前言:碳化硅产业链包含碳化硅粉末、碳化硅晶锭、碳化硅衬底、碳化硅外延、碳化硅晶圆、碳化硅芯片和碳化硅器件封装环节。其中衬底、外延片、晶圆、器件封测是碳化硅价值链中最为关键的四个环节,衬底成本占到碳化硅器件总成本的50%,外延、晶圆和封装测试成本分别为25%、20%和5%。碳化硅材料的可靠性对最终器件的性能有着举足轻重的意义,基本半导体从产业链各环节探究材料特性及缺陷产生的原因,与上下游企业协同合作提升碳化硅功率器件的可靠性。
作者:深圳基本半导体有限公司技术营销总监 魏炜
1、碳化硅晶锭生长及制备方法
碳化硅有多达250余种同质异构体,用于制作功率半导体的主要是4H-SiC单晶结构。碳化硅单晶生长过程中,4H晶型生长窗口小,对温度和气压设计有着严苛标准,生长过程中控制不精确将会得到2H、3C、6H和15R等其他结构的碳化硅晶体。
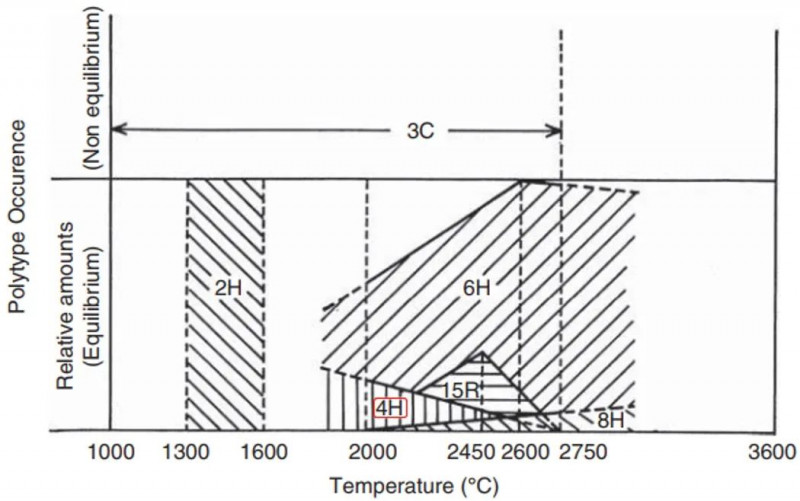
图1:各种碳化硅同质异构体生成的条件
在产业界,碳化硅单晶晶锭的制备有升华PVT、HT-CVD、LPE(溶液生长法)三种方法。其中升华PVT是目前最主流的制备方法,大约95%的商用碳化硅晶锭是由PVT生长。其过程是将碳化硅粉末放入专用设备中加热,温度上升到2200—2500℃后粉末开始升华。由于碳化硅没有液态,只有气态和固态,升华后在顶部会结晶出晶锭。硅单晶的生长速度约为300mm/h,碳化硅单晶的生长速度约为400um/h,两者相差近800倍。举例来说,五六厘米的晶锭形成,需连续稳定生长200-300小时,由此可见碳化硅晶锭制备速率十分缓慢,这使得晶锭造价高昂。
2、碳化硅单晶晶锭及衬底片缺陷
碳化硅晶锭和衬底片中均含有多种晶体缺陷,如堆垛层错、微管、贯穿螺型位错、贯穿刃型位错、基平面位错等等。碳化硅晶锭缺陷会极大地影响最终器件的良率,这是产业链中非常重要的话题,各衬底厂家都在不遗余力地降低碳化硅晶锭缺陷密度。
3、碳化硅衬底可靠性
衬底片是晶锭切成薄片,磨平并抛光后得到的产物。衬底片在抛光工艺后获得良好的表面质量,可抑制外延生长中缺陷的产生,从而获得高质量的外延片。其表面质量包括平整度、近表面位错以及残余应力。为了在外延生长的初始阶段抑制缺陷的产生,衬底表面必须是无应力和无近表面位错。如果近表面的残余损伤没有被充分的去除,衬底上的外延生长将导致宏观缺陷的产生。所以衬底环节的质量水平会严重影响后续的外延生长环节的质量水平。
4、碳化硅外延生长及可靠性
外延是指在衬底的上表面生长一层与衬底同质的单晶材料4H-SiC。碳化硅有很多种同质异构体,为保证高品质外延材料的制备,需要特殊技术来避免引入其他晶型,目前标准化工艺是使用4°斜切的4H-SiC单晶衬底,采用台阶控制生长技术。目前常用工艺为CVD法:常用设备为热壁式水平外延炉,常用反应前驱气体为硅烷 (SiH4)、甲烷 (CH4)、乙烯 (C2H4)等,并以氮气 (N2)和三甲基铝 (TMA)作为杂质源。典型生长温度范围为1500~1650 ℃,生长速率5~30 μm/h。
外延层的生长可以消除许多晶体生长和晶片加工中所引入的表面或近表面的缺陷,使晶格排列整齐,表面形貌较衬底大为改观。厚的外延层、好的表面形貌和较低的掺杂浓度对提高击穿电压有重要意义。这样的外延片用于制造功率器件,可以极大提高参数稳定性和良率。
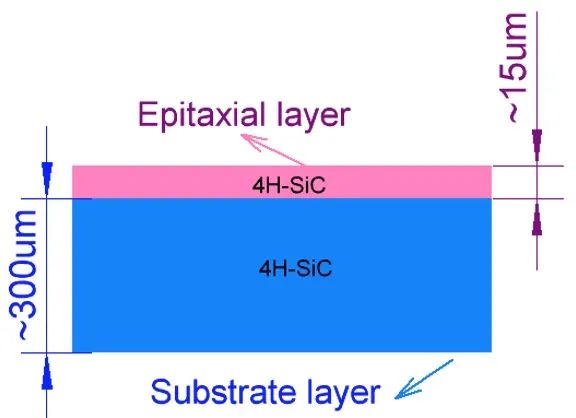
图2:衬底层和外延层结构
5、碳化硅外延片与衬底片缺陷的关联关系
上文提到了碳化硅外延层缺陷与衬底和生长过程有关。外延层缺陷有表面形貌缺陷、微管缺陷、位错等类型。其中表面形貌缺陷包含胡萝卜缺陷(某些情况下为彗星型)、浅坑、三角形缺陷、掉落物;衬底中的微管缺陷会被复制到外延层中。目前衬底中的微管密度已经远低于0.1/cm2,基本被消除。碳化硅外延层中的位错大多源于衬底位错,衬底位错主要包括TSD,TED及BPD。普通位错以及胡萝卜缺陷等外延引入的缺陷是影响碳化硅外延质量的重要问题。
6、碳化硅外延片缺陷对最终器件的影响
在外延生长过程中,衬底中的TSD约98%转化为TSD,其余转换为Frank SFs;TED则100%转化为TED;BPD约95%转化为TED,少量维持BPD。
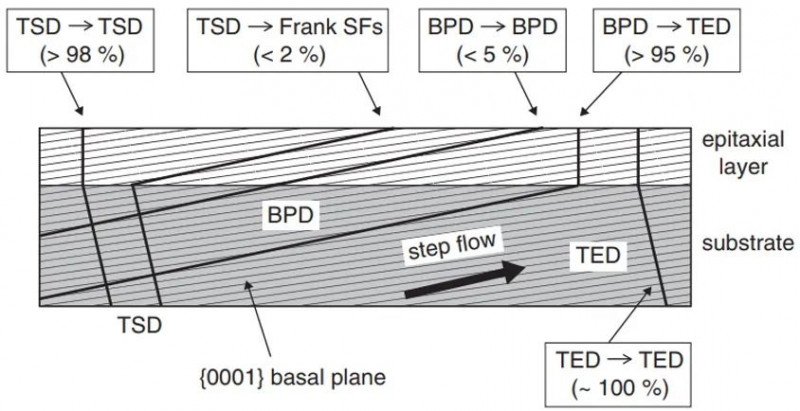
图3:碳化硅外延片缺陷与衬底片缺陷的关联性
TSD和TED基本不影响最终的碳化硅器件的性能,而BPD会引发器件性能的退化,因此人们对BPD的关注度比较高。堆垛层错,胡萝卜缺陷,三角形缺陷,掉落物等缺陷,属于杀手级缺陷,一旦出现在器件上,这个器件就会测试失败,导致良率降低。双极型器件,例如三极管、IGBT,对BPD的敏感程度更高。
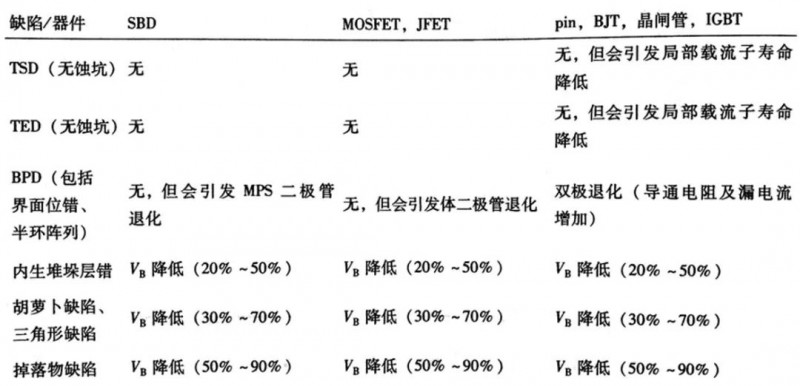
表1:外延片缺陷对最终器件的影响
7、碳化硅材料面临的两个挑战
碳化硅材料推广面临的重要挑战之一是价格过高,衬底价格远高于硅和蓝宝石衬底。目前碳化硅衬底的主流直径只有4~6英寸,需要更成熟的生长技术来扩大尺寸,以降低价格。
另一方面,碳化硅位错密度量级处于102-104,远高于硅、砷化镓等材料。此外,碳化硅还存在较大的应力,会导致面型参数出现问题。改善碳化硅衬底质量,是提高外延材料质量、器件制备的良率、器件可靠性和寿命的重要途径。
除碳化硅材料外,芯片研发和封装环节也是影响碳化硅器件可靠性的重要因素,下一篇文章将重点介绍碳化硅芯片研发及封装的可靠性内容,欢迎关注基本半导体微信公众号(ID:basicsemi),了解更多碳化硅相关精彩内容。
关于基本半导体
深圳基本半导体有限公司是中国第三代半导体行业领军企业,专业从事碳化硅功率器件的研发与产业化,在深圳南山、深圳坪山、南京浦口、北京亦庄、日本名古屋设有研发中心。公司拥有一支国际化的研发团队,核心成员由剑桥大学、清华大学等知名高校的十余位博士组成。
基本半导体掌握国际领先的碳化硅核心技术,研发覆盖碳化硅功率器件的材料制备、芯片设计、制造工艺、封装测试、驱动应用等产业全链条,先后推出全电流电压等级碳化硅肖特基二极管、通过工业级可靠性测试的1200V碳化硅MOSFET、车规级全碳化硅功率模块等系列产品,性能达到国际先进水平,应用于新能源、电动汽车、智能电网、轨道交通、工业控制、国防军工等领域。
基本半导体先后参与发起“广东省未来通信高端器件创新中心”、“深圳第三代半导体研究院”,获批中国科协产学研融合技术创新服务体系第三代半导体协同创新中心,产品荣获“中国芯”优秀技术创新产品奖、中国创新创业大赛专业赛一等奖等荣誉。
