近日,武汉大学工业科学研究院袁超课题组在国际权威期刊《Journal of Applied Physics》上,以“A review of thermoreflectance techniques for characterizing wide bandgap semiconductors‘ thermal properties and devices’ temperatures”为题总结讨论了热反射表征技术(Thermoreflectance techniques)在宽禁带半导体材料和器件领域的应用进展。

随着宽禁带和超宽禁带半导体器件的功率日益增大,器件散热问题逐渐成为工业界的巨大挑战。半导体材料热物性是反映器件散热能力最直接的参数,而器件结温是评估热可靠性和寿命的关键参数,因此,热物性和结温检测成为宽禁带半导体器件研发和生产中不可缺少的环节。宽禁带半导体器件普遍由薄膜异质结构组成,薄膜尺寸几十纳米到几微米 ( 如图1),因此,要求热物性检测技术具有纳微米级分辨率。传统的检测方法如稳态热板法、瞬态热线法、激光闪射法等,都不能满足分辨率的要求。3-omega方法虽然达到了分辨率的要求,但是需要在材料表面进行复杂的微加工,使得测试流程复杂且对材料表面质量要求过高。另一方面,宽禁带半导体器件沟道尺寸小(亚微米级)且常常在高频工况下(GHz级)运行,要求结温测试方法需满足高空间分辨率和高时间分辨率。
图1:几种典型的宽禁带器件结构:(a) 氮化镓高电子迁移率晶体管(GaN HEMT); (b) 氧化镓场效应管(β-Ga2O3 FET); 以上典型结构说明器件内存在大量微纳结构和异质界面
近几十年,以热反射(Thermoreflectance)为测试原理,国际上开发并发展了多种泵浦-探测热反射技术(Pump-probe thermorefletance), 实现了纳微米级分辨率测试能力,广泛应用于宽禁带半导体材料的热物性检测。基于相同原理,国际上同期开发了一种热反射成像技术(Transient thermoreflectance imaging),实现了纳秒级时间分辨率和纳米级空间分辨率的测温能力,同样广泛应用于宽禁带半导体器件的稳态和瞬态结温检测。本文重点介绍了热反射现象和原理,在此基础之上,总结和讨论了多种泵浦-探测热反射技术,包括时域热反射法(Time-domain thermoreflectance), 频域热反射法(Frequency-domain thermoreflectance), 瞬态热反射法(Transient thermoreflectance)和稳态热反射法(Steady-state thermoreflectance)。总结了这些方法针对常见宽禁带半导体材料的检测应用,包括氮化镓薄膜异质结构(GaN-based structure)、氧化镓薄膜异质结构(β-Ga2O3-based structure)、金刚石薄膜、合金材料(如钪掺氮化铝ScAlN, 铝掺氮化镓AlGaN)以及宽禁带二维材料(如六方氮化硼h-BN)等,并全面总结了所有材料的热物性报道值(部分结果见本报道图2,详细结果见全文)。
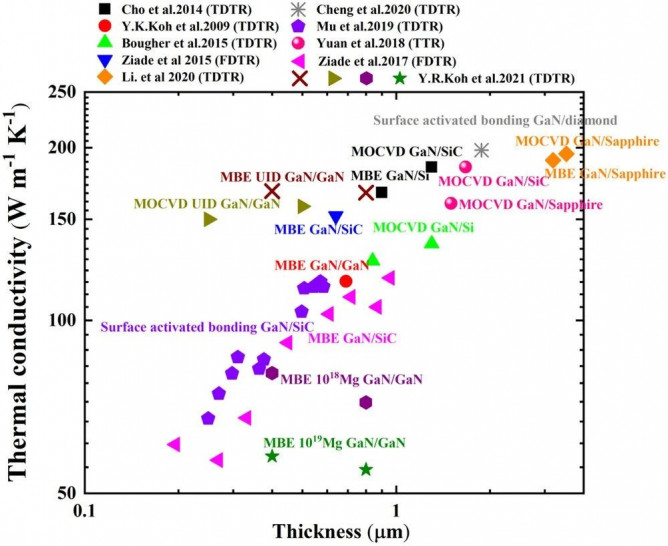
图2:氮化镓薄膜的热导率报道值;全文中还详细总结了氮化镓异质结构、氧化镓异质结构、金刚石薄膜和宽禁带合金材料的热物性报道值(热导率、界面热阻)
本文还重点比较了不同泵浦-探测热反射技术的特点。在所有方法中,时域热反射法发展最早且较为成熟,当前应用较为广泛;而频域热反射法和瞬态热反射法因具有和时域热反射法相似的分辨率和测试精度,也逐渐被认可,且已实现了广泛应用。值得注意的是,瞬态热反射法(如图3),相比时域热反射法,搭建成本大幅度减低,测试分析速度更快,操作更为简便,因而具有在半导体产线上的应用潜力。另外,本文也总结讨论了热反射成像技术以及它在宽禁带器件测温方面的应用。
图3:传统的瞬态热反射法(TTR)系统示意图
常规的泵浦-探测热反射技术和热反射成像技术需要借助金属薄膜进行测试。对于泵浦-探测热反射技术,在检测之前需在材料表面镀一层薄膜金属(如金、铝),使得材料破坏,属于破坏性检测;对于热反射成像技术,温度检测区域集中在器件金属电极,而不是器件沟道处,导致温度测试结果往往低估真实器件结温。
本文介绍了近几年一些学者(包括袁超研究员)对传统泵浦-探测热反射技术的改进,发展了免金属镀膜的泵浦-探测热反射技术(Transducer-less thermoreflectance),以实现在氮化镓外延、硅等材料的无损测试,为材料研发提供快速反馈,提升研发和生产效率、降低成本,并有望为半导体产线提供实时监测,使“边生长,边观测,边调控”成为可能。此外,介绍了热反射沟道结温直接测试技术以及它在氮化镓HEMTs器件上的应用。
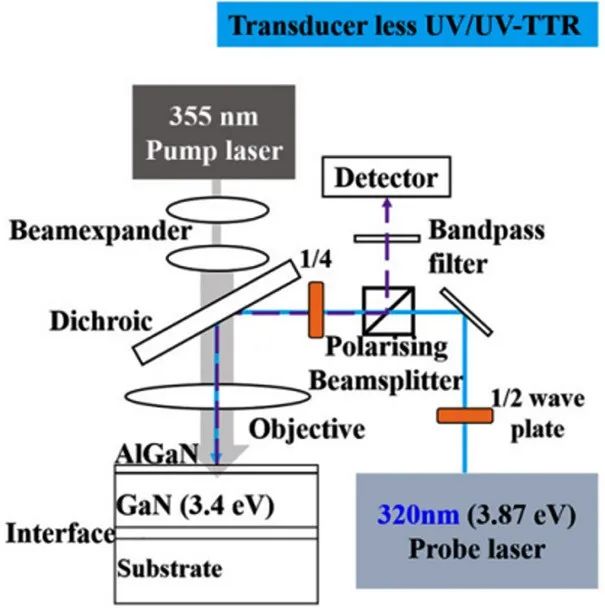
图4:免金属镀膜的瞬态热反射法(TTR)系统示意图
1、Chao Yuan*, Riley Hanus, Samuel Graham, A review of thermoreflectance techniques for characterizing wide bandgap semiconductors thermal properties and devices temperatures, Journal of Applied Physics, 132(22):220701, 2022.
2、论文第一作者和通讯作者为袁超研究员,合作作者来自美国佐治亚理工学院的Riley Hanus博士和 美国马里兰大学的Samuel Graham教授。
3、链接:https://aip.scitation.org/doi/pdf/10.1063/5.0122200
课题组主页:http://jszy.whu.edu.cn/yuanchao
袁超研究员长期从事宽禁带半导体热表征和热管理研究工作。曾先后加入英、美知名大学宽禁带研究团队从事科学研究。在薄膜尺度热反射表征方法、声子热输运理论、以及(超)宽禁带半导体器件设计等领域具有一定的技术优势和科研特色,并致力于开发半导体无损热检测装备。现承担多个国家/省部/国际合作级重大战略需求的纵向科研项目,在高影响力期刊上(包含 Materials Today Physics, Communications Physics,Appl. Phys. Lett.等)发表多篇论文。此外,长期和国内外知名半导体集成电路企业和机构合作。
(来源:DT半导体)