近日,深圳平湖实验室在GaN/SiC集成领域取得突破性进展,在国际上首次研制了商用8英寸4°倾角4H-SiC衬底上的高质量AlGaN/GaN异质结构外延(如图1)。 该成果打破了大尺寸GaN与SiC材料单片集成的技术瓶颈,为GaN/SiC混合器件的发展及其产业化进程奠定基础,可批量应用于大尺寸、高质量GaN外延材料的制备,为现有硅基GaN技术路线提供了一种极具竞争力的替代方案。
其突破性在于:
1)缺陷密度显著降低:GaN外延材料中的缺陷密度下降10~15倍,有望从根本上解决GaN器件的可靠性问题、通过10年以上寿命验证;
2)散热性能大幅提升:SiC衬底的高热导率将进一步提升GaN器件的功率密度与集成度。
这项重大进展将为宽禁带半导体在新能源汽车、消费电子、人工智能等领域的规模化应用提供重要技术支撑。
碳化硅(SiC)和氮化镓(GaN)作为第三代半导体的代表,凭借高禁带宽度、高击穿场强、高电子饱和速度和高热导率等优异特性,特别适合制造高频、高功率、耐高温、抗辐照器件,广泛应用于新能源车、消费电子、光伏、电网等领域。
基于同质外延的4H-SiC器件具有低缺陷、高耐压、抗雪崩优势,但面临低沟道迁移率和栅氧可靠性挑战。GaN HEMT拥有高开关频率和高沟道迁移率,但受限于Si基异质外延的高缺陷密度和横向结构,在高可靠性、高耐压及抗雪崩应用上竞争力不足。如何整合两者特性、实现优势互补是产业界和学术界的重大探索方向。
近年来,GaN/SiC混合晶体管成为研究热点。它结合了GaN的高迁移率/开关速度与SiC的高导热/抗雪崩能力,同时实现无动态电阻退化和优异的热稳定性。为了充分发挥其潜力,GaN/SiC单片集成是最优路径,即在SiC器件结构上外延生长GaN基异质结构。
然而,为了获得高质量SiC外延和器件,商用SiC功率器件均是基于4°倾角的4H-SiC衬底,而常用作GaN外延的SiC衬底是无倾角的。在过去,4°倾角衬底会导致GaN外延层出现台阶聚集、表面粗糙、晶体质量下降及各向异性电性能等退化。随着GaN和SiC技术迈入8英寸时代,对大尺寸外延的均匀性和应力控制提出了更高要求。因此,如何在大尺寸4°倾角SiC衬底上实现高质量GaN外延,成为GaN/SiC异质集成及其产业化亟待解决的核心难题。

图1 (a) 8英寸4H-SiC衬底上GaN外延片实物照片 (b) 2μm GaN外延层的截面透射电子显微镜照片 (c) AlN成核层与4°off-axis 4H-SiC界面可见特征性的7 nm宽度原子台阶与周期性的位错结构
深圳平湖实验室开发的8英寸4°倾角4H-SiC上GaN外延片具有良好的均匀性与平整度。PL测试显示(如图2),AlGaN/GaN异质结构势垒层的Al组分不均匀度约为1.2%;厚度不均匀度约为2.2%。对该外延片进行平整度测试,得到弯曲度(Bow)仅为+8.3 μm。

图2 (a) AlGaN/GaN异质结构势垒层PL测试图谱 (b) 外延厚度测试图谱 (c) 8英寸SiC上GaN外延片翘曲测试,Bow = 8.3 μm
对该外延片进行高分辨X射线衍射测试,4°倾角SiC衬底上GaN外延层的(002)/(102)面摇摆曲线半峰宽分别为290/ 296 arcsec,估算可得位错密度约为6×108cm-2,与无倾角SiC衬底上GaN外延层的晶体质量相当;相比常规Si衬底上GaN,材料位错密度降低10~15倍(如图3)。原子力显微镜测试表明,外延层表面粗糙度RMS=1.6 nm(5μm×5μm)(如图3)。Hall测试表明,AlGaN/GaN异质结构的二维电子气迁移率高达1870 cm2/V·s(如图4)。 以上各项指标均达到国际领先水平,显示该外延片具有优秀的材料特性。
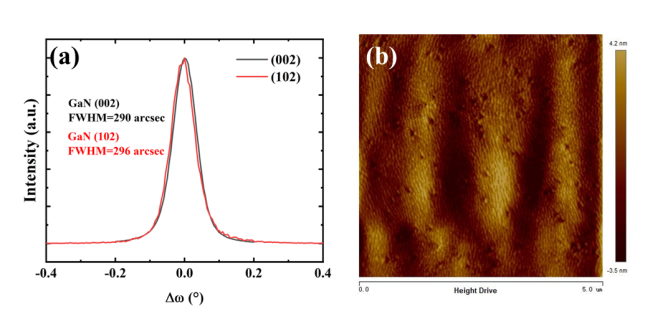
图3 (a) 4°倾角SiC衬底上GaN外延层的XRD (002)/(102)面摇摆曲线 (b) 外延层表面的原子力显微镜照片
![]()
图4 SiC衬底上AlGaN/GaN异质结构的霍尔测试结果
(来源:深圳平湖实验室)





