近些年来,P-NiO/N-Ga2O3氧化镓异质结的引入暂时解决了氧化镓中有效P型掺杂的问题。P型NiO禁带宽度为3.8-4 eV与氧化镓禁带宽度相差较小,掺杂浓度在1017-1019 cm-3范围可控,一些优异的P-NiO/N-Ga2O3氧化镓异质结已经被报道。然而,P-NiO/N-Ga2O3氧化镓异质结的导通电阻相对较大,对功率器件的研制并不友好。因此,我们团队研制了P-NiO/N-Ga2O3异质结型势垒肖特基二极管(HJBS),如下图1所示,该HJBS在很大程度上降低了导通电阻,实现了0.93GW/cm2的优异性能,为国际同期氧化镓二极管功率性能的最高水平。
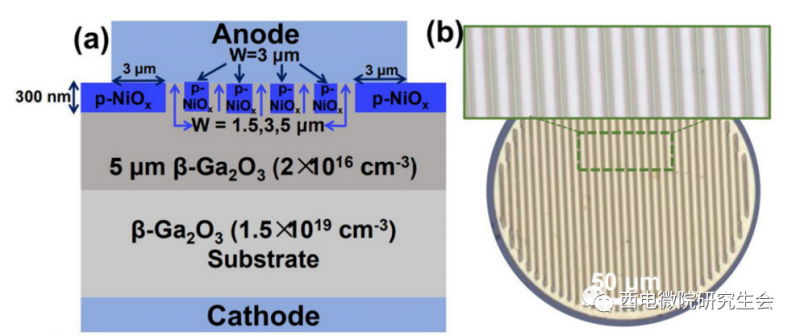
图1 (a)、(b)分别为P-NiO/N-Ga2O3
HJBS二极管的结构示意图、光学图
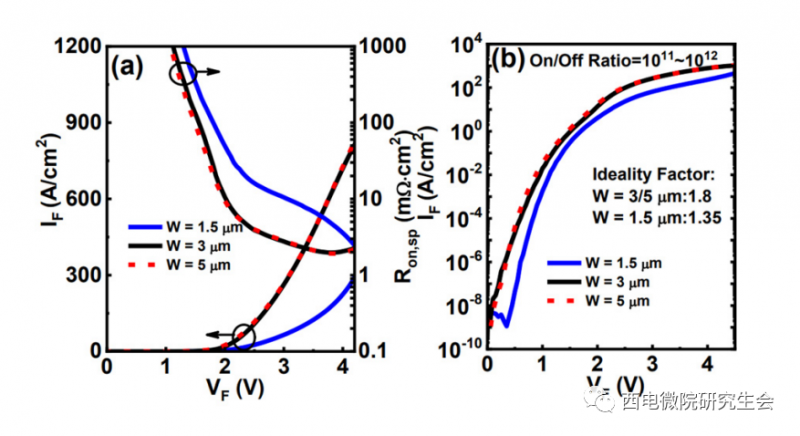
图2 (a)、(b)分别为线性和对数条件下的正向I-V特性曲线
如图2所示,在改变fin宽度为5 μm,半径为60 μm的HJBS二极管在正向偏压为4.2 V时,正向电流最高达到824 A/cm2,此时导通电阻为1.91 mΩ?cm2。而当fin宽度为1.5 μm时,器件导通电阻增大(2.45 mΩ?cm2)是由于更小的fin宽度,使得水平的侧壁耗尽增强,进而增大了开启电压。通过采用该HJBS结构,正向导通时,由于P-NiO更高的掺杂浓度,空穴注入N-Ga2O3时是大注入,为了达到电学平衡,Ga2O3中产生更多的电子,电导调制使得器件导通电阻降低。在对数正向I-V特性曲线图 (b),可以看出,三种器件的开关比均达到了1011-1012,三种不同fin宽度分别为1.5 μm、3 μm、5 μm的HJBS二极管的理想因子分别为1.35、1.8、1.8。
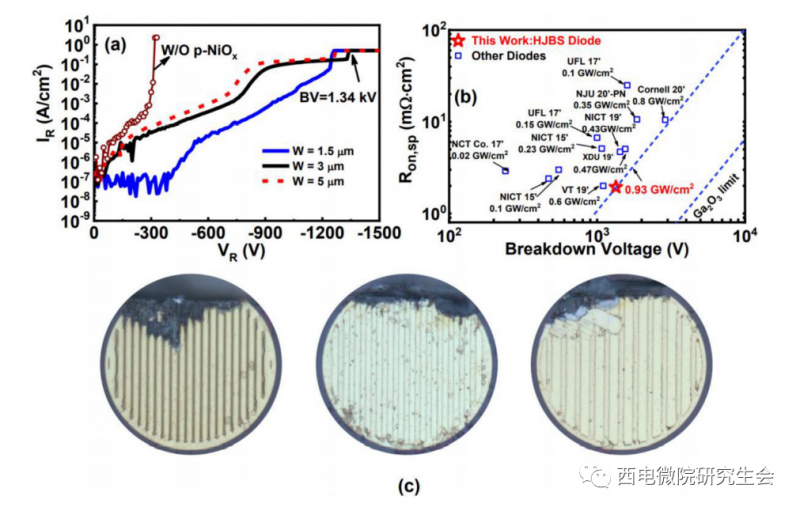
图3 (a)HJBS器件和普通SBD的反向I-V特性曲线
(b)氧化镓二极管的功率性能对比图
(c)器件发生击穿的光学图片
在室温下,对以上器件进行了反向击穿测试,为了进行对比,制备了同样工艺的没有任何终端的SBD。普通SBD的击穿电压为300 V,三种fin宽度不同器件的击穿没有明显的差异,其中fin宽度为3 μm的器件的击穿电压为1340 V,结合器件的导通电阻1.94 mΩ?cm2,器件的功率优值(P-FOM=BV2/Ron,sp)达到0.93 GW/cm2,为国际同期氧化镓二极管的最高水平。因为三种器件的阳极金属一致,它们的势垒高度也一样,当反向偏压增加时,势垒顶部会变得尖锐,电子可以通过,所以反向电流增加。然而,由于更小的fin宽度实现了更大程度上的水平侧壁耗尽,耗尽区也更宽,有更少的电子可以隧穿通过势垒,所以反向偏压增大时,更小fin宽度的器件反向泄漏电流会更小。当反向偏压进一步增大时,阳极边缘电场集中效应对器件发生击穿占据了主导作用,所以最终三种不同fin宽度的器件击穿电压差异不大,同时从器件发生击穿都在阳极边缘的光学图片也能验证这点。
同时,我们研究了通过加入P型NiO材料实现了高性能的氧化镓基场效应晶体管器件,通过NiO与氧化镓的异质PN结成功制备出具有高性能的二极管和结型场效应晶体管,器件的机构示意图及氧化镓与NiO界面的HRTEM图如下。
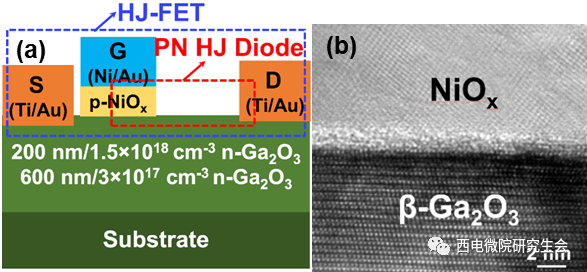
图4 (a)氧化镓结型场效应晶体管器件的示意图
(b)NiO与氧化镓界面的HRTEM图
由于氧化镓缺失同质PN结,引入P型NiO材料与氧化镓构成异质PN结可在一定程度上增加器件的内建电势差,加强N型氧化镓的耗尽作用,同时NiO具有可观的约4.0 eV的禁带宽度,使得拥有PN结的器件临界电场强度损失较小。对于结型场效应晶体管,PN结的垂直耗尽作用可以增加器件零偏置的耗尽宽度,因此器件可以选取更厚或者掺杂浓度更高的外延层,这可以降低功率器件导通时的压降,降低器件工作状态的功率损耗。
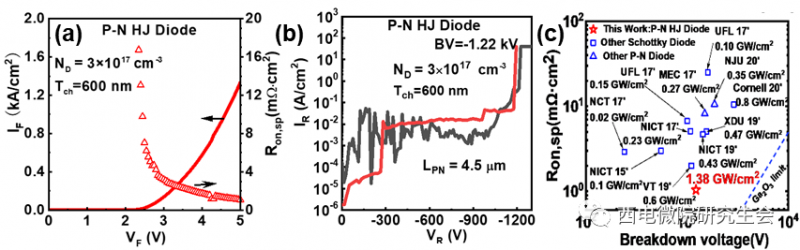
图5 PN二极管的(a)导通关系,(b)反向耐压关系,(c)Benchmark图
制备的PN结正向与反向电流电压关系式如上图5所示,该器件开关比达到109,开启电压为2.6 V,正向电流在偏置为5V时达到1.3 kA/cm2,特征导通电阻为1.08 mΩ?cm2, 同时由于PN结具有较肖特基结更小的泄漏电流,器件击穿电压可达到1.22 kV。器件功率优值可通过击穿电压的平方除以特征导通电阻计算得到,此PN结的功率优值可高达1.38 GW/cm2, 由上图5(c)可看到此器件性能处于同期领先地位,标志着此器件具有较高的反向耐压同时兼顾较小功率损耗的能力。

图6 结型场效应晶体管的(a)输出曲线,(b)转移曲线
(c)击穿图,(d)Benchmark图
通过栅极采用NiO材料,该结型场效应晶体管器件最大饱和导通电流达到455 mA/mm、特征导通电阻达到3.19 mΩ?cm2, 由转移曲线可以看到器件的阈值电压为-13 V,亚阈值摆幅为75 mV/dec、短沟道效应为6 mV/V、电流开关比达到1010。通过图(c)可以看到器件击穿达到1115V,因此此结型场效应晶体管的功率优值达到0.39 GW/cm2,从图(d) benchmark图可看到此性能也处于国际同期领先地位,给出了一种未来氧化镓基器件发展路线。
总结
最后,谈一点功率器件的研制心得,为了提升器件耐压,绝大部分时候需要考虑终端缓解电场,其中包括离子注入形成高阻区域、场板结构舒缓峰值电场、单个或多个PN结(超结)。针对超宽禁带半导体,往往较难同时实现P型和N型掺杂,同质PN结的实现具有较大的挑战,因此异质PN结是一个不错的选择并可有效实现高性能终端技术。更进一步,高耐压同时也需要漂移区的掺杂浓度较低,器件导通电阻将会增加。在引入PN结以后,理论上来讲器件在大偏压情况下会实现双极输运和电导调制效应,从而降低器件导通电阻提升器件整体性能。归纳起来,高性能的功率器件总是离不开PN结,因此在设计功率器件的时候需要考虑引入PN结实现对器件性能的提升。
参考文献
【1】Qinglong Yan, Hehe Gong, Jincheng Zhang, Jiandong Ye, Hong Zhou, Zhihong Liu, Shengrui Xu, Chenlu Wang, Zhuangzhuang Hu, Qian Feng, Jing Ning, Chunfu Zhang, Peijun Ma, Rong Zhang, and Yue Hao,“β-Ga2O3 hetero-junction barrier Schottky diode with reverse leakage current modulation and BV2/Ron,sp value of 0.93 GW/cm2,” Appl. Phys. Lett. 118, 122102 , 2021. (IF=3.791, SCI, 二区)
【2】Chenlu Wang, Hehe Gong, Weina Lei, Yuncong Cai, Zhuangzhuang Hu, Shengrui Xu, Zhihong Liu, Qian Feng, Hong Zhou, Jiandong Ye, Jinfeng Zhang, Rong Zhang, and Yue Hao, “Demonstration of the p-NiOx/n-Ga2O3 Heterojunction Gate FETs and Diodes with BV2/Ron,sp Figures of Merit of 0.39 GW/cm2 and 1.38 GW/cm2,” in IEEE Electron Device Letters, vol. 42, no. 4, pp. 485-488, April 2021. (IF=4.187, SCI, 二区)

作者:周弘,西安电子科技大学教授,博士生导师。2017年在普渡大学获得博士学位,2017年-2018年在加州大学伯克利分校进行博士后研究,2018年归国加入西安电子科技大学微电子学院。主要研究方向为宽禁带和超宽禁带半导体功率器件,取得一系列宽禁带半导体微波功率与电力电子器件的国际最高指标。入选海外高层次留学归国人员、第三批GF青年托举人才,Google学术引用超过2500次。
