在近期日本熊本市举办的第37届国际功率半导体器件和集成电路会议(International Symposium on Power Semiconductor Devices and ICs,ISPSD)上,南京大学江苏省第三代半导体与高能效器件重点实验室张荣和陆海教授研究团队入选了两篇氮化镓(GaN)功率器件辐照效应研究论文,向国际同行展示了宇航级GaN功率器件研究最新成果。该工作是在周峰副研究员协助指导下完成,合作单位包括中国空间技术研究院、哈尔滨工业大学、中国科学院近代物理研究所、江苏能华微电子科技发展有限公司、中国电子产品可靠性与环境试验研究所。ISPSD是功率器件领域最具影响力和规模最大的顶级国际学术会议,本次会议发表了来自12个国家、74个机构的研究成果,涵盖了功率半导体器件、功率集成电路、工艺、封装和应用等多个方向。
本次南京大学入选的两项工作成果如下:
1、紫外脉冲激光辐照下650V GaN功率器件的动态非钳位感性开关特性研究
非钳位感性开关(UIS)能力是功率电子器件在感性负载应用中备受关注的可靠性需求。商用p-GaN HEMT由于缺乏雪崩击穿能力,需通过器件电容和负载电感之间的谐振效应来维持UIS应力下的动态过压和能量冲击。当UIS过压超过器件的临界阈值时,器件会发生破坏性烧毁。宇航用功率器件常通过地面加速器实验装置来模拟空间重离子辐射效应,受限于离子束斑区域的紧凑空间和远程连接的复杂操控,单粒子辐照下GaN功率器件的动态UIS特性长期为研究空白,成为高频、高功率密度GaN功率器件宇航应用中亟需研究的关键问题。
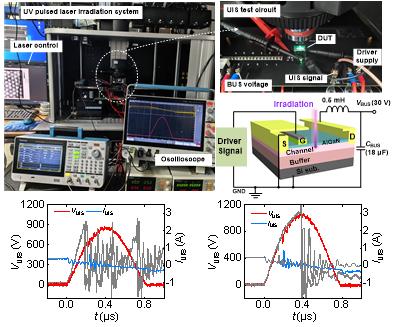
图1. 微区紫外脉冲激光装置与UIS测试电路以及相应的UIS辐照波形
本工作通过开发微区紫外脉冲激光辐照实验技术,克服微米级区域聚焦、激光与重离子关联性等效、厘米级区域Mapping点测、UIS脉冲协同等多个难题,实现在紫外脉冲激光模拟单粒子辐照下评价器件的UIS能力。研究表明,器件的UIS过压从1109 V降低到897 V,衰减了19%;同时发现UIS过程中的冲击能量损失降低。UIS电路建模和数值仿真模拟表明碳掺杂缓冲层中的类受体陷阱会被单粒子辐照诱导的电荷填充,导致局域电场增强,从而恶化器件的动态过压能力;同时UIS充放电阶段的电荷不平衡分布受到辐照效应影响,使得能量损失相较于辐照前略有降低。该项研究结果证实了GaN材料质量会影响器件的UIS辐照性能,抗辐照加固设计一方面需要降低类受体陷阱浓度,改善辐照电荷俘获造成的动态过压能力退化;另一方面,优化漏极侧局域强电场,避免辐照下器件提前击穿烧毁。
2、抗辐照加固设计AlGaN/GaN p-GaN型混合阳极功率二极管
空间重离子入射产生的非平衡电荷对器件的关态阻断能力、动态UIS特性等都构成严重威胁,由于能量快速沉积造成的单粒子烧毁(SEB)是其中的关键难题,被列入到JEDEC-JESD57A等国内外标准中。近些年,国际上多家公司已推出抗辐照加固设计GaN开关三极管,而在单端反激拓扑、正激同步整流变换拓扑等宇航电源系统中起关键整流作用的GaN功率二极管尚未有研究报道。
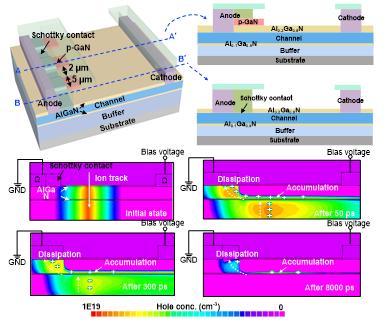
图2. 抗辐照加固设计GaN功率二极管和辐照下电荷输运过程
本工作中报道了650V等级抗辐照加固GaN功率二极管,提出AlGaN/GaN p-GaN型混合阳极结构与异质结外延材料相结合的双重加固设计。器件阳极由区域性分段分布的p-GaN层和肖特基接触金属组成,同时在GaN缓冲层与沟道层之间引入了8nm厚度的AlGaN层,将辐照引入的电荷束缚在异质结材料区域内,并在电场作用下通过器件阳极泄放到体外。重离子辐照实验表明,在650V恒压偏置下器件维持低漏电到~107 ions/cm2离子注量,单粒子烧毁电压超过800V;进一步在微区紫外脉冲激光辐照下评估了器件的低损耗反向恢复特性。研制的抗辐照GaN功率二极管作为GaN开关器件的功能补充,将拓宽GaN技术在宇航电源中的应用场景。
上述研究工作得到国家科技重大专项、国家重点研发计划、国家自然科学基金和江苏省重点研发计划等项目支持。近年来,南京大学团队面向宇航级抗辐照高能效功率电子应用,在重离子辐照、大气中子辐照、瞬时注量率效应、抗辐照加固GaN功率器件等方面取得了多项创新成果,部分指标处于国际领先水平,并联合产业界积极推进技术落地。





