
基于SiC单晶制备的功率器件具有耐高温、低损耗、耐高压等优良性能,能够满足电力电子系统的轻量化、高效率和小型化的需求,在新能源汽车、轨道交通、5G基站、智能电网等领域正在掀起一场替代传统硅基功率器件的革命。溶液法生长SiC单晶具有晶体结晶质量高、易实现晶体扩径、易实现低温生长、易实现稳定的P型掺杂等独特的优势,有望在将来成为大规模量产SiC单晶的主要方法。然而,由于Si-C二元溶液中C在硅熔体中的溶解度极低,导致采用Si-C二元溶液无法实现SiC单晶的快速生长。因此,如何提高Si-C溶液中的C的溶解度是实现SiC单晶快速生长需要解决的首要问题。另外,3C-SiC的载流子迁移率、热传导性能、机械性能都优于目前商用的4H-SiC,有助于制造可靠和长寿命的器件,但3C-SiC不稳定,在高于2173 K的高温下会转变成六方多晶。因此,要想实现3C-SiC单晶的稳定生长,需开发新型助溶剂,在温度低于2173K时提高硅基溶液中的C溶解度,以提高溶液法生长3C-SiC单晶的生长速度。
近日,昆明理工大学雷云、马文会等与北京青禾晶元半导体科技有限责任公司母凤文等合作,在晶体学著名期刊Crystal Growth & Design上发表2篇题为“Rapid growth of high-purity 3C-SiC crystals using a SiC saturated Si–Pr–C solution”和“Promising Approach for Rapid Growth of High-Quality SiC Crystals Using Si−Nd−C Solutions”的研究论文。论文分别报道了采用Pr和Nd作为助溶剂成功地在低温下(1823~1923K,注:与PVT法的生长温度>2473 K相比是低温)在SiC饱和的硅熔体中获得超高的C溶解度,并且添加的助溶剂在3C-SiC晶体中的残留量可低于GD-MS的检测极限(<0.05 ppmw),有望解决助溶剂对SiC晶体污染的问题。当助溶剂和石墨坩埚的纯度均低于99.9%时,获得的3C-SiC的纯度高于99.995%。
另外,如果要实现在低温下的硅基溶液中生长3C-SiC单晶,除了要提高硅基溶液中C的溶解度和降低助溶剂对SiC晶体的污染外,SiC物相必须是硅基溶液中唯一稳定存在的固相。当采用Pr含量为25mol%~35mol%的Si-Pr合金和采用Nd含量为25mol%~42mol%的Si-Nd合金时,在1823-1923K下可获得SiC稳定存在(SiC饱和)的Si-Pr-C和Si-Nd-C溶液。且在1923K,SiC饱和的Si-Pr-C和Si-Nd-C溶液中C的溶解度最高分别可达到2.7 mass%(13.5 mol%)和5.16 mass%(25.83 mol%)。研究结果为溶液法低温快速生长高质量的3C-SiC单晶提供了理论基础和新的契机。研究工作得到国家自然科学基金项目的资助。
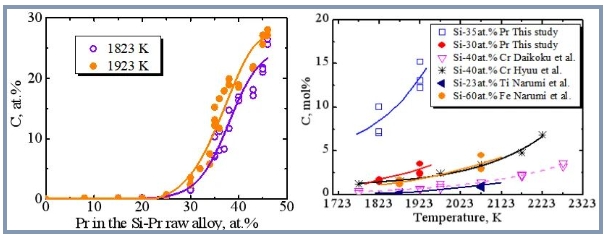
图1. (a)温度为1823-1923K时,当Si-Pr合金中的Pr含量高于25at.%,C在Si-Pr熔体中的溶解度急剧增加;(b)在相同温度下,C在Si-Pr熔体中的溶解度高于目前已报道的Si-40at.%Cr、Si-23at.%和Si-60at.%Fe熔体。
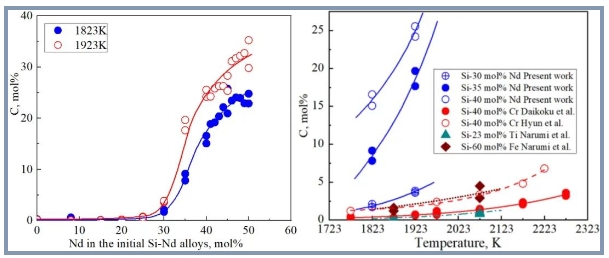
图2. (a)温度为1823-1923K时,当Si-Nd合金中的Nd含量高于25at.%,C在Si-Nd熔体中的溶解度急剧增加;(b)在相同温度下,C在Si-Nd熔体中的溶解度高于目前已报道的Si-40at.%Cr、Si-23at.%和Si-60at.%Fe熔体。
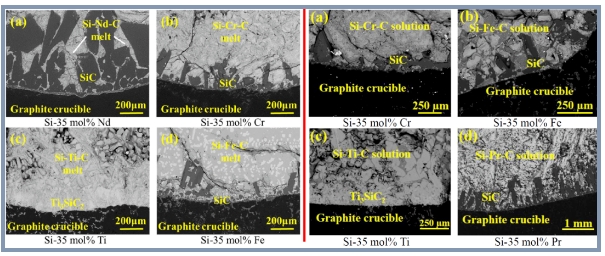
图3. 当温度为1923K,温度梯度为33 K/cm,Si-Nd、Si-Pr、Si-Ti、Si-Cr、Si-Fe合金中的助溶剂均为35mol%时,Si-Nd-C和Si-Pr-C溶液中的SiC晶体析晶能力远远大于Si-Cr-C、Si-Ti-C和Si-Fe-C溶液中SiC晶体的析晶能力(对比结果分别见左边4幅图和右边4幅图)。
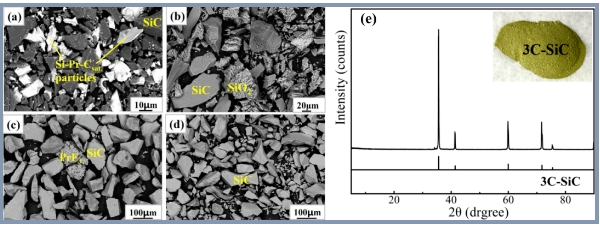
图4. 采用酸洗的方法去除SiC晶体之间的溶剂夹杂相后(图a-d),用GD-MS检测得到SiC的纯度>99.995%,Pr的含量低于GD-MS的检测极限(<0.05 ppmw);获得的SiC晶体为单一的3C-SiC(图e)。
通讯单位:昆明理工大学;
合作单位:北京青禾晶元半导体科技有限责任公司
第一作者:邓幻、李鹏;
通讯作者:雷云
文章链接:https://doi.org/10.1021/acs.cgd.3c01183;https://doi.org/10.1021/acs.cgd.3c00409。
(来源:宽禁带半导体技术创新联盟)





