Wolfspeed 正在扩展其行业领先的碳化硅(SiC)MOSFET 和肖特基二极管分立器件产品线,新增采用顶部散热(TSC)封装的 U2 系列产品。该系列提供 650 V 至 1200 V 多种电压选项,能显著提升系统功率密度和效率,同时优化热管理性能并增强电路板布局灵活性。

应用领域:
-
电动汽车车载充电机及快速充电基础设施
-
电动汽车与工业暖通空调(HVAC)电机驱动
-
高电压 DC/DC 转换器
-
太阳能及储能系统
-
工业电机驱动
-
工业电源
产品特性:
-
提供满足 JEDEC 与 AEC-Q101 标准的选项
-
低剖面、表面贴装设计
-
顶部散热,热阻(Rth)低
-
碳化硅(SiC)MOSFET 电压范围:750 V 至 1200 V
-
碳化硅(SiC)肖特基二极管计划覆盖 650 V 至 1200 V
优势:
-
碳化硅(SiC)顶部散热(TSC)封装中最大的爬电距离
-
通过优化 PCB 布局实现更高系统功率密度
-
表面贴装设计支持大规模量产
新特性:新款顶部散热(TSC)封装的优势
大多数标准表面贴装分立功率半导体器件通过底部与 PCB 直接接触的方式散热,并依赖安装在 PCB 下方的散热器或冷却板。这种散热方式广泛应用于各类电力电子场景,尤其在 PCB 安装空间和散热器重量不受限制的应用中尤为常见。
相比之下,顶部散热(TSC)器件通过封装顶部实现散热。在顶部散热(TSC)封装内部,芯片采用倒装方式布置于封装上层,使热量能够直接传导至顶部表面。这类器件特别适合汽车及电动交通系统等高性能应用场景——这些领域对高功率密度、先进热管理方案和小型化封装有着严苛要求。在这些应用中,顶部散热(TSC)器件通过实现最大功率耗散并优化热性能,有效满足了系统的冷却需求。
顶部散热(TSC)设计还实现了 PCB 的双面利用,因为底板表面不再需要为散热器预留接口。将散热器从热路径中移除,不仅显著降低了系统整体热阻,还支持自动化组装工艺——这一优势可大幅提升生产效率,从而打造出更具成本效益的解决方案。
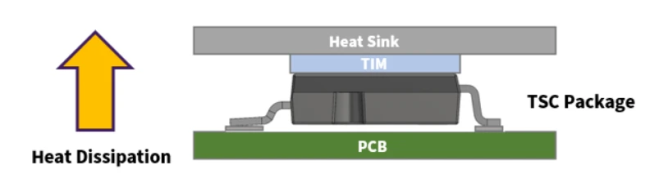
SpeedVal™ Kit 评估平台:轻松测试 U2 顶部散热(TSC)器件
Wolfspeed SpeedVal Kit 模块化评估平台为工程师提供了一套灵活的构建模块,可在实际工作点对系统性能进行电路内评估,从而加速从硅器件向碳化硅(SiC)的转型过渡。最新发布的三相评估主板不仅支持高功率静态负载测试,更能为先进电机控制固件的开发提供基础平台。
针对 Wolfspeed 顶部散热(TSC)MOSFET 不同导通电阻 Rdson 的评估板即将推出。

(来源:Wolfspeed)
