
近日,中国科学院宁波材料技术与工程研究所郭炜研究员在GaN HEMT器件研究中取得新进展,相关工作以Al2O3/in-situ GaON gate dielectrics incorporated GaN MIS-HEMTs with stable VTH and significantly reduced interface state density(具有高阈值电压稳定性和低界面态密度的Al2O3/原位GaON栅介质高电子迁移率晶体管研究)为题发表在学术期刊Applied Physics Letters中。
研究背景
基于槽栅结构的MIS-HEMT增强型高电子迁移率晶体管具有阈值电压大、栅极驱动电路简单等优势,是下一代高频功率开关器件的重点研究方向之一。但相比产业界常用的p-GaN栅HEMT,MIS-HEMT存在刻蚀界面缺陷多诱发阈值电压(VTH)漂移与电流迟滞等问题。因此,开发与槽栅刻蚀工艺兼容的低界面缺陷态MIS栅介质是改善器件综合性能的关键。
主要研究内容
中科院宁波材料所研究团队创新性提出采用低损伤数字刻蚀工艺,在槽栅刻蚀表面原位形成GaON钝化层,并在其上再通过ALD技术沉积Al2O3介质层,形成Al2O3/in situ GaON 叠层栅介质,实现了对凹槽栅缺陷的有效钝化,降低了界面缺陷态密度(Dit),显著增强了HEMT器件的温度和电压稳定性。
在槽栅刻蚀后,AlGaN势垒层存在一定的等离子体损伤缺陷。因此,原位 GaON的形成过程在消除表面缺陷、钝化悬挂键方面发挥了关键作用。图1展示了分别采用Al2O3/in situ GaON双层栅介质、单层Al2O3介质和单层GaON介质的MIS-HEMT器件在不同栅偏压与不同温度下的转移特性。当器件在最大栅压4至12 V范围内进行双扫(dual-sweep)测试时,采用双层介质和单层GaON介质的MIS-HEMT器件的VTH仅发生了60 mV的漂移,而采用单层Al₂O₃介质的器件则表现出明显的迟滞现象。在温度升高时,HEMT器件更容易受到介电层与III-族氮化物界面处热激活陷阱的影响。双层Al₂O₃/in situ GaON器件的VTH漂移仅为约–0.28 V,远小于单层Al₂O₃器件的–0.88 V。C-V测试证明,基于叠层栅介质的MIS-HEMT Dit 在4×1011-2×1012 cm-2 eV-1范围,为领域内报道的MIS-HEMT结构的最好水平之一。综上,结合原位GaON的低界面态密度特点和Al2O3栅介质禁带宽度大的优势,可以实现器件开关比和VTH稳定性的协同提升。
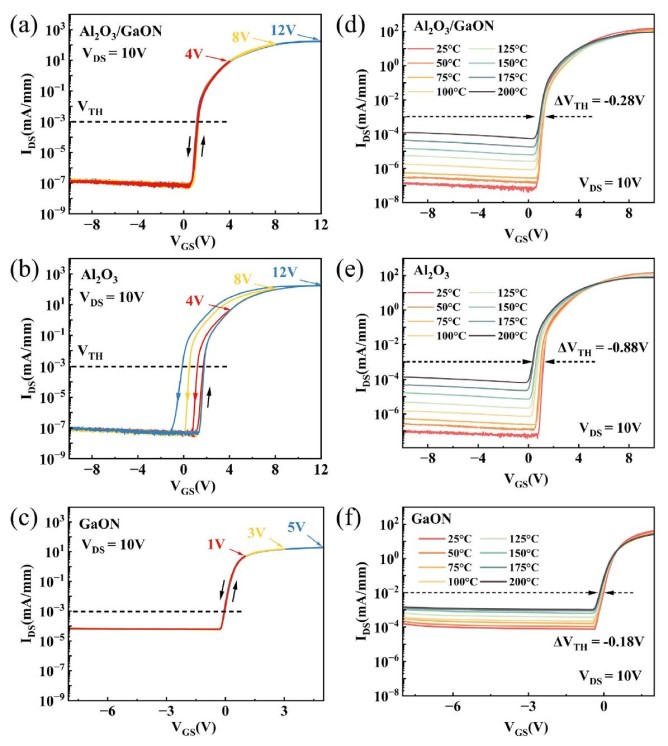
图1,采用Al₂O₃/in situ GaON 双层介质(a, d),单一Al₂O₃介质(b, e),单一GaON介质(c, f)的MIS-HEMT在不同栅偏压和温度下的转移特性曲线
通过高分辨透射电镜(HRTEM)与几何相变分析(GPA),团队发现Al2O3/GaN界面存在明显的晶格畸变,而相比之下原位GaON插层可有效缓解该失配,形成均匀的晶格过渡区。进一步XPS分析也确认,GaON层中Ga-O键成分明显增强,说明其作为“原生氧化层”在缺陷钝化中发挥了关键作用。该工作对于改善MIS-HEMT器件的稳定性和可靠性、促进MIS-HEMT商业化应用提供了重要参考。
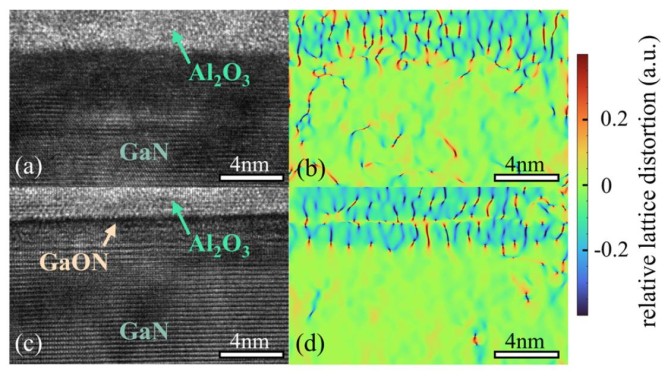
图2 在Al₂O₃/GaN 和 Al₂O₃/in situ GaON/GaN界面处的高分辨透射电子显微镜及对应的晶格常数分布图:Al₂O₃/GaN界面(a, b),Al₂O₃/in situ GaON/GaN界面(c, d)
论文第一作者为中科院宁波材料所研究生罗天,通讯作者为中科院宁波材料所郭炜研究员和叶继春研究员。工作得到了国家自然科学基金、固态微波器件与电路国家重点实验室以及宁波市重点研发计划等项目的大力支持。
论文信息
Al2O3/in situ GaON gate dielectrics incorporated GaN MIS-HEMTs with stable VTH and significantly reduced interface state density
Tian Luo, Sitong Chen, Ji Li, Fang Ye, Zhehan Yu, Wei Xu, Jichun Ye*, Wei Guo*
Appl. Phys. Lett. 126, 063503 (2025)
