
随着微电子技术的持续发展,超宽禁带半导体材料在高功率和射频电子领域引发了广泛关注。近日,一项关于超宽禁带氮化铝(AlN)异质结器件的最新研究成果发表于《IEEE Electron Device Letters》。该研究由威斯康星大学麦迪逊分校马振强教授团队与阿卜杜拉国王科技大学李晓航教授团队合作完成,论文第一作者为威斯康星大学麦迪逊分校的陆义博士。研究团队首次通过半导体纳米薄膜嫁接技术,成功制备出单晶p-Si/n-AlN异质集成PN结二极管,展现出卓越的整流特性、超低漏电流和优异的热稳定性。这一突破为AlN基电子器件的发展提供了关键的技术支撑。
【研究背景】
在能源转型和信息技术飞速发展的今天,高功率、高频率电子器件需求迅速增加。超宽禁带半导体材料如氮化铝(AlN),因其优异的材料性能,如超宽的带隙(6.1 eV)、极高的击穿电场(12-15 MV/cm)以及出色的热导率(340 W/m·K),备受产业和学术界的关注。近年来,采用Si掺杂n型AlN层的单极性AlN肖特基二极管(SBD)取得了进展。然而,由于AlN的p型掺杂效率极低,其双极型器件(如PN结二极管)的发展长期受限,相关研究面临巨大挑战。
【研究内容】
为解决这一难题,研究团队创新性地采用半导体嫁接技术,将厚度约180 nm的大面积单晶p型Si纳米薄膜精确嫁接到n型AlN外延层上,首次实现了高质量、高性能的p-Si/n-AlN异质结PN二极管。该半导体纳米薄膜嫁接技术有效克服了不同半导体材料之间的晶格失配难题,实现了任意半导体材料间的高质量异质集成。在本研究中,Si与AlN界面的原位氧化层能够起到自钝化作用,显著降低界面缺陷密度,同时该钝化层也为载流子的量子隧穿提供了有利通道。
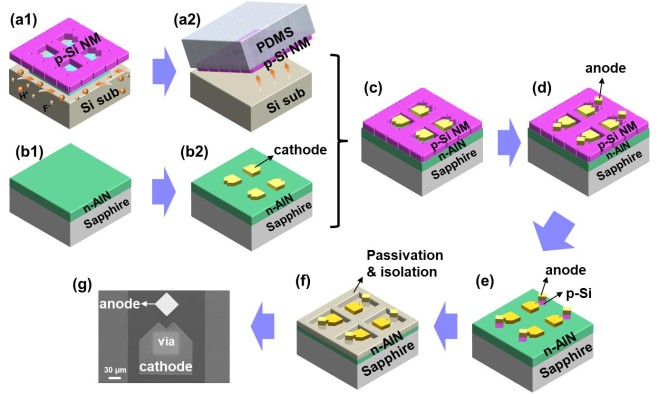
图1. (a1) p-SOI图形化及腐蚀;(a2) 用PDMS印章拾取纳米薄膜;(b1) n-AlN外延层;(b2) 阴极金属化与退火;(c) 纳米膜转移到AlN;(d) p-Si上阳极金属化及退火;(e) RIE刻蚀去除未覆盖的p-Si纳米膜;(f) ALD Al₂O₃钝化、开孔及器件隔离;(g) 器件SEM图像。
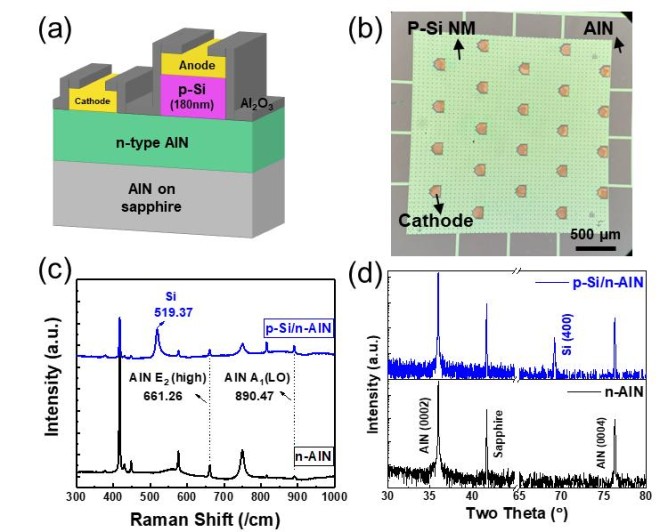
图2. (a) 器件示意图; (b) Si纳米薄膜转移到n-AlN模板上; (c) 拉曼和(d) XRD图谱。
研究团队进一步优化了n-AlN金属接触,通过1100℃的高温快速退火,有效改善了金属与n-AlN的欧姆接触性能,将界面接触电阻降低至4.9×10-3 Ω·cm2,为器件的整体高性能奠定了坚实基础。所制备的PN二极管表现出出色的整流性能和优异的均匀性,在±10 V电压下整流比高达3×10⁷,并拥有极低的漏电流密度(约6.25×10-9 A/cm² @ -10 V)。正向扫描(-10至+30 V)与反向扫描(+30至-10 V)I-V曲线未观察到明显滞后现象,进一步证明了单晶Si与AlN的高质量界面和极低的界面缺陷水平。
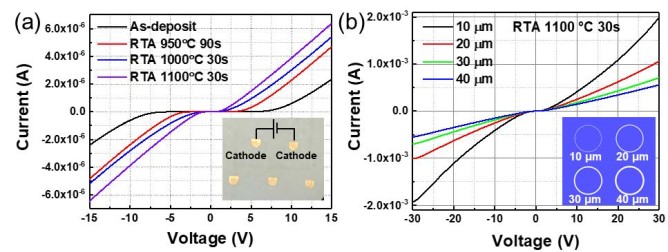
图3. (a) 不同退火条件下相邻阴极的IV曲线,插图为阴极的显微镜照片;(b) 1100°C 30 s退火样品不同间距的IV曲线。
该器件在室温至100℃的温度范围内展现出优异的热稳定性,导通电阻随温度升高显著下降(由室温下的15.8 Ω·cm2降至100℃时的0.33 Ω·cm2)。在高反向电压测试中,器件的击穿电压高达-894 V,且未出现破坏性击穿,充分展现了其优良的可靠性与稳定性。此外,研究团队通过二维器件仿真深入分析了电场分布特性,结果显示电场主要分布于AlN一侧,而硅侧的电场分布很弱。同时,通过在器件侧壁引入Al₂O₃钝化层,有效缓解了界面电场的集中,进一步提升了器件的击穿能力和整体性能。

图4. (a) 19个Si/AlN PND器件的I-V曲线;(b) 典型器件的滞后特性;(c) 典型器件从室温至100°C的I-V特性;(d) 提取的电阻与1/kT的关系。

图5. (a) 19个Si/AlN PND器件高反向电压测量,插图为达8 mA上限时的反偏电压统计;(b) 典型PND多次高压测试结果;(c) -1000 V下PND二维电场分布仿真;(d) 本工作及已报道n-AlN基二极管的性能对比。
【结语】
本研究成果为超宽禁带半导体材料的异质集成提供了全新思路。所制备的PN结二极管展现出高整流比、极低漏电流,以及优异的高温和高压耐受能力,使其在高功率电子、射频器件及极端环境应用领域展现出广阔的应用前景。本研究所提出的异质结器件技术不仅为AlN器件的应用边界带来拓展,也为未来其他超宽禁带半导体材料的异质集成与创新提供了重要参考,有望持续推动高性能、高可靠性电子器件的发展。
