近日,广东致能科技团队与西安电子科技大学广州研究院/广州第三代半导体创新中心郝跃院士、张进成教授团队等等合作攻关,通过采用广东致能科技有限公司的薄缓冲层AlGaN / GaN外延片,基于广州第三代半导体创新中心中试平台,成功在6英寸蓝宝石衬底上实现了1700V GaN HEMTs器件。
相关研究成果于2024年1月发表于IEEE Electron Device Letters期刊。X. Li et al., “1700 V High-Performance GaN HEMTs on 6-inch Sapphire With 1.5 μm Thin Buffer,” IEEE Electron Device Lett., vol. 45, no. 1, pp. 84–87, Jan. 2024, doi: 10.1109/LED.2023.3335393.
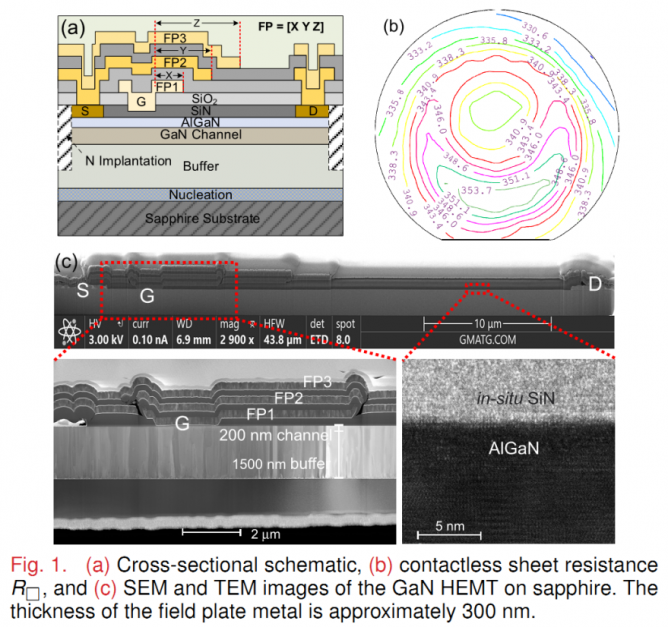
图1:150mm GaN HEMT器件及外延结构图
实现这一器件所采用的GaN外延材料结构包括1.5μm薄层缓冲层和AlGaN/GaN异质结结构。该外延结构由广东致能团队通过MOCVD方法在6英寸蓝宝石衬底上外延实现,其外延结构如图1所示。
1.5 μm的GaN缓冲层具有良好的晶体质量和均匀性,晶圆级方块电阻R□中值为342Ω /□,不均匀度为1.9 %。得益于绝缘的蓝宝石衬底,缓冲层垂直漏电通道被切断,外延/衬底界面处的横向寄生通道也被显著抑制。制备的LGD为30 μm的d - mode HEMT器件具有超过3000 V的高阻断电压(如图2)和17Ω·mm的低导通电阻。
蓝宝石上的薄缓冲层GaN技术可以显著降低外延和加工难度,降低成本,使GaN成为1700 V甚至更高电平应用的有力竞争者。
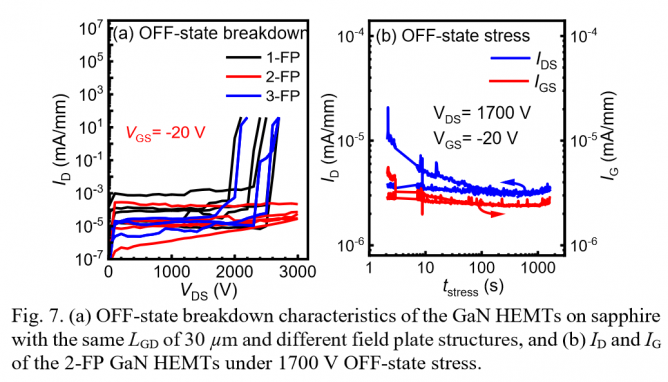
图2:GaN HEMT器件耐压特性以及HTRB结果
蓝宝石衬底上高性能GaN HEMTs的成功展示和评估为即将到来的1700 V商用GaN器件提供了一个非常有前景的选择。1.5 μm的薄缓冲层表现出非常高的均匀性、出色的耐压能力和可忽略不计的电流崩塌。制备的GaN HEMT器件在3000 V以上兼顾了低RON和高VBD,并通过1700 V的长期HTRB应力初步验证了其鲁棒性。
此外,高均匀性、廉价衬底、简单外延等优势势必会加速降低成本,推动GaN HEMT走向更广阔的应用领域。
来源:西安电子科技大学广州研究院/广州第三代半导体创新中心、致能科技





