近年来,SiC(碳化硅)、GaN(氮化镓)等宽带隙(WBG)功率半导体的开发和市场导入速度加快,但与硅相比成本较高的问题依然存在。使用硅片的卧式可以以较低的成本获得GaN的高频特性,但不适合需要650V以上的高耐压的情况。SiC一直是650-1200V 应用的首选宽带半导体,尤其是电动汽车和可再生能源中的逆变器 。650 伏是当今更大的市场,1200 伏产品细分市场也将以很高的复合年增长率更快地增长。不少企业研究GaN取代SiC作为新兴的高压功率开关半导体材料。其中,比利时的研究实验室imec在200毫米晶圆上展示了突破性的氮化镓 (GaN) 工艺,该工艺首次可以在高功率 1200V 设计中采用碳化硅 (SiC)。与 Aixtron的设备合作,imec已经证明了GaN缓冲层的外延生长,可用于200mm QST衬底上的1200V横向晶体管应用,硬击穿电压超过1800V。

近日,第九届国际第三代半导体论坛(IFWS)&第二十届中国国际半导体照明论坛(SSLCHINA)在厦门国际会议中心召开。期间,“功率模块与电源应用峰会”上,西安电子科技大学教授游淑珍做了“面向1200V功率应用的异质衬底横向和垂直GaN器件发展”的主题报告,涉及1200V横向p-GaN HEMT器件、QST衬底上垂直GaN器件的研制、1200V横向D模GaN HEMT器件等研究成果。

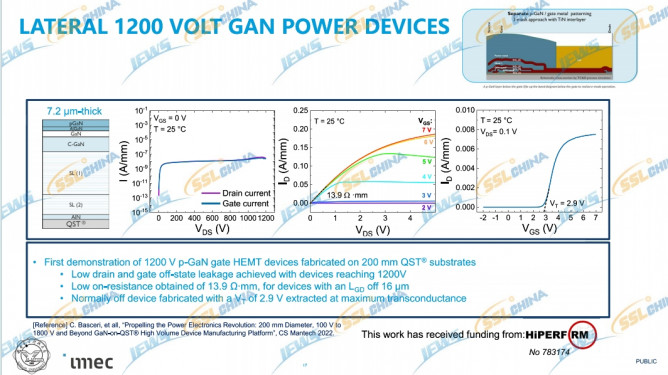
报告回顾了异质衬底上1200V横向和纵向晶体管的研发进展。报告展示了imec基于8英吋QST衬底的氮化镓外延层,该外延层可以实现硬击穿>1200V。在该外延层上制备的增强型p-GaN栅HEMT可承受关态击穿电压>1200V。为了满足如此高的耐压特性,氮化镓缓冲层厚度>7um, 这对外延生长的应力控制提出了挑战。因此,imec采用反向堆叠阶梯型双层超晶格结构,即第一层超晶格等效Al组分低于第二层超晶格等效Al组分。
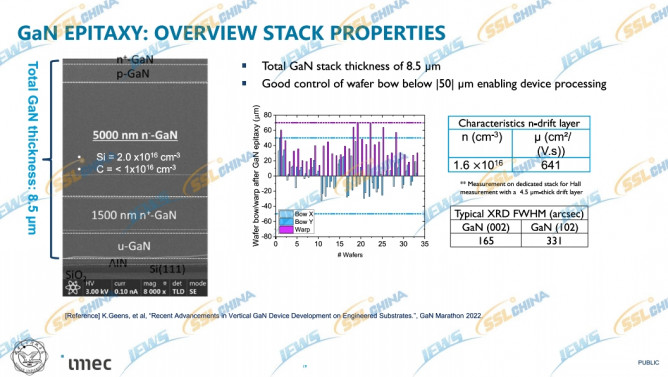

该设计有效的调节了原位生长曲线,使得在生长较厚的缓冲层之后,晶圆翘曲仍然可以被控制在50um以内,满足进入工艺线的基本要求,并保持外延层的机械强度。但是横向晶体管在高压应用中受限于芯片面积占用率以及表面陷阱引起的可靠性问题。与之相反,垂直氮化镓晶体管并不需要增加芯片面积来增加器件关态击穿电压。垂直氮化镓晶体管需要增加垂直方向上漂移层的厚度来增加器件关态击穿电压。报告展示了imec基于8英吋QST衬底的准垂直二极管反向击穿电压约750V,该器件的漂移层厚度为5um。
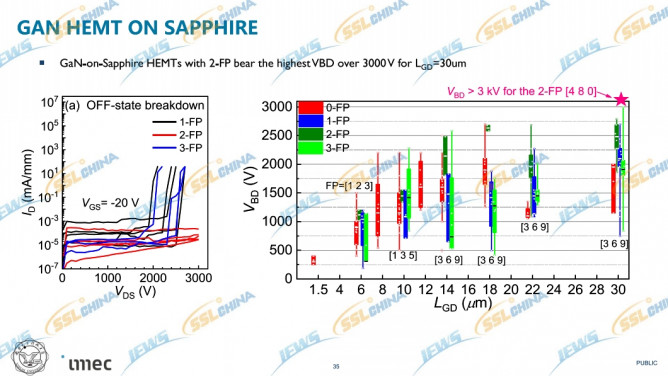
得益于蓝宝石衬底材料的发展,6英吋蓝宝石衬底的价格持续降低,并低于100美元。因此基于蓝宝石上氮化镓的晶体管在高压(>1200V)领域的应用引起了人们的兴趣。报告展示了西安电子科技大学广州研究院及广州第三代半导体创新中心在其中试线上制备了蓝宝石基氮化镓HEMT,该HEMT的缓冲层只有1.5um,远低于同等电压等级的硅基氮化镓器件的缓冲层厚度。该HEMT表现出非常优异的关态击穿特性,击穿电压可以达到3000V以上。另外,蓝宝石基氮化镓HEMT性能的高一致性,便宜的衬底,简单的外延结构都加速了氮化镓器件制造的降本增效,推动氮化镓HEMT进入更广泛的应用领域。
嘉宾简介
游淑珍,教授,海外引进高层次人才,西安电子科技大学教授,比利时微电子中心imec GaN器件研发组长,欧盟项目课题负责人,比利时鲁汶大学博士。国际著名会议IRPS技术委员会成员。
