在IGBT模块的使用过程中,关断时刻的电压尖峰限制着系统的工作电压,特别在高压平台的应用中对于模块电压尖峰要求更高,有些还会增加有源钳位功能来限制电压尖峰。排除模块本身特性外,关断尖峰由回路电感和驱动参数决定。其中回路电感由系统整体的布局结构决定,结构确定后往往很难继续优化,所以匹配驱动参数时尖峰电压也是必须要考虑的因素。
在确定的使用工况下,驱动电路中可调参数一般都只剩门级电容与门级电阻,其中门级电容对于器件关断过程影响较小,想要一个较好的效果往往需要选取上百nF的电容,极大的门级电容会给驱动电路的驱动能力与隔离设计带来较大的挑战,甚至会带来LC震荡问题,所以门级电容调整范围一般较小,普遍通过门级电阻来调整电压尖峰。
门级电阻调整时,大量的工程经验告诉我们,门极电阻增大、关断速度减慢、关断损耗增加、电压尖峰减小。这个规律从NPT型IGBT到FS型IGBT一直都非常直接且有效,但是现在器件渐渐切换至沟槽栅(Trench)IGBT,从关断损耗来看电阻对关断的影响已经大幅减弱(图1),但是关断电阻对于Trench结构IGBT的影响不仅仅是单纯的减弱。
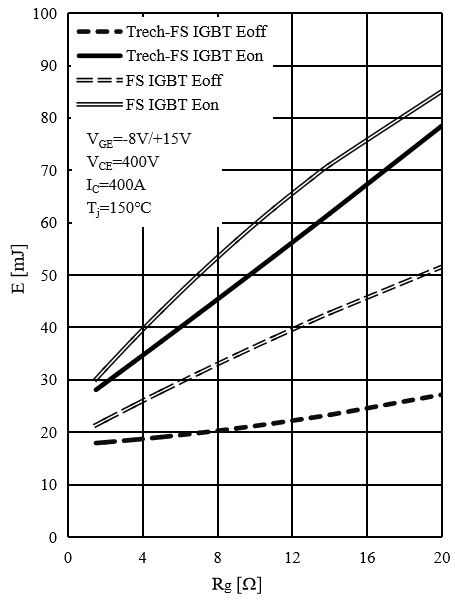
图1:FS IGBT与Trech-FS IGBT开关损耗随电阻变化曲线
图2为一款具有Trench结构的IGBT模块在相同的电压电流下,不断增大电阻后得到的波形。可以看到,门级波形中,其米勒平台电压越来越高,维持时间越来越长,与无Trench结构IGBT一致;但是在电压电流波形的中产生了特别的变化,将Vce波形起点对齐后很明显其电压尖峰随电阻呈现出非单调性变化,尖峰随着电阻的增大先上升后下降,最大值出现在5.6Ω。这显然是在无Trench结构IGBT中极少出现的现象。

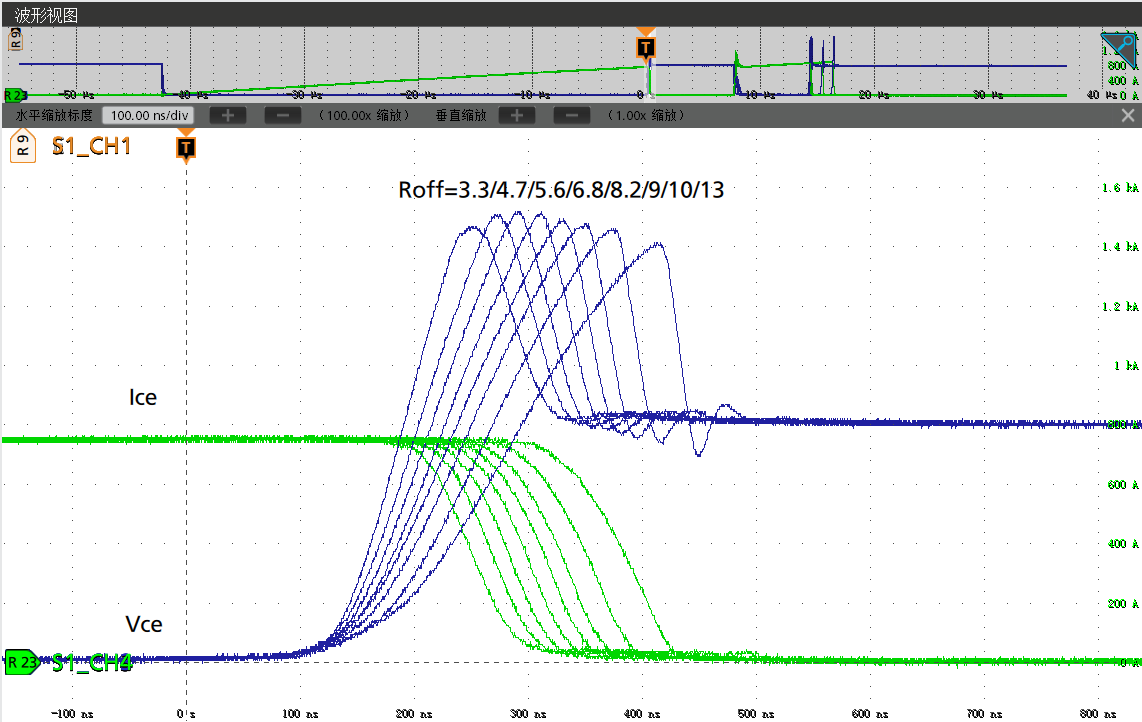
图2:电阻增大的门级波形(上)与电流电压波形(下)
实际上最大电压尖峰对应的电阻不但与芯片本身相关也与模块中芯片的并联个数、模块选定的工作电压值、甚至与实际应用电路有关,它可能对应任何阻值。这种现象就要求应用端进行电阻选取要试用更多、范围更大的电阻,因为增加电阻的单调性规律在Trench结构IGBT已经不再适用。Trench结构IGBT这样独特的特性,与它的设计密切相关。
首先关注IGBT的基本结构(图3),一个IGBT在结构的上等效可以为一个MOS一个PNP管与一个NPN管,在正常应用环境下NPN管不起作用,在开通状态集电极电流分为经过MOS的电子电流Inmos与经过PNP管的空穴电流Ihpnp,所以IGBT属于双极型器件,并且两种电流大小与IGBT所用衬底中电子迁移率和空穴迁移率成正比。
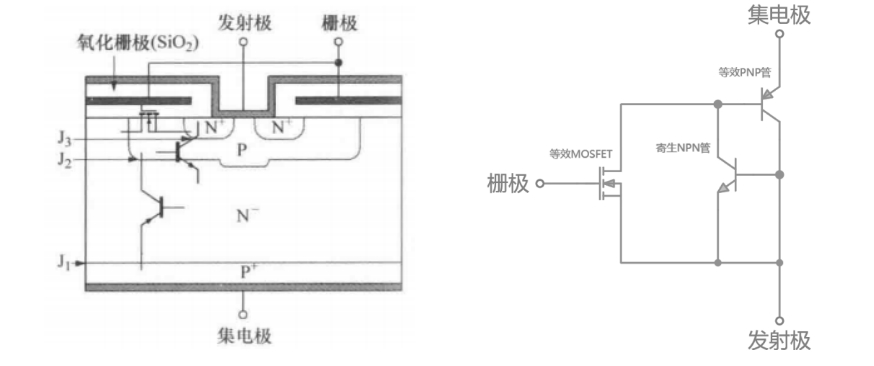
图3:NPT型IGBT(左)与其等效电路(右)
在等效电路图中可以看到,驱动电路给予的电压实际在控制IGBT中的MOS的电子电流,其空穴电流不受驱动电压直接控制。
IGBT的关断过程大体可以分为四个阶段(图4);阶段一:栅极电压下降,但此时栅极电压仍然大于等效MOS在此条件下的阈值电压,电压电流与导通表现一致;阶段二:当栅极电压开始接近等效MOS在此条件下的阈值电压,等效MOS开始关断动作,电子电流开始下降,但是由于外部为感性负载,母线电流不会突变,需要产生额外的电流维持负载电流,这时器件中的载流子被抽取,产生的电流恰好补充下降的电子电流,同时由于载流子消失,空间电场开始建立,电压上升,并且栅极电压由于米勒效应影响维持在米勒平台附近;阶段三:当电压上升至母线电压后,空间电场仍然继续扩展,但电压不再变化,电场强度会降低,此时MOS沟道未完全关断,电流下降过程由MOS沟道的关断特性和载流子的抽取特性共同决定,此时电流快速下降,与外部杂散电感感应出电压尖峰;阶段四:在电流下降至某一值后,空间电场宽度不再扩展,载流子抽取停止,剩余的载流子自行复合,表现为电流的拖尾阶段。
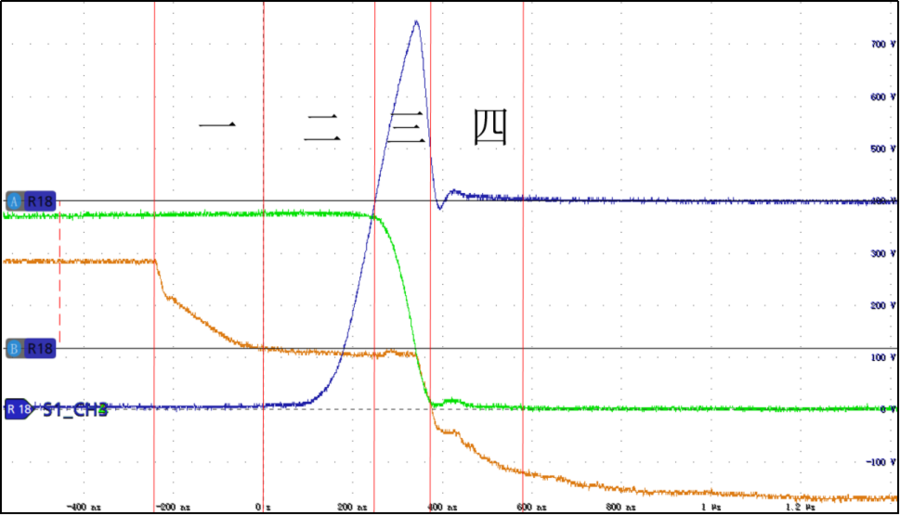
图4:IGBT关断的四个阶段
很明显电压尖峰的产生与电流的快速下降有关,即与IGBT中等效MOS的关断行为和载流子抽取行为有关,而Trench结构IGBT中做出调整的就是其等效MOS管的结构(图5),所以在关断特性上表现出了明显的不同。
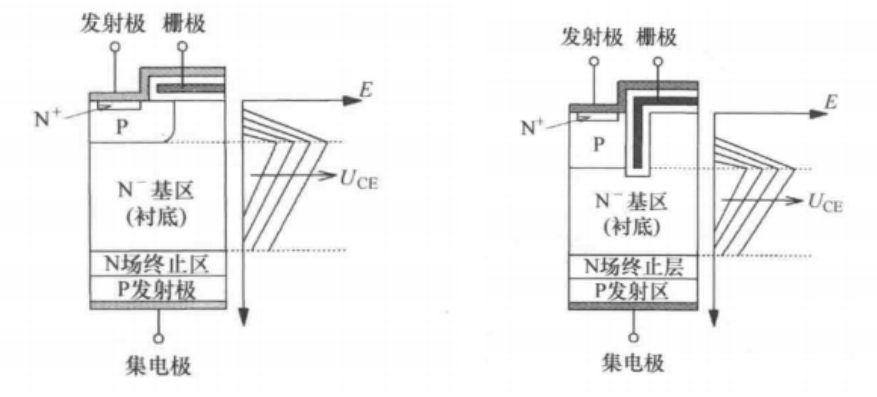
图5:FS IGBT(左)与Trench-FS IGBT(右)
可以看到,Trench结构最大的特点就是栅极进行了向下延申,原有的平面栅在导通过程中的反型沟道仅仅存在于P区中靠近栅极下方的水平面,而沟槽栅在导通过程中反型沟道存在于P区中与栅极靠近的整个垂直区域。这使得Trench结构IGBT导通过程中电子和空穴构成的载流子浓度显著大于平面栅结构。同时Trench结构可以消除平面栅存在的高阻JFET区,降低了导通压降。并且有研究表明,硅基IGBT的通态饱和压降存在理论上的最小值,要实现该最小值且不显著影响器件的关断损耗,N-基区中的通态存储载流子浓度分布需呈现出由发射极侧向集电极侧逐渐递减的特征。
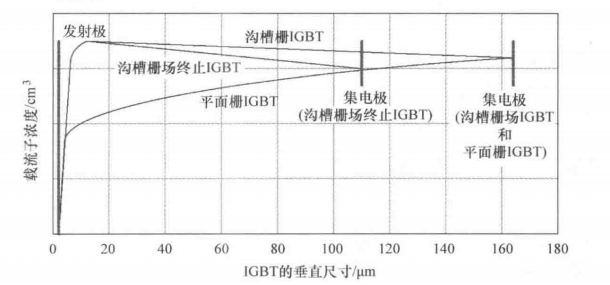
图6:各类IGBT载流子浓度分布
图6为各类IGBT载流子浓度分布,其中平面栅型器件N-基区中的通态载流子浓度分布由发射极侧向集电极侧依次递增,与理想分布变化趋势相反;而沟槽栅型器件N-基区中的通态存储载流子浓度由发射极侧至集电极侧呈现出近似均匀的分布,更加接近理想分布。因此,沟槽栅结构更有利于实现器件通态饱和压降与关断损耗之间的优化折中。Trench结构IGBT这种更高的载流子浓度和更加理想化的载流子浓度分布,使得其在关断时刻,负载电流靠N-基区的载流子被抽取而维持的现象更明显。并且靠载流子抽取产生的电流仅与芯片的设计有关,驱动回路仅能控制其中等效MOS的关断行为。
很明显,与无Trench结构IGBT相比Trench结构IGBT的载流子抽取的效果被加强了。当驱动电阻较小时,米勒平台很低,非常接近等效MOS在此条件下的阈值电压,在电流下降阶段,器件关断过程以载流子抽取行为为主,MOS沟道关断行为影响小;增大电阻,米勒平台上升,MOS沟道关断行为加强,载流子通过抽取行为与MOS沟道两条路径运行,电流变化速度加快;继续增大电阻,MOS沟道关断行为占据主导,电流变化速度减慢,如(图7)。
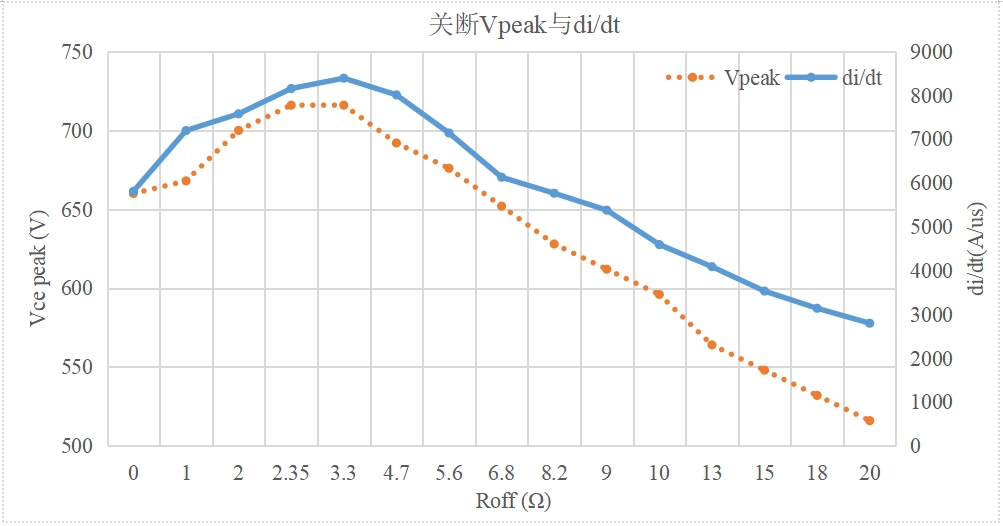
图7:Trench IGBT在0-20Ω关断Vpeak与di/dt
另外当门级电阻足够小时,米勒平台可能低于等效MOS在此条件下的阈值电压,那么MOS沟道在电流下降时已经关断,电流变化只由载流子抽取行为决定,由于载流子通道是有限的,器件的关断速度会固定在某个值不在变化,这个现象在某些Trench结构IGBT也会出现,但是由于材料的物理特性IGBT芯片内部总会存在栅极电阻,芯片也不可能将阈值电压设计设置很低,所以此现象很少发生。
翠展微电子在追求极致的公司理念下,设计Trench结构时已经考虑到这种结构带来的附加影响,并通仿真设计,在不影响关断损耗与导通损耗的情况下,使这种现象的影响在应用端降至最低,这样可以让应用端更方便去进行驱动电阻的选取。翠展微电子自研芯片与模块均已采用Trench结构,整体损耗更低,功率密度更高,可靠性更强。翠展微电子以更高效,更强大的功率器件助力各行业增效节能,让绿色能源成为现实。
来源:翠展微电子





