2022年7月18日,电子五所牵头的T/CASAS 005《用于硬开关电路的GaN HEMT动态导通电阻测试方法》形成委员会草案,该项标准委员会草案按照第三代半导体产业技术创新战略联盟标委会(CASAS)标准制定程序,反复斟酌、修改、编制而成。起草组召开了多次正式或非正式的专题研讨会,得到了很多CASAS正式成员的支持。请CASAS正式成员关注秘书处邮件。
目前基于AlGaN/GaN 异质结结构的GaN平面型场效应晶体管因其低导通损耗和高功率密度能力而成为目前商业化应用的主流器件结构,但在实际应用过程中,工程师仍然对其可靠性有一些担忧。其中,最关键的可靠性问题就是GaN功率器件在开关操作中所面临的动态导通电阻 (RDS(ON)) 退化问题,这种现象也被称为“电流崩溃”现象。由于器件表面陷阱、异质外延层体陷阱所引起的沟道载流子部分耗尽,而造成的器件导通电阻和导通损耗增加的现象。也就是说,GaN器件在承受一段时间高压偏置后再切换到开通状态,实际的导通电压会高于静态导通电阻值。因此,在高频变换器应用中,由动态电阻变化带来的导通电阻增加现象将十分显著,这会大大增加器件的功率损耗,降低器件的工作效率,严重制约GaN功率的器件广泛应用。
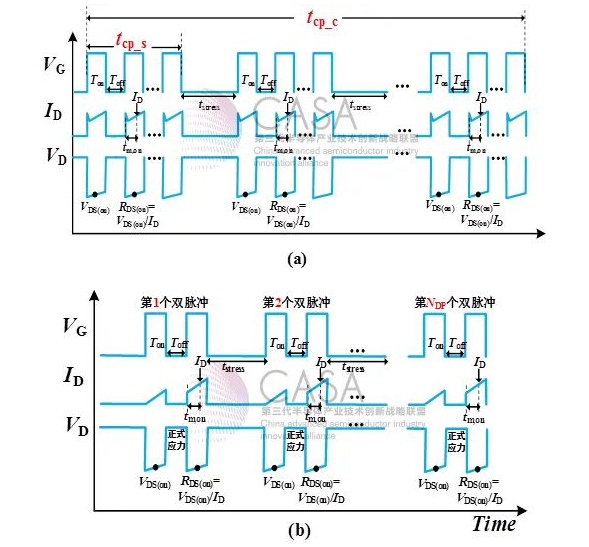
图 硬开关切换过程中动态导通电阻连续脉冲测试波形图(a)和双脉冲测试波形图(b)
由于目前GaN功率器件应用的拓扑结构包含了硬开关及软开关条件,对于动态导通电阻的测试影响程度也不同,因此有必要针对不同应用条件下相关动态导通电阻测试开展分类标准制定。目前,在前期研究基础上,GaN功率器件在硬开关工作条件下的动态导通电阻退化现象要更为明显。前期调研也发现,大部分厂家的测试需求都是针对硬开关拓扑,因此很有必要针对此类测试要求形成具体可操作的标准。因此希望借此标准的制定,有效规范行业内测试方法,使得基于硬开关条件下的动态导通电阻测试结果可有效比对,解决相关设备开发商与器件制造商之间的信息不对称,助力GaN功率器件产业的高质量发展。
T/CASAS 005—202X《用于硬开关电路的GaN HEMT动态导通电阻测试方法》规定了用于硬开关切换电路的GaN高电子迁移率晶体管(HEMT)动态导通电阻测试方法。适用于进行GaN HEMT的生产研发、特性表征、量产测试、可靠性评估及应用评估等工作场景。可应用于以下器件:
a) GaN增强型和耗尽型分立电力电子器件;
b) GaN集成功率电路;
c) 以上的晶圆级及封装级产品。
