东芝电子元件及存储装置株式会社(东芝)开发了用于碳化硅(SiC)功率模块的封装技术,能够使产品的可靠性提升一倍,同时减少20%的封装尺寸。
与硅相比,碳化硅可以实现更高的电压和更低的损耗,且被广泛视为功率器件的新一代材料。虽然目前主要应用于火车的逆变器上,但是很快将被广泛用于光伏发电系统和汽车设备等高压应用。
通过银烧结技术改善提高可靠性
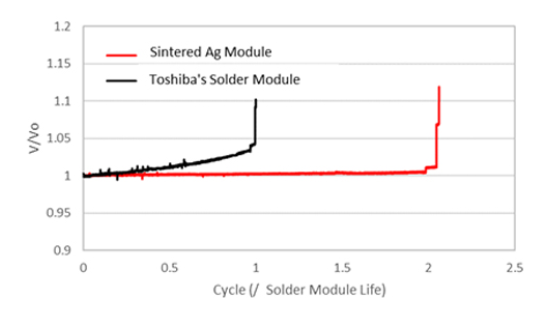
可靠性是碳化硅器件使用受限的主要问题。在高压功率模块中的应用不仅是半导体芯片,封装本身也必须具备高度的可靠性。东芝通过一种全新的银(Ag)烧结技术进行芯片焊接,来实现有效提高封装可靠性的目标。
在当前的碳化硅封装中,功率密度提高以及开关频率都会导致焊接性能劣化,很难抑制芯片中随着时间的推移而增加的导通电阻。银烧结技术可以显著降低这种退化。而银烧结层的热电阻仅为焊接层的一半,从而使模块中的芯片可以更加紧密地靠近,从而缩小了尺寸。
碳化硅功率模块的新封装(iXPLV)

东芝将此新技术命名为iXPLV,并从本月底起其将应用于3.3kV级碳化硅功率模块的批量生产。该技术的详细信息已于5月5日在线上召开的国际功率半导体会议——PCIM Europe上进行了展示。





