钎锌矿结构是由两种具有负电性差的元素(如Ga, N)构成四面体,每个原子与周围四个原子成键,沿六方对称轴方向的键长要大于另外三个方向的键长,导致正负电荷中心不在同一点上,从而产生自发极化效应。如图1左所示,具有(0001)方向(In,Al,Ga)N,4个电负性N原子构成四面体的中心在对称轴(In,Al,Ga)原子上方,或者说,极化矢量P2在轴上方向分量之和小于P1,所以总自发极化方向为N原子中心指向III族原子,即(000-1)方向。而当受到压应力时,如图1中所示,四面体夹角变小,极化矢量P2在轴上方向分量增大,产生(0001)方向压电极化;反之,当受到张应力时,如图1右所示,四面体夹角变大,极化矢量P2在轴上方向分量减小,产生(000-1)方向极化。氮化物自发极化和受到压应力、张应力压电极化场示意图如图2所示。需要注意,极化矢量和极化电场方向相反。

图1(0001)晶面氮化物自发极化(左)、压应力(中)和张应力(右)下极化矢量球棍图:总自发极化方向为(000-1),压/张应力电极化方向为(0001)和(000-1)
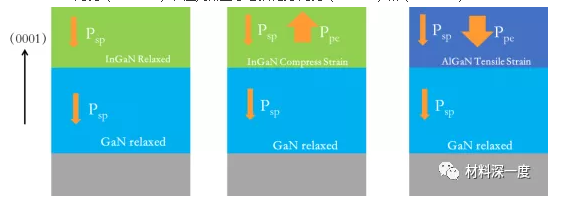
图2 氮化物自发极化和受到压应力、张应力压电极化场示意图
极化效应,包括自发极化和压电极化,是第三代半导体GaN器件需要注意的重要因素。
一、光电子器件:GaN基LED和InGaN基太阳能电池
GaN基LED的有源区由InGaN/GaN多量子阱组成,其中发光波长由量子阱InGaN的In组份和阱宽度决定。由于In原子的晶格常数较Ga原子大,InGaN受到压应力,产生(000-1)方向的压电电场,即由p-GaN指向n-GaN,与LED中内建电场方向相反。压电电场强度远大于内建电场,使InGaN量子阱能带发生陡峭倾斜,电子和空穴空间上被拉开一定距离,波函数重叠积分减小,从而降低辐射复合效率(图3左)。对于InGaN基太阳能电池,将产生同样和内建电场方向相反的压电场,阻碍光生载流子的收集(图3右)。压电极化严重制约着LED和太阳能电池效率的提高。
研发人员通过设计很多新型的InGaN/GaN多量子阱结构来降低压电极化对GaN基LED影响,如三角形量子阱、垒阱In组分渐变结构(Appl. Phys. Lett.105, 033506 (2014))、极化场补偿结构(Appl. Phys. Lett.104, 243501 (2014))等。此外研究人员尝试在压电极化效应小的非极性面,和半极性面(如(11-22)GaN材料的生长。同样,一些复合InGaN吸收层结构((Appl. Phys. Lett.96, 051107,(2010))或调制掺杂(Appl. Phys. Lett.98, 243507, 2011)用以屏蔽极化电荷,抑制压电极化效应的不利影响。当然InGaN基太阳能电池还面临高质量高In组分InGaN吸收层的外延生长等关键问题,而随着In组分的提高,压电极化效应影响将更加严重。而在GaN基LED和紫外LED中,压电极化工程也被用以提高空穴的浓度和运动迁移速度(Science 01 Jan 2010: Vol. 327, Issue 5961, pp. 60-64,Appl. Phys. Lett., 105, 153503 (2014)等)。
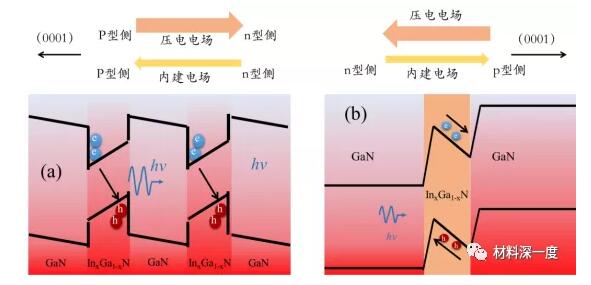
图3 GaN基LED和InGaN基太阳能电池压电效应影响能带示意图:压电电场强度很大,方向为(000-1),同内建电场方向相反
二、电子器件:GaN基HEMT,TFET和隧穿二极管
与GaN基LED和InGaN基太阳能电池中压电极化的负面影响不同,压电极化是GaN基HEMT(High Electron Mobility Transistor,高电子迁移率晶体管)器件的原理基础。如图2右所示,在GaN缓存层上外延生长一定厚度AxGa1-xN层,由于AxGa1-xN的晶格常数小于GaN,所以AxGa1-xN层将受到张应力作用。由于压电极化效应,异质结界面处的净极化电荷为正,而且面密度极高。高密度的正极化电荷产生的强电场将使异质结边界上的能带产生很强突变,形成窄而深的电子势阱。同时该强电场将会吸引材料中其他地方的自由电子被限制在厚度只有几纳米电子势阱中,在与异质结界面平行的平面内运动,此二维沟道被称为二维电子气(2DEG)。隧穿场效应晶体管(TFETs, Tunnel field-effect transistors)通过栅极电压的变化控制带间隧穿电流,被看做是非常有前景的低工作电压和低功耗的逻辑CMOS器件,其Ion和Ion/Ioff都会大于传统MOSFTE,其S可以突破60mV/decade的限制,而且TFET的Ioff非常低,所以TFET的工作电压可以进一步地降低。窄禁带半导体(InGaAs, InAs和GaSb)TFETs已有实验报道,虽然具有较高Ion,但Ioff同样较高。宽禁带半导体理论上可以具有很小Ioff,但是隧穿概率却因宽禁带的属性而较小。如对于GaN同质结,即使n,p侧均掺杂到3*10?/cm?量级,隧穿宽度仍然很大,达15nm,导致隧穿电流,即Ion会较小。利用极化效应的极化工程派上用场,利用强大的极化电场极大缩减隧穿距离,如 InN插入层,或者更加精细复杂的In组分渐变多InGaN层,见图4所示。更多详情可见, University of Notre Dame的PATRICK FAY的文章(Li et al.: Polarization-Engineered III-Nitride Heterojunction TFETs)。压电极化效应也被用以制作二端隧穿二极管,可参考Appl. Phys. Lett., 107, 163504 (2015)等,制作三端二维空穴气器件(A polarization-induced 2D hole gas in undoped gallium nitride quantum wells)。
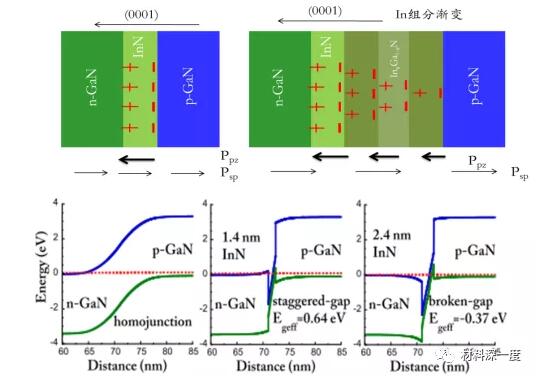
图4 GaN基隧穿二极管示意图:通过 InN插入层,或者更加精细复杂的In组分渐变多InGaN层等极化工程,可以增加隧穿概率
三、ZnO/GaN压电MEMS器件
在压电MEMS器件方面做到几乎登峰造极的就是鼎鼎大名的王中林院士了。博士期间听王中林院士应王占国院士邀请到半导体所做过一场学术报告。报告精彩帅气,行云流水,声情并举,图文并茂。至今十余年过去,至今印象深刻。王中林院士最开始从事电子显微学研究(也是这个领域的世界顶级科学家),后来一直坚持从事基于压电和摩擦式纳米发电机和压电电子学应用基础、功能器件及集成系统研究。王中林院士著作等身,Nature,Science等顶级期刊手到擒来,学术论文被引用总数20万次以上(google),并且压电应用从最开始的ZnO材料,拓展到GaN材料、锆钛酸铅等(PZT)及MoS2等同具压电极化效应的二维材料等。
介绍下王中林院士的纳米发电机鼎定江湖之作(SCIENCE VOL 312 14 APRIL 2006, 242-246),如图5所示:ZnO纳米线正常状态无应力(A),AFM拨动使其受到拉应力(外侧)和压应力(内侧),分别产生压电电势Vs—和Vs+(C,D);ZnO纳米线底部与Ag电极形成欧姆接触,ZnO纳米线顶部与高功函数AFM针尖Pt金属形成肖特基结;在针尖Pt和ZnO纳米线顶部外侧接触时,Pt/ZnO肖特基结反偏,无电流通过(E);而当针尖Pt和ZnO纳米线顶部内侧接触时,肖特基结正偏,形成正向电流,电子从n型ZnO纳米线流向针尖Pt,中和固定压电电荷直至达到平衡(F)。而用VLS法生长ZnO纳米线顶部存留有较大尺寸Au颗粒时,短路效应将不会产生电流(I)。
另一个印象比较深的工作为p-GaN/n-ZnO纳米线阵列的压力传感器(Nature Photonics, DOI: 10.1038/NPHOTON.2013.191)。基于第三代半导体纳米线的压电电子和光电子器件更多可以参考Chemical Review上的综述文章(Chem. Rev. 2019, 119, 15, 9303–9359)。

图5 ZnO纳米线纳米发电机原理:压电效应产生正负电势,使Pt-ZnO肖特基结正偏,电子从n型ZnO纳米线流向针尖Pt,中和固定压电电荷直至达到平衡
(图片来自SCIENCE VOL 312 14 APRIL 2006, 242-246)
四、总结
压电极化效应制约GaN基LED和太阳能电池效率的提高,却是GaN基HEMT器件和ZnO/GaN压电MEMS器件的物理基础和根本。极化效应真是特别让GaN材料和器件研究者“又有喜 又有愁”。
但是“大爱”的研究人员付出“柔情万种”,利用压电极化效应精巧设计“极化工程”结构,提升器件性能,包括突破压电极化效应对LED和太阳能电池效率的制约、提高p-GaN空穴浓度、提升空穴的迁移速率、产生二维空穴气制作HHMT、以及提高隧穿概率制作TFET和隧穿二极管器件等。而基于ZnO/GaN压电效应的MEMS器件、能源器件等也越来越吸引更广泛的兴趣甚至应用。
作者简介
汪炼成,物理电子学博士,中南大学特聘教授,博士生导师,微电子科学与工程系副主任,高性能复杂制造国家重点实验室研究员。博士毕业于中科院半导体研究所, 先后在新加坡南洋理工大学,新加坡科技大学和英国谢菲尔德大学从事博士后研究工作,科研方向为第三代半导体电子/光电子器件和系统集成。
