近日,国家信息光电子创新中心(NOEIC)和鹏城实验室的光电融合联合团队完成2Tb/s硅光互连芯粒(chiplet)的研制和功能验证,在国内首次验证了3D硅基光电芯粒架构,实现了单片最高达8×256Gb/s的单向互连带宽。
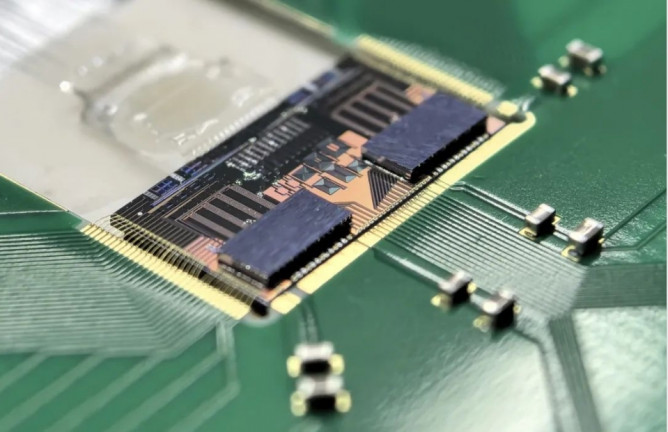
2Tb/s 硅基3D集成光发射芯粒
随着人工智能应用的快速发展,AI算力系统对于高效能互连技术的需求呈现爆发性增长态势。为了满足这一挑战,业界正大力研发更大容量、更高速率、更高集成度的硅基光互连芯片解决方案,把硅光收发芯片直接集成到计算芯片附近或同一封装内,极大地减少信号传输的延迟和功耗,从而显著提升算力系统的整体性能。然而,面向下一代单通道200G以上(200G per lane)的光接口速率需求,硅光方案在速率、功耗、集成度等方面面临着巨大挑战。
该团队在2021年1.6T硅光互连芯片的基础上,进一步突破了光电协同设计仿真方法,研制出硅光配套的单路超200G driver和TIA芯片, 并攻克了硅基光电三维堆叠封装工艺技术,形成了一整套基于硅光芯片的3D芯粒集成方案。
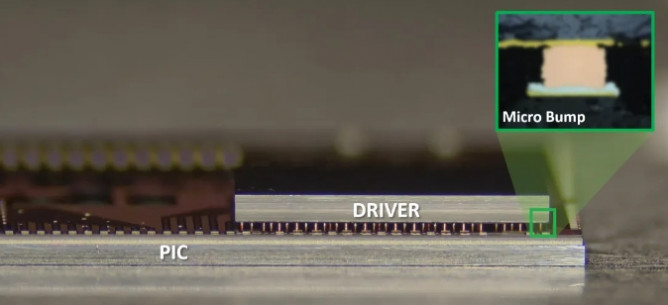
硅光互连芯粒的侧向显微镜结构
该方案充分利用了硅光与CMOS封装工艺兼容的特点,相比于传统wirebond方案,3D芯粒能解决电芯片与光芯片间高密度、高带宽电互连的困难,显著降低射频信号在光-电芯片互连过程中的严重衰减。经系统传输测试,8个通道在下一代光模块标准的224Gb/s PAM4光信号速率下,TDECQ均在2dB以内。通过进一步链路均衡,最高可支持速率达8×256Gb/s,单片单向互连带宽高达2Tb/s。

8×224Gb/s硅基光发射芯粒输出眼图
据介绍,该工作充分展现了3D集成硅光芯粒的优越互连性能,以及联合团队的领先自主研发水平。该成果将广泛应用于下一代算力系统和数据中心所需的CPO、NPO、LPO、LRO等各类光模块产品中,为国内信息光电子技术的率先突围探索出可行路径。
目前,全球量产硅光芯片产品的主流传输速率为800Gb/s,1.6Tb/s产品刚刚发布。此次,由国家信息光电子创新中心等单位自主研发的2Tb/s硅光芯粒样品,已达到国际先进水平。预计近期可以实现高端硅光芯片的批量商用。
(来源:国家信息光电子创新中心)





