在现代电子工业中,热管理是一个关键的挑战。半导体器件产生大量的废热,这些废热必须在规定的温度范围内有效地消散,以维持器件的性能和可靠性。这些热量通过具有显著热阻的层和界面从器件热点传递到换热器进行散热。最近的研究主要集中在用高导热材料取代普通衬底以降低总体热阻。金刚石的各向同性是所有块状材料中最高的,这使它成为芯片冷却的理想散热材料。模拟表明,薄金刚石可以将热阻降低20%。然而,金刚石冷却器在实际应用中的进展仍然有限。实现低热边界阻(TBR)的金刚石近结集成是一个关键的挑战。
金刚石在器件上的成功集成在很大程度上取决于金刚石/半导体连接接口的设计。这些接口的优化对于最小化TBR,同时确保足够的机械稳健性以承受长期可靠运行至关重要。此外,应避免高加工温度,因为它们对实现与半导体制造工艺。此外,在芯片封装过程中,金刚石/半导体连接需要表现出足够的热稳定性,以承受随后的焊料回流(温度高达300°C)。
由于金刚石和半导体在晶格常数、硬度、德拜温度和热膨胀系数(CTE)等方面存在广泛的不匹配,因此解决这些问题需要付出专门的努力。在过去的几十年里,人们进行了各种各样的尝试,其中涉及三种主要的技术方法:在金刚石上外延生长半导体;化学气相沉积法(CVD)直接生长金刚石以及金刚石与半导体的结合。然而,目前这些方法面临着TBR大、加工温度高、可靠性低和效率有限等挑战。

近日,厦门大学钟毅和华为技术有限公司赫然联合针对解决现代电子器件的热管理问题取得最新进展。该文提出了一种集体晶圆级键合技术,通过反应性金属纳米层在 200°C 下连接多晶金刚石和半导体。由此产生的硅/金刚石连接具有 9.74m2GW-1的超低 TBR ,大大优于传统的芯片连接技术。这些连接还表现出卓越的可靠性,可承受至少1000次热循环和1000小时的高温/潮湿考验。这些特性与所设计的金属夹层的再结晶微观结构有关。该演示代表了金刚石在半导体上的低温和高通量集成的进步,有可能使目前受热限制的电子应用成为可能。研究成果以“Low-temperature bonding of Si and polycrystalline diamond with ultra-low thermal boundary resistance by reactive nanolayers”为题发表在《Journal of Materials Science & Technology 》。
图文导读
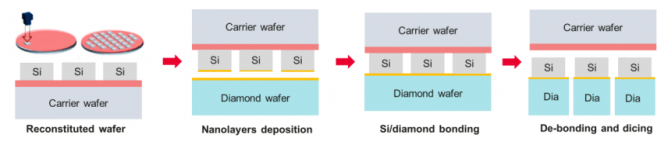
图1. 晶圆级硅/金刚石键合工艺示意图。
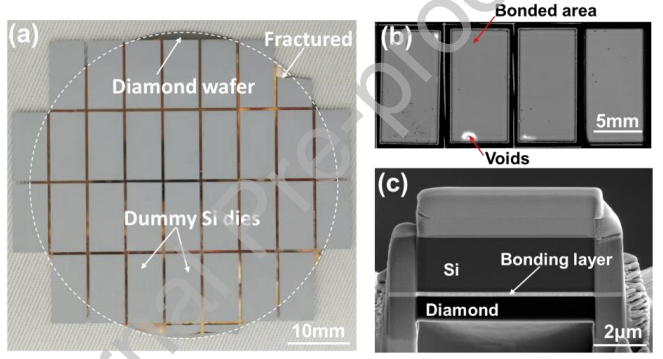
图2. (a) 2英寸金刚石晶片与Si模结合的照片,(b)扫描声显微镜测定的典型键合孔隙率,(c)截面显微结构显示出一条均匀的结合线。
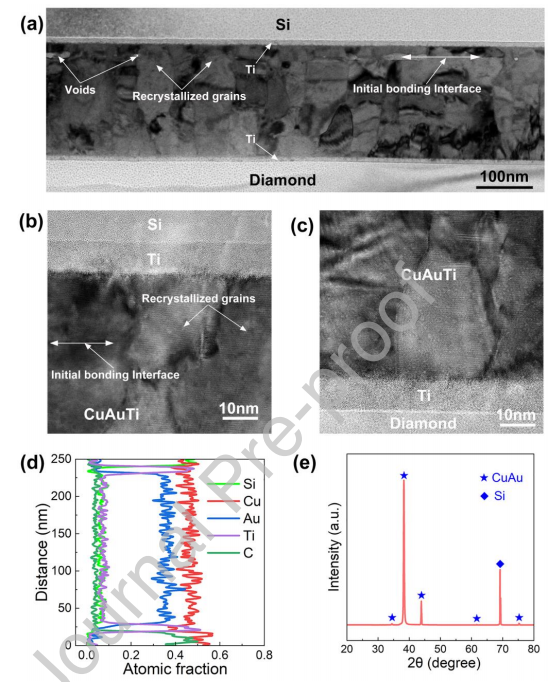
图3. (a) Si/金刚石结合层的TEM分析,(b, c) Si/metal和金刚石/metal界面的高分辨率TEM图像,(d)扫描线上EDS元素浓度分布图,(e)键合样品的XRD谱图,表明CuAu固溶相的形成。
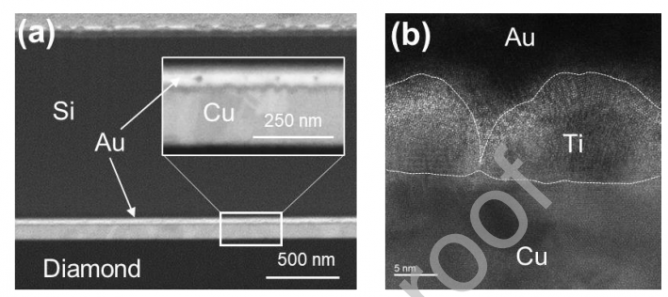
图4. (a)室温预键合后的金刚石/硅界面微观结构(b) Ti纳米层中明显的晶界。
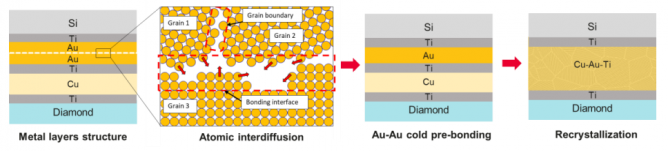
图5. Si/金刚石连接通过两步工艺实现:室温AuAu预键合和低温Cu-Au-Ti再结晶。
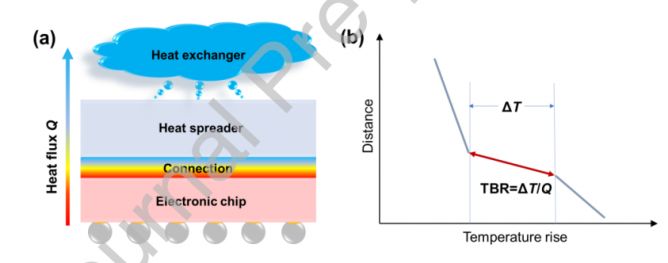
图6. (a)电子封装中的TBR示意图和(b)相应的温升。
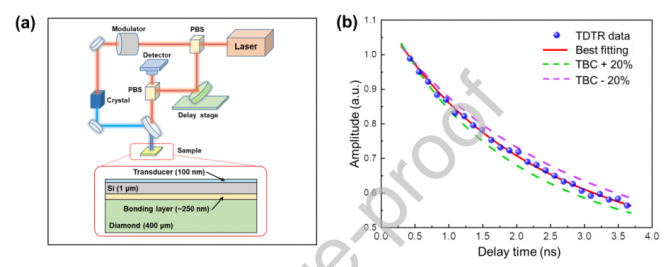
图7. (a) TDTR的设置示意图和测试样品的结构,(b) TDTR幅度信号作为延迟时间的函数。
