功率密度的提高及器件小型化等因素使热量的及时导出成为保证功率器件性能及可靠性的关键。作为界面散热的关键通道,功率模块封装结构中连 接层的高温可靠性和散热能力尤为重要。纳米银烧结技术可以实现低温连接、高温服役的要求,且具有优秀的导热导电性能和高温可靠性,已成为近几年功率模块封装互连材料的研究热点。

第九届国际第三代半导体论坛(IFWS)&第二十届中国国际半导体照明论坛(SSLCHINA)在厦门国际会议中心召开。期间,“碳化功率器件及其封装技术分会“上,日本大阪大学副教授陈传彤做了“SiC功率模块中微米级Ag烧结连接技术的进展”的主题报告,分享了微米级银烧结体的连接与性能研究、Ag-Si复合浆料提高SiC功率模块可靠性、全银烧结浆料的高散热SiC结构的研究进展。
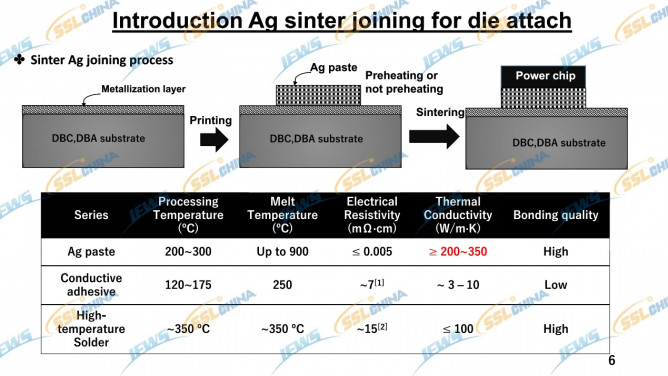

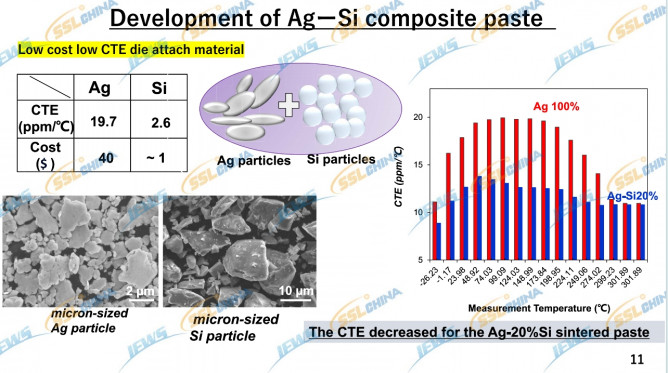
涉及用于模具附着材料的银烧结浆料连接,银微粉烧结浆料,银薄片浆料烧结,高温老化可靠性试验,热冲击试验(-50℃~250℃),Ag烧结体功率循环连接可靠性试验,SiC SBD试样的截面研究,全银烧结浆料的高散热SiC结构,高温老化可靠性试验,采用银烧结膏的先进功率模块结构等。


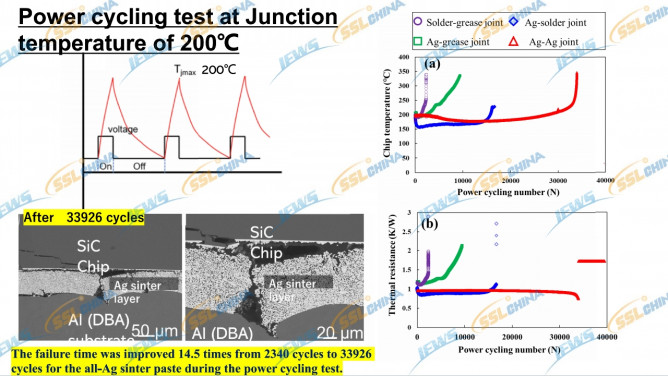
报告指出,在高温老化和功率循环测试下,银微米颗粒烧结连接提供了优异的结合质量和可靠性。Ag-Si复合浆料可提高热冲击可靠性;与传统的焊料和TIM油脂接合相比,全银烧结接合使芯片表面温度从270℃降低到180℃,热阻也从1.5 K/W降低到0.8 K/W。在功率循环试验中,全银烧结浆料的失效时间从2340次循环提高到33926次循环,提高了14.5倍。
嘉宾简介
陈传彤,于2015年获得日本名古屋工业大学机械电子工程博士学位。2016年至2019年,他担任日本大阪大学科学技术研究所助理教授,2020年起就职大阪大学3D电子封装联合实验室副教授。专注于第三代宽禁带半导体大功率模块器件高温高频下的银浆为代表的高温互连材料的研究开发以及电-热-力学多外场作用下互连材料的微观结构与性能演化、和高密度封装结构的服役可靠性检测/热扩散评价的应用研究。
发表包括IEEE T Power Electr、Acta Mater、scripta Mater、Appl Phys Lett、Ceram Int在内的Sci和Ei论文190余篇,近5年引用超2300次,h-index 27(Google Scholar)。 申请日本,美国和国际PCT专利共计20余项。并参与编著第三代功率模块器件封装类英语著作1部,日语著作8部。连续3年获得日本田中贵金属奖,和包括日本电子封装学会,国际IEEE ICEP最佳论文奖,IEEE EMPC 最佳海报奖和 IEEE CPMT Japan Chapter Young Award (2017)等多个奖项。
另外,担任日本电子封装学会関西支部委员会委员,日本第三代宽禁带半导体封装热评价体系和设备国际标准化委员会委员和IEEE ICEPT技术委员会委员。并受邀参加The Electrochemical Society meeting(ECS),IEEE Applied Power Electronics Conference and Exposition (APEC)等在内的国际知名学会20余次。近3年主持的包括日本经济产业省(NEDO),文部科学省在内的各项经费超过2000万人民币和实现了多项成果的市场转化与应用。
(备注:以上信息仅根据现场整理未经嘉宾本人确认,仅供参考!)
