氧化镓是超宽禁带半导体材料的优异代表,由于其禁带宽度和击穿场强远高于GaN,不仅可在更高场强、更高工作电压下工作,大幅度提升输出功率密度,还可以实现在高温、强辐照等极端环境下的应用。约翰逊优值(JFOM)与材料的击穿场强和载流子的最大速度的乘积有关,综合考虑了射频器件的频率和功率特性,是衡量射频器件综合性能最重要的指标,氧化镓的JFOM大约是GaN的2.6倍,表明氧化镓在射频器件领域同样具有可观的应用前景。美国空军研究实验室、布法罗大学等国外机构已相继布局开展氧化镓射频器件的研究。目前氧化镓射频器件面临的问题较多,由于短沟道效应、迁移率、热导率等因素的制约,氧化镓射频器件频率、电流密度、功率密度等性能指标仍然处于较低的水平。特别是,氧化镓的热导率极低,仅为10W/m⋅K,是SiC的2%,导致氧化镓射频器件的散热能力极差。严重的自热效应导致器件功率和频率难以协同提升,很大程度上掣肘了氧化镓射频器件的发展。
应对上述挑战,由南京大学、南京电子器件研究所、中国科学院上海微系统与信息技术研究所、中国科学院苏州纳米技术与纳米仿生研究所和西安电子科技大学杭州研究院组成的联合研究团队,提出基于高导热碳化硅衬底与氧化镓射频器件异质集成的架构设计,利用万能离子刀剥离和转移技术实现了2英寸高质量SiC衬底与50nm超薄氧化镓薄膜的晶圆级异质集成(图1a),结合低能离子注入沟道技术(IEEE Electron Device Lett. 44, 1060, 2023),在国际上首次实现碳化硅基氧化镓异质集成射频器件,器件的频率性能达到目前公开报道最高值,相关成果以“Heterointegrated Ga2O3-on-SiC RF MOSFETs with fT/fmax of 47/51 GHz by Ion-cutting Process”为题,于2023年10月24日在IEEE Electron Devices Letters上在线发表。

器件直流特性
栅长0.1μm的氧化镓异质集成射频器件电流密度高达661 mA/mm,导通电阻低至24Ω·mm。该器件在-8V栅压下关断较好,没有出现明显的短沟道效应,如图1b所示。在15V漏压下,阈值电压为-7.5V,跨导57mS/mm。在-12V偏置栅压下,关态电流低于1nA/mm,击穿电压达到90V,表明器件即使在高场下也未出现漏至势垒下降效应。对比研究,相同结构的氧化镓同质衬底器件电流密度仅为235mA/mm,出现明显的自热效应。这表明异质集成技术可有效提升器件的散热能力。结合C-V和I-V曲线,提取了不同栅压下沟道的电子面浓度、迁移率和方阻。结果表明,充分利用氧化镓硅离子激活温度低、热扩散长度小的优势,通过低能硅离子注入结合快速退火技术,实现了高电子浓度的类似2DEG的超薄导电沟道,沟道电子主要分布在距氧化镓表面10nm范围内,可以有效解决射频器件的短沟道效应(图1c)。当栅压为8V时,电子面密度高达1.83×1013cm-2,迁移率为67cm2/V·s,沟道方阻低至5.07kΩ/sq。当栅压降低至-1V时,电子面密度随之降低至1.1×1012cm-2,对应的迁移率提高到118cm2/V·s (图1d)。与氧化镓同质衬底器件相比,由于自热效应的有效抑制,沟道迁移率得到显著提升,这也是助力氧化镓异质射频器件电流密度提升的重要原因。
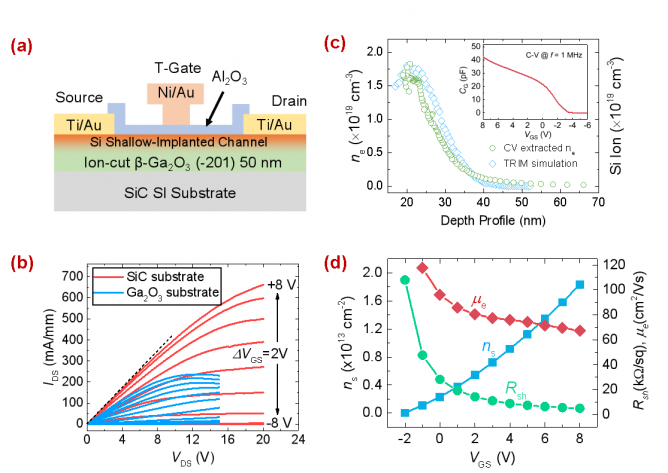
图1. SiC基Ga2O3异质集成射频器件 (a)横截面结构示意图;(b)直流输出特性;(c) C-V曲线和提取的电子浓度分布;(d)不同栅压下沟道的电子面浓度、迁移率和方阻。
频率特性和功率输出性能
栅长为0.1μm器件的截止频率fT和最大振荡频率fmax分别达到了47GHz的和51GHz,为目前氧化镓射频器件公开报道的最高水平,如图2a所示。图2b和2c对不同栅长的氧化镓射频器件的截止频率fT和最大振荡频率fmax进行对比。采用传统体掺杂沟道,当栅长缩短至0.2μm以下时,器件的截止频率fT不再随栅长的减小而继续上升,表明器件已出现明显的短沟道效应。本工作采用低能离子注入沟道和异质集成技术后,栅长0.5μm的器件fT·LG为5.45GHz·μm,对应的载流子饱和速度高达3.42×106 cm/s,与AlGaO/Ga2O3调制掺杂结构的射频器件相当,表明采用低能离子注入沟道技术获得了与2DEG性能相近的载流子输运沟道。
采用负载牵引系统对栅长0.1µm的氧化镓异质集成射频器件在2GHz频率下的功率输出特性进行了测试。器件工作在连续波(CW)模式下,饱和输出功率密度为296mW/mm,功率增益11dB,最大功率附加效率(PAE)为25.7%。随着输入功率的增加,功率增益一直保持较高水平,在输出功率饱和前没有出现明显的下降。图2d对公开报道的氧化镓射频器件在不同频率下的输出功率密度进行了对比,输出功率密度与工作频率呈反比关系,连续波下的输出功率密度普遍小于脉冲模式下的。目前,公开报道的2GHz下连续波最大输出功率为213mW/mm,其漏极工作电压为20V。得益于更高的饱和电流密度和更好的散热能力,本工作研制的氧化镓异质集成射频器件在15V工作电压下即实现了296mW/mm的连续波输出功率密度。

图2. 栅长0.1μm的氧化镓射频器件(a)小信号增益;不同栅长氧化镓射频器件(b)截止频率和(c)最大振荡频率对比;(d)不同频率下氧化镓射频器件的输出功率密度对比。
综合而言,低能离子注入技术在沟道掺杂浓度和深度设计上具有较高的灵活度,通过优化注入剂量和能量可实现高浓度的超薄导电沟道,抑制氧化镓射频器件的短沟道效应,减小低迁移率导致的较高的沟道方阻,从而提升器件的电流密度和频率特性;采用高热导率的碳化硅衬底与超薄氧化镓薄膜的抑制集成,可显著改善氧化镓射频的散热能力,抑制器件的自热效应,提升器件的电流密度,实现在连续波下工作。这一研究工作为氧化镓射频器件的发展开辟了新的解决思路,在一定程度上解决了制约氧化镓射频器件面临的关键技术问题,有望推动氧化镓在射频器件领域的发展。
该研究工作由南京大学、南京电子器件研究所、中国科学院上海微系统与信息技术研究所、中国科学院苏州纳米技术与纳米仿生研究所和西安电子科技大学杭州研究院共同完成。南京大学博士生、南京电子器件研究所高级工程师郁鑫鑫与中国科学院上海微系统与信息技术研究所徐文慧博士为共同第一作者,叶建东教授、李忠辉研究员、欧欣研究员和韩根全教授为论文通讯作者。该研究工作得到了科技部国家重点研发计划、国家自然科学基金重大/重点项目和广东省重点研发计划等项目的支持。





