当前世界上的半导体元件,绝大多数是以第一代半导体材料硅基半导体为主,约占95%的份额,但是随着电动汽车,5G通讯等新兴技术的发展,以氮化镓,碳化硅为代表新型基材越来越受到重视。第三代半导体,以碳化硅为代表,其具有禁带宽度大,击穿电场高,饱和电子漂移速度高,导热率大等特点,特别是在1200V的高压环境中,有着明显的优势。
SIC晶体具有与GaN材料高匹配的晶格常数和热膨胀系数以及优良的热导率,是GaN基的理想衬底材料,如LED,LD。因此,SiC衬底加工技术是器件制作的重要基础,其表面加工的质量和精度,直接会影响外延薄膜的质量以及器件的性能,所以碳化硅衬底材料的加工要求晶片表面超光滑,无缺陷,无损伤,表面粗糙度在纳米以下。
但是,碳化硅晶体具有高硬度,高脆性,耐磨性好,化学稳定性好等特点,这又使得碳化硅晶片的加工变得非常困难。
碳化硅衬底的加工主要分为以下几个工序,切割,粗磨,精磨,粗抛,精抛(CMP)。
1.切割
切割是将SiC晶棒沿着一定的方向切割成晶体薄片的过程。将SiC晶棒切成翘曲度小,厚度均匀的晶片,目前常规的切割方式是多线砂浆切割
2.研磨
研磨工艺是去除切割过程中造成碳化硅晶片的表面刀纹以及表面损伤层,修复切割产生的变形。由于SiC的高硬度,研磨过程中必须使用高硬度的磨料(如碳化硼或金刚石粉)研磨SiC切片的晶体表面。
常规的研磨工艺一般分为粗磨和精磨。
1)常规双面磨工艺
目前国内较多的碳化硅衬底厂商已经在规模化生产的工艺方案。
a)粗磨:采用铸铁盘+单晶金刚石研磨液双面研磨的方式
该工艺可以有效的去除线割产生的损伤层,修复面型,降低TTV,Bow,Warp,去除速率稳定,一般能达到0.8-1.2um/min的去除率。但该工艺加工后的晶片表面是亚光面, 粗糙度较大,一般在50nm左右,对后工序的去除要求较高。

b)精磨:采用聚氨酯发泡Pad+多晶金刚石研磨液双面研磨的方式
该工艺加工后的晶片表面粗糙度低,能达到Ra<3nm,这更有利于碳化硅衬底片后工序的抛光,但划伤不良一直存在。且该工艺使用的是爆炸法工艺制备的多晶金刚石,其生产难度大,产量低,价格极高。

2)团聚金刚石双面研磨工艺
国内部分衬底厂家也导入了一种新工艺,团聚金刚石研磨工艺。该工艺良率更高,成本更低,精磨损伤层更低,更有利于抛光。该工艺也分粗磨和精磨两步。这个工艺,国内比较知名是深圳中机,其团聚产品能覆盖粗磨,精磨等全工序。
a)粗磨:1.5um团聚金刚石研磨液+蜂窝树脂Pad,双面研磨工艺
该工艺采用的金刚石是团聚金刚石磨料,1.5um的金刚石原晶,去除速率一般稳定在0.8-1.2um/min,面粗在20nm左右

b)精磨:0.2um团聚金刚石研磨液+树脂Pad/聚氨酯发泡Pad,双面研磨工艺
该工艺采用的金刚石是0.2um原晶的团聚金刚石磨料,加工后的面粗在3nm以内。
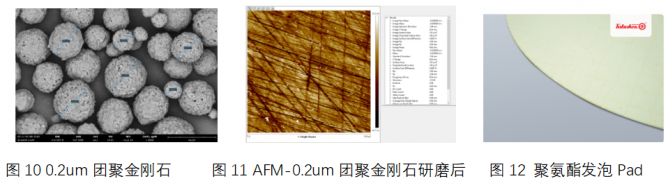
3)砂轮单面减薄工艺
部分碳化硅衬底厂商采用砂轮减薄,目前常用的砂轮有2000#粗磨,8000#精磨。该工艺方案加工灵活,稳定性高,工艺精简。但由于减薄过程中晶片是在真空条件下,不利于Bow/Warp的修复。此外国产精磨砂轮磨耗比大,加工成本高,多依赖进口。
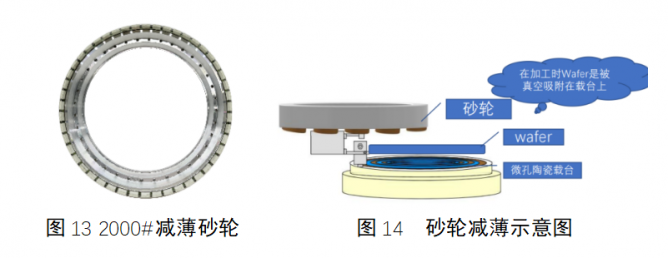
目前该工艺在日本较为成熟,甚至已经用到了30000#精抛砂轮,加工后的晶圆片表面粗糙度能达到2nm以内。加工后的碳化硅衬底片可以直接进行最后一道CMP抛光。
3.抛光
通常碳化硅衬底厂的抛光工艺分为粗抛和精抛
1)粗抛:常用的粗抛工艺采用高锰酸钾氧化铝粗抛液搭配无纺布粗抛垫,通常采用的是无纺布抛光垫。高锰酸钾起到氧化腐蚀作用,纳米氧化铝颗粒起到机械磨削的作用,加工后的碳化硅衬底片表面粗糙度能达到0.2nm以内。
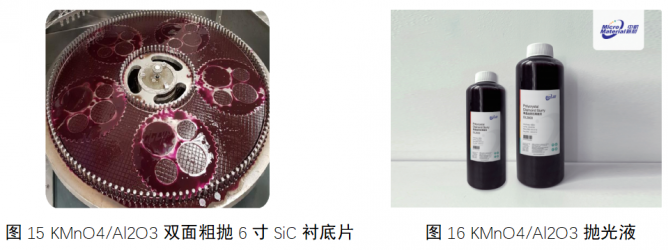
2)精抛:通常采用100nm以内的氧化硅抛光液搭配黑色阻尼布精抛垫使用,使用单面抛光机对碳化硅衬底片的Si面进行抛光。常见的CMP精抛液是AB组份,抛光液通常是搭配双氧水使用,其中双氧水起到氧化腐蚀的作用。该工艺加工后的碳化硅衬底片表面粗糙度能达到0.1nm以内。常用来检测精抛后碳化硅衬底片划伤的设备是Candela 8520。
化学机械抛光是通过化学腐蚀和机械磨损协同作用,实现工件表面材料去除及平坦化的过程。晶片在抛光液的作用下发生化学氧化作用,表面生成化学反应层,随后该反应软化层在磨粒的机械作用下被除去。





