对于 0.33 NA 系统,22 nm 间距只能通过填充 4% pupil的illumination来支持,远低于标称吞吐量的 20% 下限(图 1)。
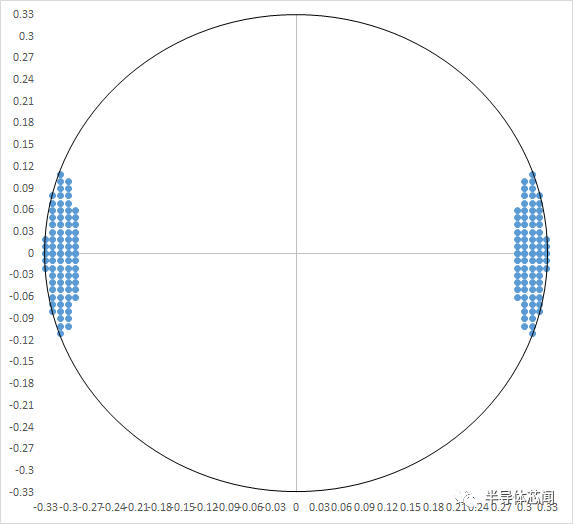
图 1. 22 nm 间距的允许illumination仅填充 0.33 NA pupil的 4%。
这意味着吞吐量可能会大大低于 100 wph @40 mJ/cm2 ,因为大部分光在到达掩模之前就被聚光镜吸收了。例如,额外的光吸收本身就是组件加热的一个问题。因此,即使使用 EUV,44 nm 间距的图案化也可以加倍以实现 22 nm 间距。
对于 0.55 NA 系统,希望单次曝光可以同时图案化水平和垂直 22nm 间距特征,pupil填充率超过 20%。然而,一些 2D 特征,例如 31 nm 间距交错触点/通孔(图 2),由于遮挡消除了最低衍射级,因此无法方便地与这种曝光兼容。

图 2. quasar illumination形状需要满足布局中 22 nm 的水平和垂直间距,但 31 nm 交错特征将进一步限制illumination,低于pupil的 20%。
22 nm 节距quasar illumination的较小部分使得最低衍射级避免了遮挡可以安全使用,但填充的pupil不到 20%,这再次意味着额外的聚光镜吸收和减少的吞吐量,如 0.33 NA 的情况。这种图案不兼容性在现有的光刻系统中没有出现,因为它们没有任何遮蔽。但对于 0.55 NA EUV 系统,如果这种交错的 2D 图案需要与水平和垂直特征保持一致,则必须单独曝光。
由于焦深减小,22 nm(或更小)间距 0.55 NA 单次曝光将需要使用超薄(≤20 nm)光刻胶。对于 20 nm 的光刻胶厚度,化学放大光刻胶 (5/um) 的吸收率将下降到 10%,金属氧化物光刻胶 (20/um) 的吸收率将下降到三分之一,这意味着大部分能量将被光刻胶下方吸收 。这种能量的有限部分可以作为返回的光电子和二次电子返回到光刻胶,因为这些电子实际上优先平行于抗蚀剂/底层界面发射(图3)。
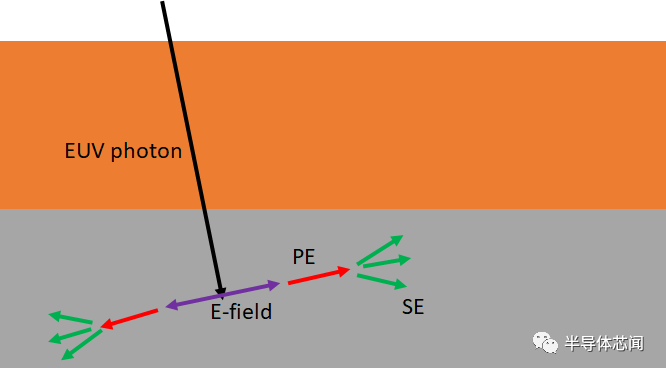
图 3. 在光刻胶厚度低于 30 nm 时,大部分 EUV 光子(黑色)在抗蚀剂膜(橙色)下方被吸收,光电子(红色)和二次电子(绿色)大部分平行于界面发射。光电子发射优先沿电场方向(紫色)定向,随后的二次电子发射优先保持光电子方向。
因此,随着光刻胶变薄,EUV 曝光的能量效率会降低。此外,减少的吸收加剧了随机效应。因此,即使在 3nm 的 EUV 中,多重图案也有望得到显着的应用。因此,应重新考虑 EUV 使用对环境的影响。
原文链接:





