作者简介:柏松,中国电子科技集团公司第五十五研究所、宽禁带半导体电力电子器件国家重点实验室,研究员,研究方向为宽禁带半导体电力电子器件。
碳化硅电力电子器件已经成为国内外研究和产业化热点,在一些应用领域正在逐步取代硅基电力电子器件。
本文概述了碳化硅材料和器件的特性,综述了国际上碳化硅电力电子器件技术的发展现状,展示了宽禁带半导体电力电子器件国家重点实验室在该领域取得的最新技术进展。
碳化硅(SiC)作为继硅和砷化镓之后发展起来的宽禁带半导体的重要代表,正在成为制作高性能电力电子器件的理想半导体材料,已经显现出由其材料特性预测的性能优势,部分SiC器件成功实现了产业化,在一些重要的能源领域开始逐步取代硅基电力电子器件。
SiC电力电子器件优势
更高电压、更高效率、更高功率密度代表了电力电子器件技术的发展主题。
在2020年之前的50年中,硅基电力电子器件技术日益成熟,产业规模不断壮大,在能源领域发挥了不可或缺的作用。
然而受材料特性所限,硅基电力电子器件性能正在接近其理论极限,难以继续支撑技术和产业快速前进的要求。
进入21世纪后,尤其是在2010-2020年,诸多新兴的半导体材料成为工业界的热点,凭借优越的材料特性为电力电子器件技术带来了新的发展动力。
下表列出了硅和各类新兴半导体材料的特性,其中4H-SiC和氮化镓(GaN)属于宽禁带半导体,而氧化镓和金刚石为超宽禁带半导体。
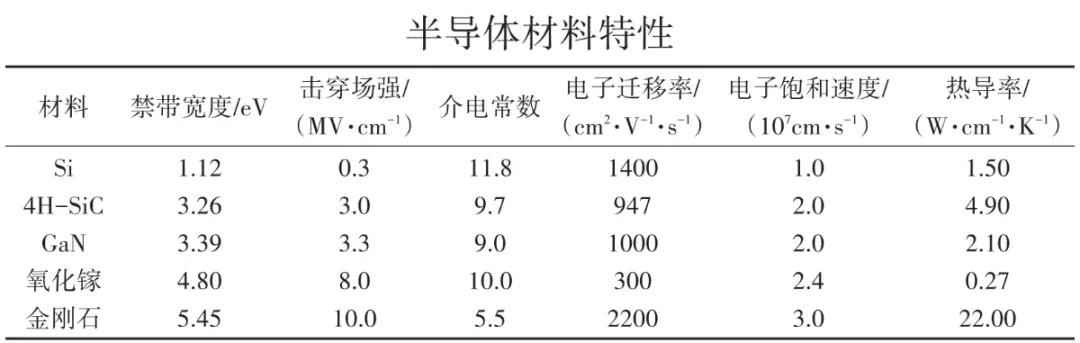
决定电力电子器件特性的主要材料参数包括禁带宽度、击穿场强、电子饱和漂移速度等。
4H-SiC、GaN、氧化镓以及金刚石的材料特性与硅相比优势非常显著,在学术界和产业界越来越受重视,其中以SiC为代表的宽禁带半导体的技术成熟度较高,在一些应用领域开始逐步取代硅基电力电子器件。
4H-SiC的禁带宽度几乎为硅的3倍,其本征载流子浓度远低于硅,热导率也达到硅的3倍,因而更加适合高温、高电压工作。
10倍的击穿电场使SiC更适合制作高压器件,能够突破硅器件击穿电压的极限,达到10 kV甚至20 kV以上。
高击穿电场使器件具有厚度更薄、掺杂浓度更高的漂移层,能够实现更低的比导通电阻和更高的导通电流密度。
作为单极型器件的SiC金属-氧化物半导体场效应晶体管(MOSFET),其比导通电阻远低于同电压等级硅MOSFET,最高击穿电压可超越硅绝缘栅双极型晶体管(IGBT),同时具有低导通损耗和低开关损耗,从而能够实现更高的效率和更高的功率密度。
国际进展
在众多SiC电力电子器件中,SiC肖特基二极管是商业化程度最高的,通常采用结势垒肖特基(JBS)或者并和PIN肖特基(MPS)结构,具有反向漏电低、抗电流过冲能力强等优势。
SiC肖特基二极管在600~3300 V电压范围内具备优越的性能和可靠性,已形成成熟的产品技术,广泛应用于开关电源、光伏发电、新能源汽车等领域。
英飞凌公司发布的第六代SiC MPS二极管采用薄片、低势垒等先进技术,降低导通电压,提高导通电流密度,进一步提升了产品的市场竞争力。
在更高电压的应用方面,SiC肖特基二极管也颇具吸引力,15 kV SiC肖特基二极管已研制成功,但其在高温、高阻断条件下的可靠性有待验证。
SiC MOSFET 是最为成熟、应用最广的SiC功率开关器件,具有高开关速度、低损耗和耐高温等优点,被认为是替代硅IGBT的最佳选择。
SiC材料可以通过热氧化工艺在表面生长氧化层,因此SiC MOSFET可基本沿用硅基功率MOSFET的制备工艺。
然而由于SiC/SiO2界面处存在大量的陷阱电荷和界面电荷,使得SiC MOSFET的沟道迁移率较低,进而使器件的导通电阻增加。
同时,SiC的临界击穿电场强度更高且介电常数是SiO2的2.5倍,容易出现由于SiO2内电场强度过高而引发器件失效等可靠性问题。
因此,必须优化设计SiC MOSFET的元胞结构和终端结构,同时深入研究栅氧介质的形成工艺。
SiC功率MOSFET通常采用平面结构或者沟槽结构,在650~3300 V电压范围内已形成成熟的产品技术。
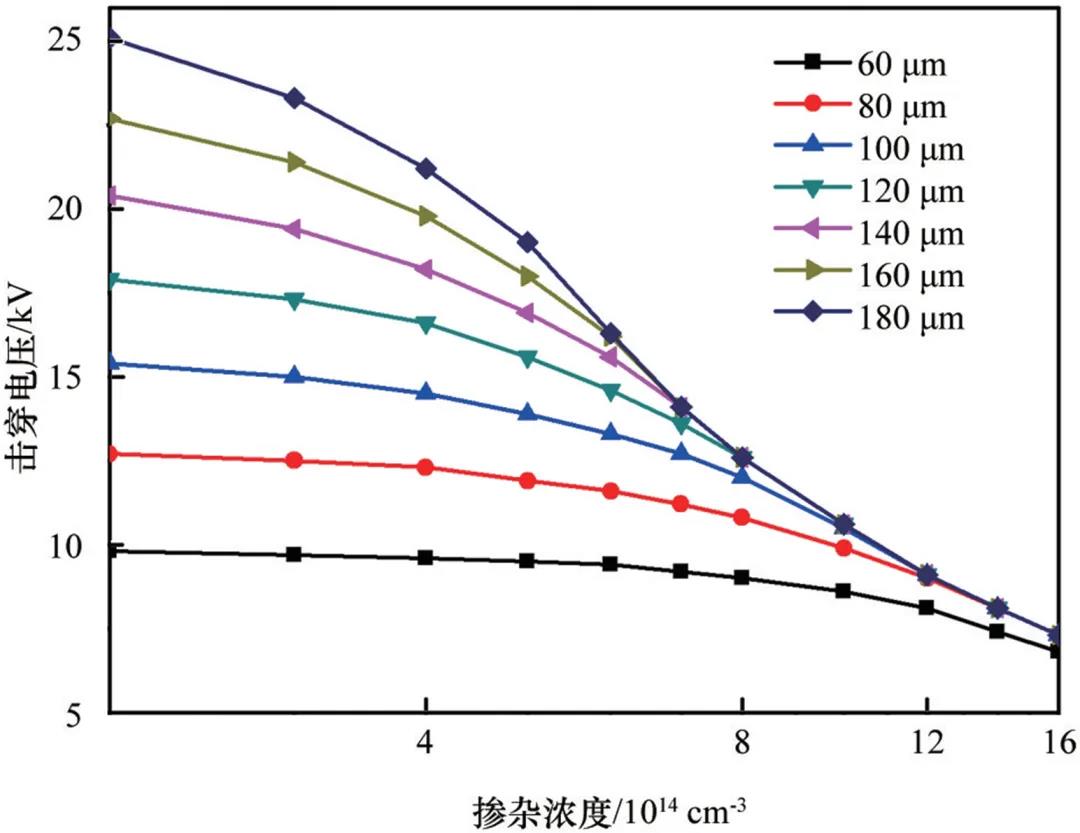
SiC功率MOSFET器件结构
SiC MOSFET沟道迁移率低的问题仍然比较突出,对于中低压器件(650~1700 V)沟道电阻占总导通电阻的比例较高。
罗姆半导体集团和英飞凌科技公司采用沟槽结构SiC MOSFET,没有结型场效应晶体管(JFET)区,具有更高的沟道密度,同时沟道所在SiC晶面具有较高的沟道迁移率,因此能够实现更低的比导通电阻。
而Cree和意法半导体两家公司采用平面结构SiC MOSFET,通过优化器件的结构设计,实现了性能和可靠性俱佳的产品技术,得到了广泛的应用。
Cree发布的第三代平面结构SiC MOSFET,1200 V产品的比导通电阻仅为2.7 mΩ⋅cm2,在高压领域也显示出优越的性能,10和15 kV器件的比导通电阻分别为123和208 mΩ⋅cm2,基本达到了单极型SiC器件的理论极限。
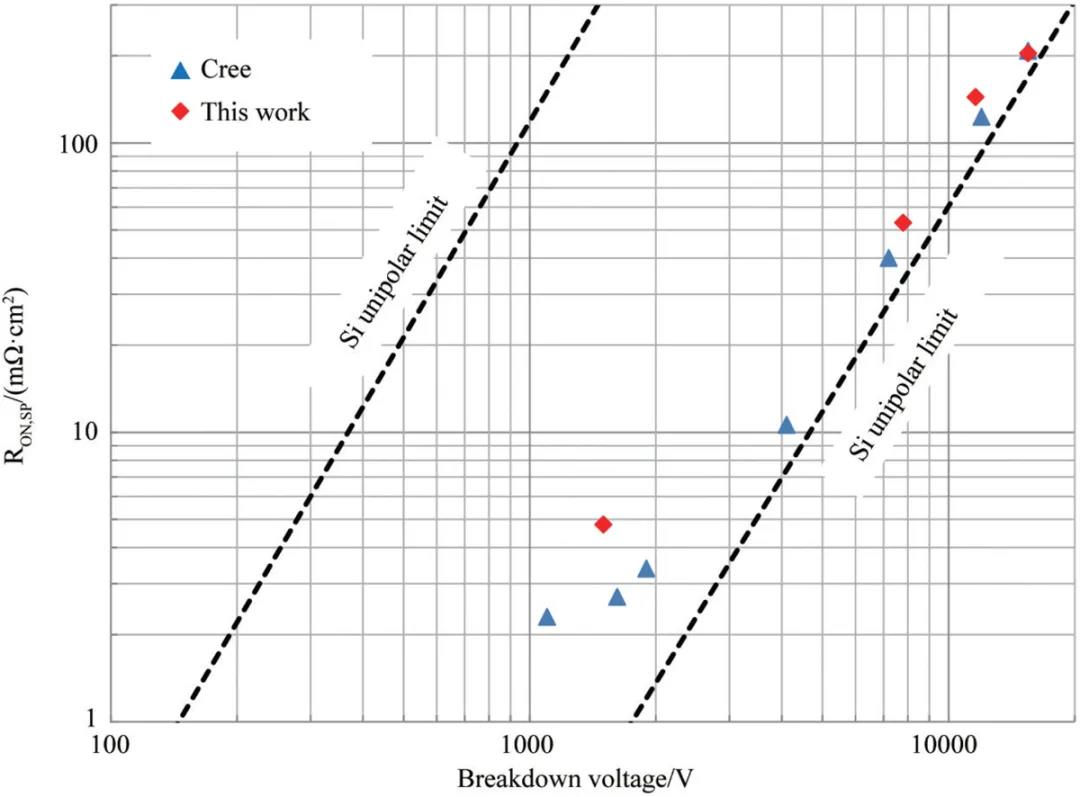
Cree公司SiC MOSFET研制结果
SiC功率MOSFET作为单极型器件,导通状态下通过多数载流子导电,当击穿电压达到10 kV甚至更高时,高导通电阻成为限制其应用的重要问题。
SiC IGBT是一种双极型器件,器件的背面多了一个pn结,当器件处于导通状态时,背面的pn结会将少子注入到漂移层,产生电导调制效应,从而实现更低的导通电阻,更加适合智能电网等设施的高压大功率应用。
由于SiC的电子迁移率比空穴迁移率高1个量级,n沟道SiC IGBT(N-IGBT)比p沟道SiC IGBT(P-IGBT)具有更优越的导通和开关特性。
Cree公司和日本产业技术综合研究所等报道了12~27 kV 高压SiC N-IGBT 的研制结果,15 kV SiC N-IGBT 的微分比导通电阻仅为14 mΩ⋅cm2,而27 kV SiC N-IGBT 也只有123 mΩ⋅cm2,充分显示出高压大功率的性能优势。

高压SiC N-IGBT 研制结果
SiC N-IGBT需要p型SiC衬底,其质量和性能均有待提升,另外SiC的载流子寿命比较低,限制了SiC IGBT性能的进一步提升。
SiC电力电子器件最新研制进展
依托中国电子科技集团公司第五十五研究所建立的宽禁带半导体电力电子器件国家重点实验室,致力于以SiC为代表的宽禁带半导体电力电子器件技术研究和开发,建立了600~3300 V SiCMPS 二极管和1200~1700 V SiC MOSFET 产品技术,在新能源汽车、光伏发电等领域实现了应用。
为进一步发挥SiC电力电子器件高电压、大功率、高效率、高功率密度等优势,本实验室面向国际科技前沿开展SiC MOSFET、SiC IGBT等器件技术的开发工作。
01 1200VSiC MOSFET
SiC功率MOSFET器采用了平面型结构。
研制的第一代1200 V/80 mΩ SiC MOSFET 器件,芯片的有源区面积为8.5 mm2,比导通电阻6.8 mΩ⋅cm2。按照工业级标准完成了器件的可靠性考核。

阈值电压和体二极管的稳定性是SiC MOSFET器件可靠性的两项重要挑战。
在环境温度150℃、栅极偏置电压+20 V和-10 V的应力条件下,经过1000 h的考核,SiC MOSFET器件的阈值电压漂移率均小于0.3 V。
SiC MOSFET器件的体二极管也经受了在环境温度150℃、1000 h的稳态工作寿命考核,显示出良好的稳定性。
为进一步提升SiC MOSFET器件的导通电流密度,降低栅电容,对SiC MOSFET 器件的结构设计和制造工艺展开了改进研究。
尤其是针对SiC MOSFET沟道导通电阻大的问题,开发了栅氧前氮注入与栅氧后氮化退火相结合的工艺,实现了沟道迁移率的明显提升。
结合SiC MOSFET单胞结构优化以及JFET区选择掺杂技术,研制出新一代1200 V/80 mΩ SiC MOSFET器件,芯片有源区面积缩小到6 mm2,比导通电阻降低至4.8 mΩ∙cm2,击穿电压为1500 V。

1200 V/80 mΩ SiC MOSFET导通和阻断测试曲线
该产品的可靠性和可生产性通过验证后,性价比将得到显著提升。
02 6.5~15 kV SiC MOSFET
采用平面型MOS结构,进行了高压SiC MOSFET器件技术的开发。
在3.3 kV以上的高压领域,SiC MOSFET的沟道电阻在器件总电阻中的比例显著降低,而外延漂移层电阻成为最主要的组成部分,在做好器件耐高压设计之外,漂移区外延掺杂浓度和厚度的设计最为关键。
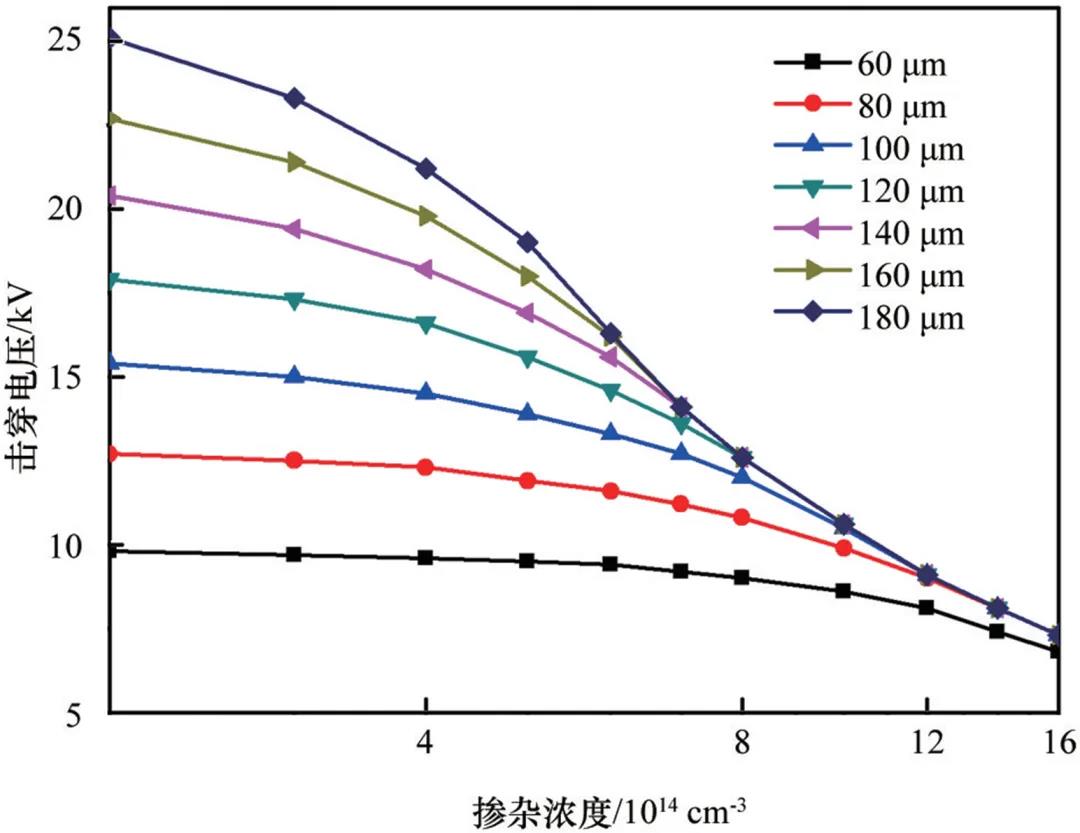
SiC器件击穿电压与外延层厚度以及浓度之间的关系
研制的6.5 kV/150 mΩ SiC MOSFET击穿电压达7.8 kV,在阻断电压为6.5 kV时漏电流小于2 μA,有源区面积35.6 mm2,比导通电阻53 mΩ∙cm2。
将6.5 kV SiC MOSFET与6.5 kV硅IGBT的开关损耗进行了对比,SiC MOSFET器件的总开关损耗仅为传统Si-IGBT模块的1/15,因此更加适合高开关频率应用。

开展了10和15 kV SiC MOSFET器件的设计和制备。当栅极电压VGS为20 V、漏源极电压VDS为5.0 V时,研制的10 kV/480 mΩ SiC MOSFET器件的导通电流为10.4 A,比导通电阻为144 mΩ∙cm2。
研制的15 kV/680 mΩ SiC MOSFET采用了掺杂浓度6×1014 cm-3、厚度150 μm的SiC外延漂移层,芯片尺寸为9.2 mm×9.2 mm,有源区面积30.1 mm2,采用了总宽度为1.5 mm的场限环终端。
室温下15 kV SiC MOSFET的导通和阻断性能测试结果显示,器件的击穿电压达15.5 kV,漏源极电压VDS为6.5 V 时导通电流达9.6 A,对应的比导通电阻为204 mΩ∙cm2,为目前报道的最高水平。
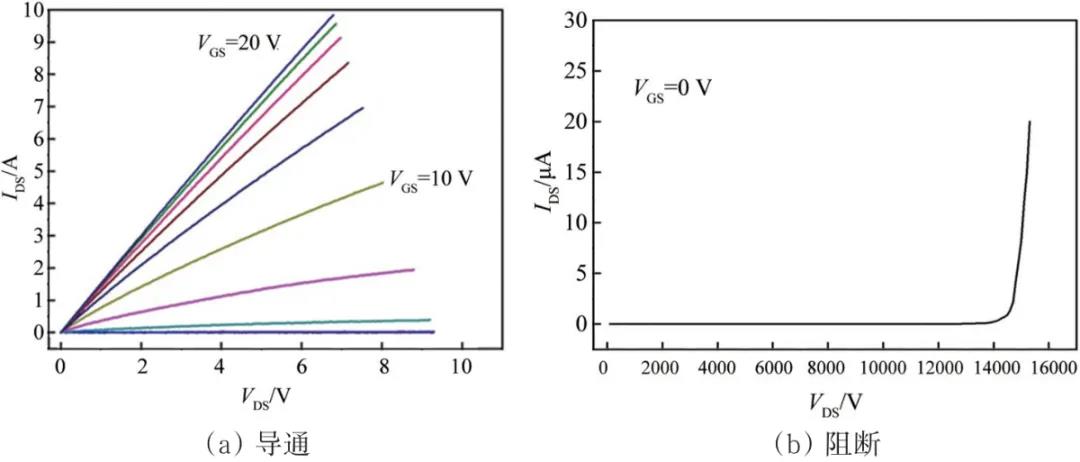
15 kV SiC MOSFET 导通和阻断测试曲线
03 20 kV SiC IGBT
高压SiC N-IGBT在n型SiC衬底上依次外延生长了20 μm厚的p+少子注入层,3 μm厚n型缓冲层以及180 μm厚掺杂浓度为2×1014 cm-3的n型漂移层。
器件的单胞长度为14 μm,MOS沟道长度1.0 μm,采用了总宽度为1.5 mm的场限环终端,芯片尺寸为9.2 mm×9.2 mm,有源区面积30.1 mm2。
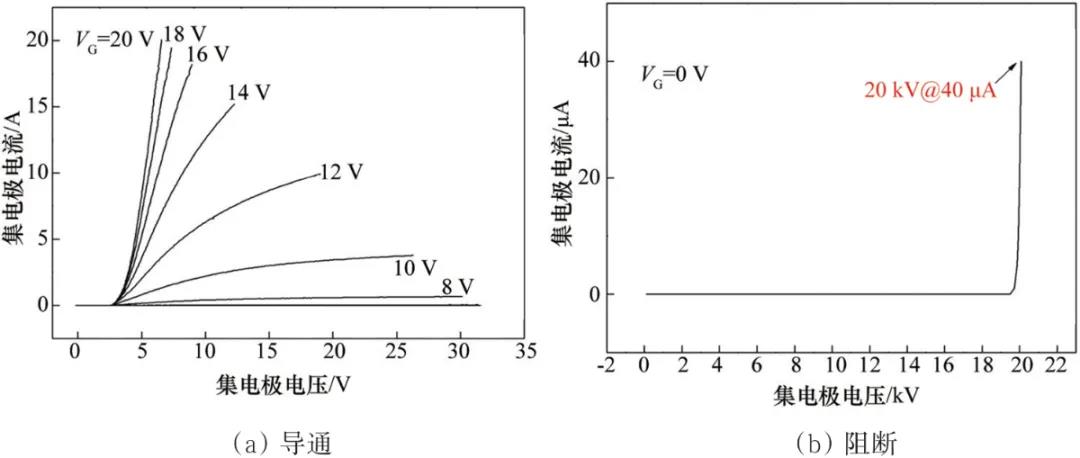
SiC N-IGBT器件结构示意
SiC N-IGBT的正面工艺与SiC MOSFET基本相同,采用了1350℃氧化工艺以提升载流子寿命。
在正面工艺完成后通过研磨去除n型SiC衬底,采用激光退火工艺在背面p+注入层表面形成良好的p型欧姆接触。
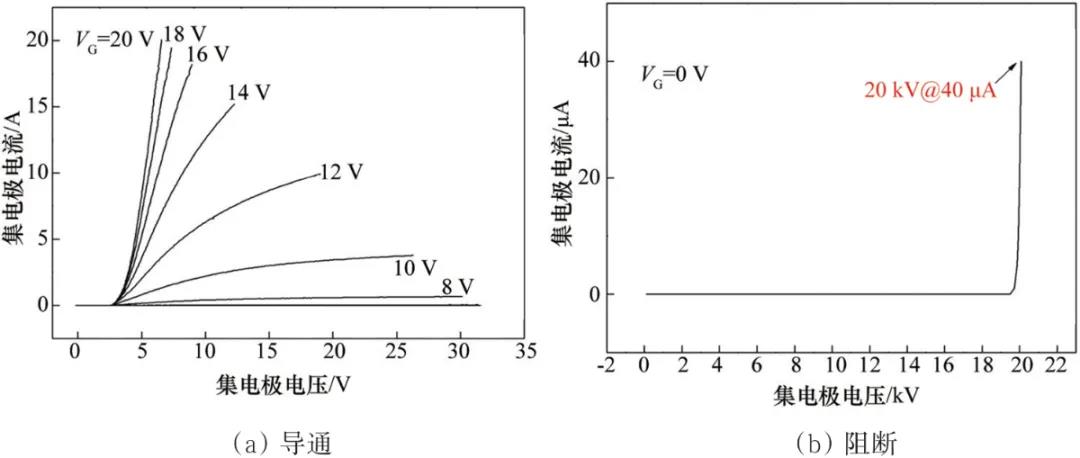
室温下20 kV SiC N-IGBT导通和阻断测试曲线,其中阻断特性是将器件浸入在绝缘液体中测试获得
当VGE=0 V、VCE=20 kV时,器件的漏电流为40 μA。当VGE=20 V,VCE=6.5 V 时,SiC IGBT 的集电极电流达20 A,微分比导通电阻为36 mΩ∙cm2,显示出SiC IGBT作为双极型器件在高阻断电压、高导通电流密度等方面的突出优势。
结论
SiC电力电子器件已经成为国内外研究和产业化热点。
国内众多科研机构正在通过技术攻关追赶国际上突飞猛进的发展步伐,建立了中低压SiC肖特基二极管和SiC MOSFET产品技术,推进产品在数据中心电源、光伏发电、新能源汽车等领域的批量应用,面向国际科技前沿开展高压和超高压SiC MOSFET、SiCIGBT等器件技术的开发并取得重要成果,缩小了与国际先进水平之间的差距。
“新基建”为宽禁带半导体器件带来新的发展机遇,我们应抓住机遇,加快提升以SiC为代表的新一代电力电子器件的技术水平,努力实现从跟跑到并跑再到领跑。
论文发表于《科技导报》2021年第14期,欢迎订阅查看。
