2024年4月8-11日,一年一度化合物半导体行业盛会——2024九峰山论坛暨中国国际化合物半导体产业博览会(简称“JFSC&CSE”)将于武汉光谷科技会展中心举办。苏州德龙激光股份有限公司将携新品亮相本届盛会,诚邀业界同仁莅临A301展台参观、交流合作。

本届CSE博览会由第三代半导体产业技术创新战略联盟、九峰山实验室共同主办,以“聚势赋能 共赴未来”为主题,将汇集全球顶尖的化合物半导体制造技术专家、行业领袖和创新者,采用“示范展示+前沿论坛+技术与商贸交流”的形式,为产业链的升阶发展搭建供需精准对接平台,助力企业高效、强力拓展目标客户资源,加速驱动中国化合物半导体产业链的完善和升级。
CSE作为2024年首场国际化合物半导体产业博览会得到了多方力量的大力支持,三大主题展区,六大领域,将集中展示各链条关键环节的新技术、新产品、新服务,将打造化合物半导体领域的标杆性展会。助力打造全球化合物半导体平台、技术、产业的灯塔级盛会,集中展示化合物半导体上下游全产业链产品,搭建企业发布年度新产品新技术的首选平台,支撑产业链及中部地区建设具有全球影响力的万亿级光电子信息产业集群。

德龙激光(688170.SH)2005年由赵裕兴博士创办,位于苏州工业园区,2022年4月29日科创板上市。公司是一家技术驱动型企业,自成立以来,一直致力于新产品、新技术、新工艺的前沿研究和开发。公司专注于激光精细微加工领域,凭借先进的激光器技术、高精度运动控制技术以及深厚的激光精细微加工工艺积淀,聚焦于泛半导体、新型电子及新能源等应用领域,为各种超薄、超硬、脆性、柔性及各种复合材料提供激光加工解决方案。同时,公司通过自主研发,目前已拥有纳秒、超快(皮秒、飞秒)及可调脉宽系列固体激光器的核心技术和工业级量产的成熟产品。德龙激光肩负着“用激光开创微纳世界”的使命,致力于成为在精细微加工领域具备全球影响力的激光公司。
产品介绍
碳化硅晶锭切片设备

设备说明
本设备用于碳化硅晶锭/片的激光切片加工,激光切割后,配合辅助装置完成晶片的分片。
设备型号
DLDS-8680
设备参数
最大切割晶锭厚度:50mm
上下料方式:全自动上下料
切割轴速度:0-1000mm/s
激光加工损耗:110-150μm(6寸,380μm厚度)
加工效率:≤25min/pcs(6寸,380μm厚度)
设备优势
材料损耗小,加工效率高,设备运行无需耗材,加工成本低。
应用领域
应用于碳化硅晶锭(片)的晶圆切片加工领域。
碳化硅激光退火设备
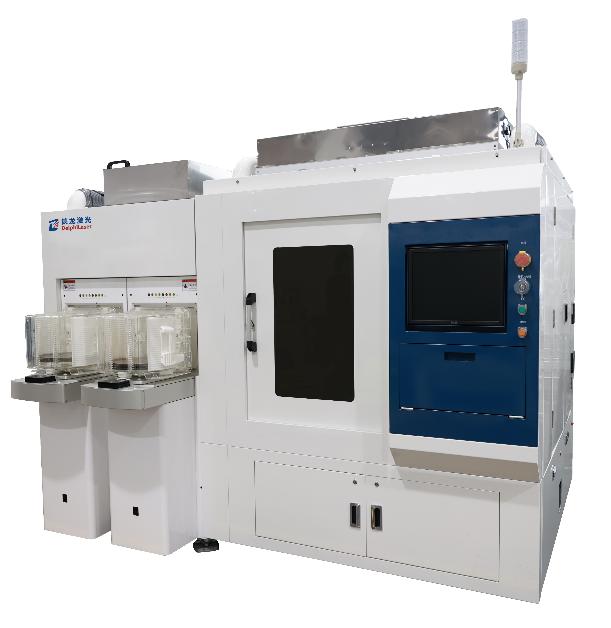
设备说明
该设备用于碳化硅的欧姆退火工艺,具备裸片自动上下料、晶圆自动校准等功能。
设备型号
LAN-6281
设备参数
退火晶圆材质:碳化硅
加工产能:150mm圆片≥7wph(以20片圆片全自动传片进行计算)
加工产品尺寸:6-8寸
退火方式:厚度100-200nm以碳化硅为衬底的晶圆上Ni金属欧姆退火
设备优势
加工工艺效果优异,加工效率高,设备运行无需耗材,加工成本较低。
应用领域
应用于碳化硅晶圆片的背金激光退火(以碳化硅材料为基板的晶圆)。
化合物晶圆激光切割设备

设备说明
本设备是利用超短脉冲激光实现化合物晶圆高质量、高效率切割。切割速度快,切割效果好,良率高;提供整套的切割&裂片&扩片设备,完整解决方案;工艺成熟,可针对不同类型晶圆进行切割。
设备型号
Inducer-5560(SiC)
Inducer-5360(GaAs/InP)
设备参数
最大切割厚度:500μm
切割轴最大速度值:500mm/s
加工尺寸:6寸(可升级至8寸)
设备优势
切割速度快,切割效果好,良率高
提供整套的裂片&扩片设备,完整的解决方案
工艺成熟,可针对不同类型的碳化硅晶圆进行切割
应用领域
可针对碳化硅、氮化镓、砷化镓、钽酸锂/铌酸锂晶圆提供专用的激光隐形切割设备。
值此之际,我们诚邀业界同仁共聚本届盛会,莅临展位现场参观交流、洽谈合作。
关于JFSC&CSE 2024








