作为宽带隙材料,GaN具有击穿电压高、热导率大、开关频率高,以及抗辐射能力强等优势。在低缺陷密度块体 GaN 衬底上生长低缺陷密度外延层,与在非 GaN 衬底上制造的横向GaN器件相比,它导致垂直功率器件在电压和热应力下具有更高的可靠性。垂直 GaN 功率器件能够为要求最苛刻的应用供电 ,例如数据中心 服务器、电动汽车、太阳能逆变器 、电机和高速列车的电源。

近日,第九届国际第三代半导体论坛(IFWS)&第二十届中国国际半导体照明论坛(SSLCHINA)在厦门国际会议中心召开。期间,“氮化镓功率电子器件技术分会“上,成都氮矽科技有限公司器件设计总监朱仁强带来了“增强型功率氮化镓器件结构设计进展”的主题报告。
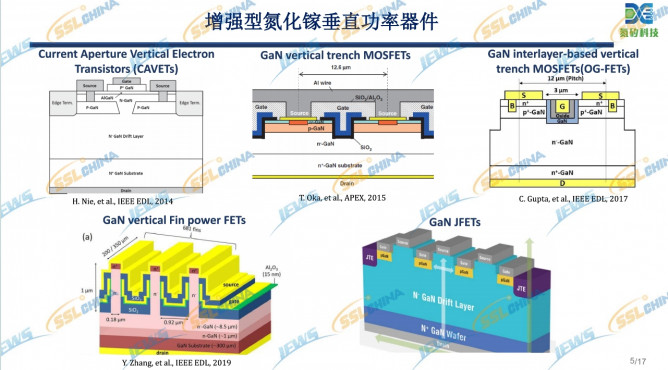
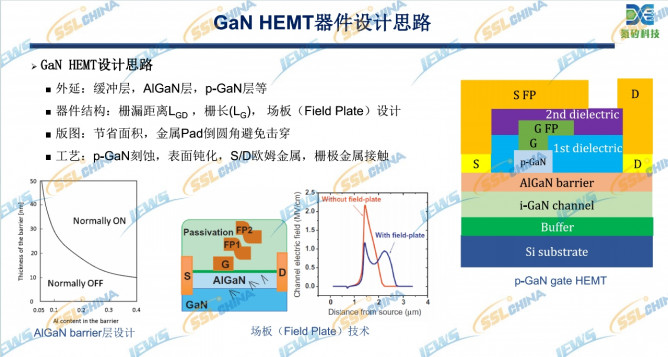

功率氮化镓目前主要采用横向结构(GaN-on-Si Lateral HEMT)。垂直氮化镓器件中存在氮化镓衬底成本高的挑战。报告围绕增强型氮化镓垂直功率器件,分享了GaN HEMT基本结构、Cascode实现常关型、氟离子注入技术、凹槽栅结构、三维Tri-gate结构,p-GaN gate结构等技术内容,以及GaN HEMT器件设计思路,功率氮化镓HEMT器件产业界技术路线。其中,p-GaN gate 结构实现增强型器件,栅极区域插入p-(Al)GaN,提升导带能级,以实现二维电子气耗尽,工艺相对简单可控,器件稳定性高。
(备注:以上信息仅根据现场整理未经嘉宾本人确认,仅供参考!)
