基于全HVPE生长、具有创纪录的高品质优值(1.1 GW/cm2)的垂直GaN肖特基势垒二极管
刘新科,IEEE会员,邹苹,王灏帆,林钰恒、吴钧烨、陈增发、王新中、IEEE资深会员、黄双武
摘要:本文首次报道了由氢化物气相外延(HVPE)生长的垂直GaN-on-GaN肖特基势垒二极管(SBD)。由于HVPE生长的碳杂质浓度较低,电场有效迁移率从734 cm2•V-1•s-1提高到1188 cm2•V-1•s-1。利用该技术制备的器件具有0.52 V的低开启电压和7.1×109的高开关比。电流密度为500 A/cm2时,比导通电阻RON为1.69 mΩ•cm2。采用He注入技术实现了1370 V的高击穿电压VBR。迄今为止,这在已报道的具有指定阳极尺寸的垂直GaN肖特基势垒二极管中,已实现了最高性能值(VBR2/RON)为1.1 GW/cm2。
关键词:GaN-on-GaN;氢化物气相外延;氦离子注入;低导通电压;高迁移率;高品质系数
I.介绍
由于GaN具有优异的材料性能,如宽带隙(3.4 eV)、高介电强度(~9)、高导热系数(~1.3 W/(cm·K))、高电子饱和度和电子迁移率[1]-[3],因此被认为是高压、高频和大功率应用的有前途的候选者。对于功率器件而言,垂直结构在提高电流密度和击穿电压方面优于横向结构,后者通常制造在异质外延生长的衬底上,如硅,蓝宝石和碳化硅,由于GaN和外源衬底引起的晶格失配和热失配,其表现出高密度的螺位错(TDD) (108-1012 cm-2)[4]-[6]。这大约是垂直结构(104-106 cm-2)的106倍。对于垂直GaN肖特基势垒二极管(SBD),由于肖特基电极边缘的电场浓度导致器件在反向偏置下过早坍塌,器件的实际击穿电压远低于理论值[7]。近年来,为了提高垂直SBD的击穿电压,人们做了许多工作,如场板、金属场环、等离子体处理、纳米线[8]-[11]、离子注入[12]、[13]等。其中,He离子注入由X. Liu等人提出。[1]已经实现了1.7 kV的VBR。然而,理论值之间仍有一定的差距,可能的原因之一是GaN外延中的碳杂质浓度过高。

图1:(a)由全HVPE生长的垂直GaN SBD结构示意图。(b)制备器件在2英寸独立(FS)-GaN晶圆片上的光学图像。(c)和(d)由第一性原理计算的GaN材料中碳杂质的缺陷类型。(e) MOCVD生长漂移层和(f) HVPE生长漂移层的PL光谱。(e)中500~650 nm范围内的板峰与GaN外延的深态和缺陷有关。(g) SIMS测试的漂移层碳杂质浓度。(h)和(i) XPS测量的hvpe基外延中硅含量和碳含量的比例。
特别是,由于掺杂精度和厚度控制的优势,大多数垂直SBD的n-GaN漂移层都是通过金属有机化学气相沉积(MOCVD)制备的[13,14]。然而,MOCVD外延很容易在外延层的带隙内引入无意中与深能级相关的碳原子[15]。因此,控制漂移层中的碳浓度至关重要。氢化物气相外延(HVPE)是一种非常出色的独立GaN衬底生长方法[16]-[18],它有效地用于垂直GaN功率器件的制造,如肖特基势垒二极管(SBD)和PN结二极管(PNDS)。这是因为HVPE方法使用无碳源GaCl和/或GaCl3作为Ga前驱体,其典型生长速率在100 μm/h以上。这些特性适合在低碳浓度下生长厚GaN漂移层[19]-[21]。
本文首次展示了利用氢化物气相外延技术(HVPE)生长低碳杂质浓度的高质量n-GaN漂移层,该漂移层也可用于制造高性能的垂直GaN SBD。使用指定的阳极尺寸(注意,我们在这里与已经声明器件阳极尺寸的工作进行比较),在本工作中获得了垂直GaN SBD最高的VBR2/RON ,为1.1 GW/cm2。
II.器件制备
图1(a)显示了垂直GaN SBD的结构示意图,该结构由掺杂硅的300 μm厚GaN衬底(中镓半导体)和掺杂浓度为2.1×1016 cm−3的HVPE生长的硅轻掺杂20 μm厚漂移层组成。图1(b)显示了该器件在由全HVPE生长的2英寸独立(FS)-GaN晶圆上的光学图像。在块状GaN衬底上制作垂直GaN SBD的关键器件工艺主要包括以下几个方面。首先,对衬底进行预清洗,包括10分钟丙酮、10分钟异丙醇脱脂和10分钟水氧化鱼溶液(H2O2:H2SO4 = 1:4)浸泡步骤,以去除有机残留物。然后,用HVPE在清洗后的衬底上生长n-GaN漂移层。以液态镓为Ga前驱体,氨气为N,反应过程如下:

液态Ga与气态Hcl在850°C下反应生成中间反应物GaCl, GaCl与NH3在1050°C下反应在衬底上生成GaN,实际生长速率为15 μm/h。采用BCl3/Cl2等离子体刻蚀技术制备了厚度为1.2 μm、直径为150 μm的表面结构。
为了提高离子分布的均匀性,引入了两步能量注入。He离子注入在室温下进行,入射角为7°。在1×1015 cm-2的相同剂量下,以120 keV和50 keV两个能级注入He离子,通过停止和物质中离子范围(SRIM)模拟估计其形成的注入深度为500 nm[22],[23]。He离子注入后,根据传输线法(TLM)试验模型[24],在注入区形成了一个6.7×109 Ω/□的方块电阻,表明形成了高阻区。通过真空蒸发器(ASB-EPI-C6)在衬底背面沉积Ti/Al/Ni/Au (25/100/20/80 nm)形成欧姆接触,然后在N2氛围中800°C快速热退火(RTA) 1 min。制备了直径为100 μm的Ni/Au (30/100 nm)接触面作为阳极电极。采用相同的工艺制备了由MOCVD生长漂移层的垂直GaN器件进行比较。
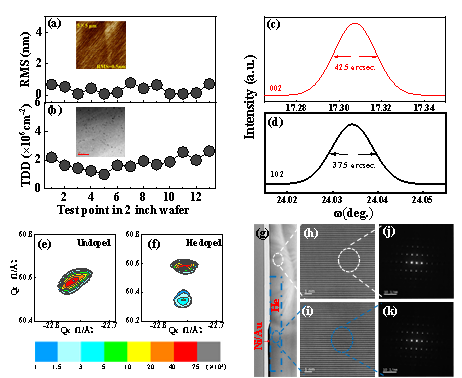
图2:(a)和(b)分别在2英寸晶圆上测试了13点AFM粗糙度和阴极发光表征位错密度。(c)和(d) HVPE分别生长(002)和(102)晶向的FWMH。(e) He未植入GaN面和(f) He植入GaN面后RSM沿(105)方向变化。(g) - (k)制备的HVPE生长的垂直GaN SBD的透射电镜横截面图像。
III.结论与讨论
如图1(c)和(d)所示,碳杂质被掺入GaN晶格并占据镓位(CGa)或氮位(CN)[25]。室温光致发光(RT-PL)光谱主要是在约365 nm处的近带边紫外跃迁。另外,在429nm和564 nm处分别观察到两个相对较弱的蓝色和黄色发光峰,弱黄色发光源于浅给体和深给体(CN)之间的跃迁[26],而弱蓝色发光是由深给体(CGa)向(CN)的电子转移引起的。如图1(e)和(f)所示,HVPE生长的外延由于碳杂质含量低,其PL缺陷发射峰较弱。图1(g)为HVPE和MOCVD生长的漂移层中的碳杂质浓度。HVPE中碳杂质浓度((5.5±0.2)×1015 (Atoms/cm3))显著低于MOCVD((3.1±0.2)×1016 (Atoms/cm3)),也低于检测限(1.0×1016 (Atoms/cm3))。Si和O元素的浓度也进行了测试,它们相差很小。图1(h)和(i)为XPS图像,碳杂质峰(C1s)的面积约为硅杂质峰(Si2p)的1/30倍。按公式[27]计算摩尔比为:

式中n1和n2为C和Si的原子序数,I1和I2为XPS峰面积,S1和S2为灵敏度因子。测定了HVPE生长的漂移层中碳杂质浓度约为~1.2×1015 (Atoms/cm3)。
图2(a)为HVPE生长外延的原子力显微镜(AFM)照片和粗糙度的RMS值,13个测试点的粗糙度约为 ~0.55 nm。图2(b)为13个不同测试点阴极发光(CL)图像中基于黑点的螺位错密度(TDD),平均TDD为~2×106 cm-2。x射线衍射(XRD)摇摆曲线(图2(c)和(d))中(002)和(102)的半峰宽分别为42.5和37.5弧秒,位错密度可由式(4)计算[28]:

式中Dtotal为位错密度,第一项Dscrew为螺位错密度,第二项Dedge为刃位错密度,β(002)和β(102)分别为(002)面和(102)面的半宽FWMH, b1和b2的值分别为GaN材料的c轴和a轴晶格常数。表明螺位错密度为4.0×106,刃位错密度为1.7×106 cm-2,总位错密度为5.7×106 cm-2,与CL测量值一致。
通常,离子注入是为了提高器件的击穿电压。本文分析了HVPE生长的漂移层中He离子的影响。表征He注入后器件内部晶格性质的变化并揭示其应变-应力机制对于分析器件对电子性能的影响至关重要,因为He注入后GaN区域的应变应力可能降低电子迁移率[29]-[31]。图2(e)和(f)显示了未注入He和注入He样品在(105)平面上的倒易空间映射(RSM)。RSM实验在两个由HVPE生长的GaN空白样品(1×2 cm2)上进行,其中一个注入He离子,另一个未注入。图2(e)和(f)所示的RSM可以得到GaN样品的晶格参数和应力应变。RSM可以用来了解GaN漂移层中的晶体特性和分析应力应变。由于离子注入深度约为500 nm,没有穿透整个GaN材料,在图2(f)中He注入样品中可以清晰地看到两个分裂峰。可以认为离子注入改变了氮化镓的晶格。因此,在氦注入区域会产生一种应变。基于非对称RSM扫描的信息,六边形结构的晶格参数(a和c)由式(5)计算[32],[33]。从未配对的RSM测量计算GaN晶格参数

通过非对称RSM测量计算GaN晶格参数(在这种特殊情况下,h = 1, k = 0和l = 5)。由于GaN He注入区沿a轴(面内)方向存在压应变,计算得到的a小于Vigard定律得到的未应变值a0(低至0.063%)。计算得到的c值高于未应变值(c0)(高达0.308%),说明注入区存在沿c轴(面外)方向的拉伸应变。同时,发现计算出的a小于由维加德定律得到的未应变(a0),减小了0.063%。这是由于氮化镓的a轴(平面内)压缩应变。与未植入相比,这可能会增加器件的导通电阻。HVPE生长的He注入区和未注入区分别拍摄高分辨率TEM图像,如图2(g)-(k)所示。He注入引起的晶格缺陷观察不明显。纳米束电子衍射(NBD)衍射图表明,在He注入和未注入的情况下,GaN区域的结晶质量非常高。控制区GaN的晶格计算为a = 0.3189 nm, c = 0.5184 nm,与文献报道的数据一致[34]。He注入后,a轴的晶格常数降低到0.3166 nm(低至0.72%),c轴的晶格常数增加到0.5199 nm(高至0.159%)。由此可见,He注入后,晶格a方向产生压应变/应力,c方向产生拉应变/应力。该结果与RSM试验结果一致。

图3:(a)两个器件的正向J-V特性和特定导通电阻RON。(b)两种装置的J-V日志特性。HVPE和MOCVD生长的器件的离子/开关比分别为7.1×109和4.9×108 (c)两种器件的详细电容-电压(c−V)图和插入值为1/C2-V图。(d)室温下HVPE生长垂直器件的衬底电阻Rsub、欧姆接触电阻Rc和漂移层电阻Rdrift的比值(e) MOCVD生长垂直器件的电阻Rdrift。
如图3(a)所示,HVPE和MOCVD生长器件的开启电压VON分别为0.52 V和0.58 V,比导通电阻RON分别为1.69 mΩ·cm2和2.1 mΩ·cm2。在低电流水平下,SBD的主要电流传导机制是热离子发射(TE)。基于该模型,SBD的正I-V关系如式(6)所示[35]。

式中,J、A*、T、q、ɸB、V、k、n分别为饱和电流密度、理查德森常数(26.4 A·cm-2·k -2)、绝对温度、电子电荷、Schottky势垒高度、正向偏置电压、玻尔兹曼常数和理想因子。如图3(b)所示,HVPE和MOCVD生长的器件的开关比分别为7.1×109和4.9×108。如图3(c)所示,采用电容-电压(c -v)法,净载流子浓度(ND-NA)可由下式求得[36]:

式中,A为器件电极有效面积,q为电子电荷(1.602×10-19 C),ε0为真空介电常数(8.854×10-12 F/m),εr为GaN的相对介电常数。HVPE和MOCVD生长漂移层的净载流子浓度(ND-NA)在1 MHz时分别为~2.1×1016 cm-3和~1.9×1016 cm-3。据报道,氮位上的碳(CN)会产生载流子补偿和非平衡载流子的捕获[37]。

图4:(a)和(b)为He离子注入后垂直GaN SBD的电场模拟(-1000 V),以突出He离子注入后的电场变化。(c)肖特基结边缘沿切线提取的电场分布。(d)分别由HVPE和MOCVD生长的垂直GaN二极管的反向I-V特性。(e)反向电压下肖特基接触界面处/附近可能的载流子泄漏机制。TFE、VRH和SCLC三种渗漏机制的比较。(f) HVPE生长的2英寸晶圆上15点沿x轴和y轴的击穿电压。
因此,在外延生长过程中控制相同Si掺杂浓度的情况下,基于MOCVD生长的漂移层的净载流子浓度(ND-NA)会略低于HVPE。表明载流子复合过程受GaN中碳原子形成的深能级影响[38]。如图1(a)所示,根据器件的结构,器件的总电阻Ron分为衬底部分、漂移层部分和欧姆接触三部分[39]:

其中Rsub为衬底电阻,Rc为来自传输线法(TLM)测试模型的欧姆接触电阻(两个器件的比接触电阻率为~ 9.3×10-4 Ω·cm2), Rdrift为漂移层电阻。Rsh为衬底的方块电阻,d为衬底的厚度。HVPE和MOCVD生长的器件中各组分的百分比如图3(d)和(e)所示,两种器件的Rsub和Rc结果分别为Rsub = 0.30 mΩ·cm2和Rc = 0.9 mΩ·cm2。然而,与MOCVD相比,HVPE生长的漂移层(Rdrift)电阻从0.9 mΩ·cm2降低到0.49 mΩ·cm2。
图4(a)和(b)分别为He注入终端和未注入终端时器件的电场强度分布仿真图。图4(c)显示了分别施加1000 V反向电压时,器件沿图4(a)所示切线的电场强度。He注入终端可以显著降低肖特基电极边缘处的表面峰值电场,使器件的击穿模式由边缘击穿转变为体击穿,为了防止器件提前击穿并提高击穿电压。如图4(d)所示,HVPE生长的器件击穿电压为1370 V, MOCVD生长的器件击穿电压为1080 V。在不同的反向电压下,SBD的漏电流机理是不同的。对于HVPE生长的器件,当反向电压低于200 V时,泄漏电流与经典的热离子场发射(TFE)模型[40]相似,TFE基于通过肖特基势垒的隧穿过程。然而,在较高的反向电压(200-1100 V)下,与可变跳程(VRH)模型存在偏差。VRH将有助于块状GaN中的位错跳变,这通常在GaN PN二极管中观察到,其中电场峰值在块状GaN内。较高的VBR表明电场强度峰值从GaN表面的肖特基结转移到GaN体。当反向电压大于1200V时,电流随I∝Vn的函数增大得更快,直到在1300V处出现峰。这种行为表明存在陷阱空间电荷限制电流(SCLC)[40]。这个峰电压决定VBR。HVPE生长的SBD具有的泄漏和VBR机制,与GaN垂直PN二极管相似。图4(e)为三种泄漏机制的微观电子示意图[41]。图4(f)分别显示了HVPE生长的2英寸晶圆上沿x轴和y轴15点的击穿电压。
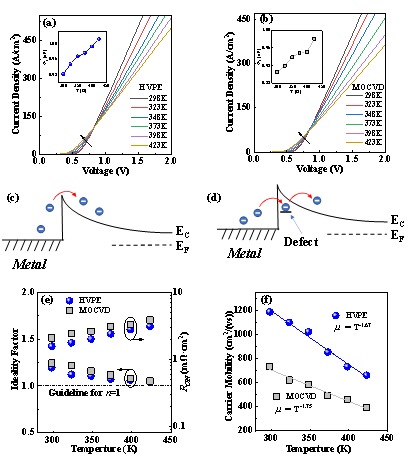
图5:(a)在298 ~ 473 K范围内MOCVD生长器件的正向I-V特性随温度变化。插图:计算肖特基势垒高度作为t的函数。(b) HVPE生长器件的温度依赖的正向I-V特性。插图:计算出肖特基势垒高度随t的函数。(c) HVPE生长器件和(d) MOCVD生长器件在反向电压下肖特基接触界面处/附近的载流子泄漏机理。(e)两个二极管的理想系数和Ron随温度的函数。(f)两个二极管的场有效迁移率随温度的函数。当温度从298 K增加到423 K时,由于声子散射,场的有效迁移率降低。
图5(a)和(b)分别显示了MOCVD和HVPE生长的器件在298 K到423 K范围内随温度变化的正向I-V特性。插图:计算出的肖特基势垒高度(SBH)随温度(T)的变化。从I-V特性中提取的SBH表明,HVPE生长的器件的SBH略高于MOCVD生长的器件。这是由于HVPE生长导致的低碳浓度,并且界面上的电子需要越过更高的势垒。对于MOCVD生长的器件,电子可以通过碳形成的缺陷层传导,因此有效的SBH会稍微降低。

图6:。(a)反向偏置为600 V时的开关性能;(b)正向电流为300 A /cm2,开关速度为1 kHz。(c)本研究中RON与VBR的基准,以及之前报道的具有指示阳极尺寸的垂直GaN SBD。(d)具有指定阳极尺寸的垂直GaN SBD的FOM与VBR的基准。HVPE生长的垂直GaN SBD的功率器件性能系数(VBR2/RON)为1.1 GW·cm-2。
如图5 (c)和(d)所示。热离子发射(TE)被认为是低电流水平下主要的电流传导机制,参考文献[39]报道了热离子发射(TE)模型后SBD的正向I-V关系。理想因子n作为电压的函数,提取方法为:

其中q是电子电荷,k是玻尔兹曼常数,T是温度,J是电流密度。采用Fu等人开发的方法。[39],两种器件的理想因子和Ron随温度的函数如图5(c)所示。不同温度下的迁移率可根据公式计算为

其中μ、t、N分别为电子迁移率、厚度和自由载流子浓度。这些不理想的电特性可归因于肖特基势垒高度的不均匀性和接触界面的影响。如图5(d)所示,实验数据与公式[35]吻合较好,且呈反比关系。声子散射和晶格振动主导了高温下的载流子输运行为。因此,高温下的接近迁移率表明两种样品的晶体质量相似。当温度降低时,杂质和缺陷的散射将以载流子输运为主。样品之间的迁移率间隙表明,HVPE样品的杂质和缺陷水平低于MOCVD样品,室温下迁移率从734增加到1188 cm2·V-1·s-1。
为了研究HVPE生长的GaN SBD的可靠性,通过应力占空比对器件进行了测量。图6(a)为反向偏置VR = 600 V时的开关性能,图6(b)为正向电压VF =1.2 V(正向电流约为300 A /cm2)时的低应力脉冲,占空比固定为50%,周期为1ms。脉冲测试结果表明,垂直GaN SBD具有良好的鲁棒性和高可靠性。图6(c)显示了最近报道的具有指定阳极尺寸的垂直GaN-on-GaN SBD的RON与VBR的基准。如图6(d)所示,由全HVPE生长的垂直GaN SBD实现了功率器件优值VBR2/RON为1.1×109 W/cm2,在指定阳极尺寸的情况下,本工作在目前报道的数据中获得了最高的FOM (1.1×109 W/cm2)。
IV.结论
这项工作首次展示了一种完全由氢化物气相外延(HVPE)生长的新型垂直GaN SBD,它显著降低了漂移层中无意的碳掺杂浓度,进一步提高了迁移率。基于全HVPE生长的器件实现了迄今为止垂直GaN SBD 的最高性能值(VBR2/RON)为1.1 GW/cm2。在这项工作中,全HVPE生长的技术显示出加速垂直GaN SBD在电力应用中的发展的巨大潜力。
致谢
作者感谢深圳大学电镜中心的HRTEM测试结果和深圳大学光电中心的器件制造过程。
2023年2月14日收到稿件;2023年5月8日修订;2023年5月17日接受。项目资助:国家自然科学基金(61974144、62004127),广东省重点领域研究与发展计划(2020B010174003),广东省杰出青年科学基金(2022B1515020073),深圳市科技计划(JCYJ20220818102809020)。这篇文章的评论是由编辑D. Sheridan安排的。(通讯作者:刘新科;王新中。)
刘新科,邹苹,王灏帆,林钰恒,吴钧烨,陈增发,黄双武,深圳大学材料科学与工程学院,电子信息工程学院,微电子研究院,广东省功能材料界面工程研究中心,射频异质异构集成国家重点实验室,深圳518060 (e-mail: xkliu@szu.edu.cn)。
王新中,深圳信息职业技术学院,广东深圳518172(电邮:wangxz@sziit.com.cn)。本文中一个或多个图形的彩色版本可在https://doi.org/10.1109/TED.2023.3279059上获得。数字对象标识符10.1109/TED.2023.3279059
英文原文如下:
