碳化硅(SiC)具有优良的电学和热学特性,是一种前景广阔的宽禁带半导体材料。SiC 材料制成的功率 MOSFET 非常适合应用于大功率领域,而高温栅氧可靠性是大功率 MOSFET 最需要关注的特性之一。本文通过正压高温栅偏试验和负压高温栅偏试验对比了自研SiC MOSFET 和国外同规格 SiC MOSFET 的高温栅氧可靠性。负压高温栅偏试验结果显示自研 SiC MOSFET 与国外 SiC MOSFET 的阈值电压偏移量基本相等,阈值电压偏移量百分比最大相差在 4.52%左右。正压高温栅偏试验的结果显示自研 SiC MOSFET 的阈值电压偏移量较小,与国外 SiC MOSFET 相比,自研 SiC MOSFET 的阈值电压偏移量百分比最大相差 11%。自研器件占优势的原因是在 SiC/SiO2界面处引入了适量的氮元素,钝化界面缺陷的同时,减少了快界面态的产生,使总的界面态密度被降到最低。
引言
SiC 是一种非常优秀的半导体材料,拥有优良的物理和电学特性。SiC 材料与 Si 材料相比具有禁带宽度更宽、临界击穿场强更大、电子饱和漂移速度更快等优点[1]。与 Si 器件相比,SiC 器件具有更低的导通电阻、更高的开关频率,这使得 SiC 器件的导通损耗更小,装置体积可以做的更小,此外 SiC 器件还具有更好的耐高温、抗辐射性能[2]。随着半导体技术的发展,Si 基功率半导体器件逐渐逼近其物理极限,在轨道交通、智能汽车、开关电源、工业电机等领域,SiC 功率器件得到快速的发展和应用[3]。在 SiC 功率器件中,SiC 功率 MOSFET 开关是国内外产业界和学术界研究的重点和热点[4],国外的罗姆、科锐、英飞凌等公司都推出了自己的 SiC MOSFET 产品。SiC MOSFET 栅介质和沟道界面影响器件的性能与可靠性[5]。本文主要对自研的 SiC MOSFET 和国外公司的 SiC MOSFET 器件进行高温可靠性测试分析。
1 SiC MOSFET 栅氧化层可靠性
SiC基MOSFET器件栅氧界面处的势垒高度较低,较低的势垒高度使沟道中的载流子更容易穿过势垒来到氧化层中,影响栅氧化层的质量。另一方面,SiC 在氧化过程中残留在界面处的 C 元素会在 SiC/SiO2的界面处带来较高的界面态密度[6]。高密度的界面态会影响 SiC MOSFET 器件的性能和可靠性[7]。界面处的电荷陷阱通过俘获电荷降低载流子密度,通过库伦散射降低载流子迁移率,影响 SiC MOSFET 的电流能力和跨导等特性;界面态电荷陷阱在器件开启和关断的过程中俘获和释放载流子,使得 SiC MOSFET 的阈值电压发生漂移[8]。栅氧化层和界面态电荷陷阱增大 SiC MOSFET 在高电场下的隧穿电流,增大漏电流、击穿栅氧介质导致器件失效。
在实际应用中可靠性是评价器件性能的重要指标,因此对 SiC MOSFET 的可靠性进行评估具有重要意义 [1]。以下介绍 SiC MOSFET 的一种可靠性评估方法,高温栅偏(High Temperature Gate Bias,HTGB)试验。高温栅偏试验,是模拟 SiC MOSFET 在导通状态时的工作情况,将被测样品长时间持续保持在高温高栅压应力的条件下进行考核,然后对被测样品进行电学测试,监测其漏电流和阈值电压,并通过电学参数的变化来评估被测器件可靠性的评估方法[9]。高温栅偏试验是评估 SiC MOSFET 器件可靠性的重要试验,目的是确认有关晶体缺陷的栅极氧化膜可靠性,对评估栅氧化层的稳定性具有重要作用。
高温栅偏试验分为正向高温栅偏试验和负向高温栅偏试验。在正向高温栅偏试验中,栅极被长时间施加直流的正偏压,SiC 栅氧化层界面中的陷阱俘获电子使阈值上升。在负向高温栅偏试验中,栅极被长时间施加直流的负偏压,空穴被捕获,阈值下降。在高温下施加栅偏压的过程中,栅氧化层中的陷阱、可动离子,SiC/SiO2界面处的界面态、近界面态会随着偏压应力的累积发生俘获和运动[8]。高温下施加在栅极的偏压应力会向栅氧层中注入并累积一些电荷,电应力持续累积,会对 SiC MOSFET 的开关特性造成影响,使得阈值电压、导通电阻等发生变化,甚至使器件失效。
2 SiC MOSFET 高温栅偏试验
2.1 试验原理
高温栅偏试验通过同时施加栅极偏置和高温应力来评估 MOSFET 器件的栅氧化层可靠性。本次考核试验参考IEC60747-8 标准对器件进行考核。测试电路图如图 1 所示,通过对 SiC MOSEFT 器件高温栅偏试验前后阈值电压 VTH、栅漏电流 IGSS的对比研究器件在高温偏压条件下的可靠性。
2.2 试验过程
样品信息:A、B 是自主研制的不同栅氧条件的 SiC MOSFET,R、C 是国外同规格器件。挑选 A 器件 5 只、B 器件 5只、R 器件 3 只、C 器件 2 只,共 15 只器件进行试验。
试验条件:
1)负偏压 HTGB:Tj=175℃,VGS=-5V,VDS=0V,t=168hours,并在试验后 6 小时、12 小时、24 小时、48 小时、96 小时、168h 后进行器件静态特性对比测试。
2)正偏压 HTGB:Tj=175℃,VGS=+20V,VDS=0V,t=168hours,试验 168 小时后进行器件静态特性对比测试。
通过对试验前后阈值电压 VTH特性及栅漏电特性进行对比,以阈值电压的漂移幅度作为器件特性变化评估依据。
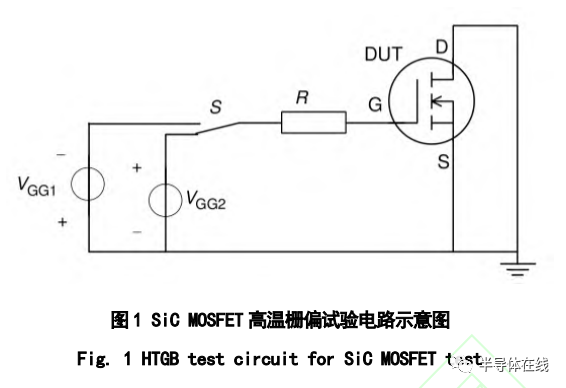
2.3 试验结果及分析
2.3.1 负压 HTGB 试验
图 2 给出了阈值特性曲线、阈值电压及阈值电压漂移情况的实验结果。

不同器件的阈值电压变化情况如表 1 所示

从图 2 以及表 1 可以看出,对于四种不同的 SiC MOSFET:
1)168 小时考核前后,自研器件 A、B 的阈值电压偏移量分别是 0.2V、0.16V,国外器件 R、C 的阈值电压偏移量分别是 0.21V、0.15V,A 与 R、B 与 C 分别相差 0.1V;自研器件 A、B 阈值电压偏移量百分比的变化分别是 10.29%、7.41%,国外器件 R、C 阈值电压偏移量百分比的变化分别是 5.77%、6.37%。自研器件与国外器件相比,差距不大;自研器件 A与 B 相比,器件 B 阈值电压偏移量更小。
2)随着考核时间的增加,阈值电压逐渐减小,减小的幅度越来越小。
图 3 给出了反向高温栅偏试验前后正向栅源漏电流(IGSSF)和反向栅源漏电流(IGSSR)的实验结果。
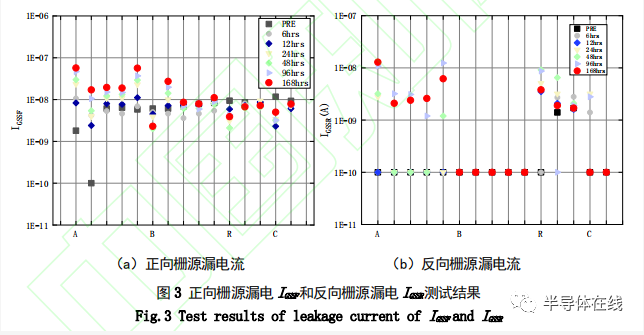
从图 3 可以看出对于四种不同的 SiC MOSFET 器件:
1)正向栅源漏电流有随偏压时间的增加而增加的趋势,试验都在 10nA 左右,自研器件和国外同规格器件之间没有明显区别;自研器件 A 与 B 相比,正向栅漏电流没有明显区别。
2)R 组中有一个器件在试验前的反向栅源漏电为 2nA,其它器件的反向栅源漏电在试验前都低于 0.1nA,试验后 B组器件仍低于 0.1nA,其他 3 款器件增加到 5nA 左右。在负压栅偏试验中,自研器件反向栅漏电流变化幅度更小,稳定性更好;自研器件 A 与 B 相比,器件 B 的反向栅漏电流更小。
2.3.2 正压 HTGB 试验
图 4 给出了正向高温栅偏试验后阈值特性曲线、阈值电压、阈值电压偏移量的结果。

正压高温偏压试验前后不同器件的阈值电压变化情况如表 2 所示:

图 4 以及表 2 可以看出,对于四种不同的 SiC MOSFET,正向高温栅偏试验前后:
1)自研器件 A、B 的阈值电压偏移量较小,分别是 2.18V、2.40V,偏移量大约为 18%;国外同规格器件 R、C 的阈值电压偏移量较大,分别是 3.98V、2.58V,偏移量在 29%左右。这说明自研器件在正向高温栅偏试验中的可靠性要优于国外同规格的器件。
2)自研器件 A、B 在试验 24 小时之后复测,阈值电压回复量在 0.2V 左右;国外同规格器件阈值电压的回复量在0.6V 左右,表明自研器件具有更优的阈值稳定性高温栅偏试验前后的正向栅源漏电流(IGSSF)和反向栅源漏电流(IGSSR)如图 5 所示。
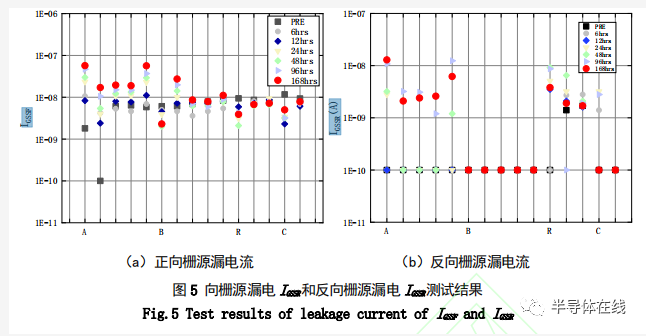
从图 5 可以看出,对于 4 种不同的 SiC MOSFET 器件,经过正向 HTGB 试验:
1)正向栅源漏电流经过正向高温栅偏试验都有变小趋势,四款器件没有明显区别,说明自研器件与国外同规格器件性能相近。
2)反向栅源漏电流在试验前后都比较小。器件 A、B、R 的反向栅漏电流在试验前后和 24 小时之后复测都低于 1nA;C 组器件中,第一个器件的反向栅源漏电在试验前后分别是 1.5nA 和 nA,24 小时之后复测为 4nA,第二个器件的反向栅源漏电在试验前后都小于 1nA,24 小时之后复测为 1.6nA。
对两款自研器件的栅氧工艺条件进行分析,如表 3 所示。

样品 A 与样品 B 相比,改变了氮化气体的体积分数,氮化气体的体积分数分别为 6%和 12%。SiC 进行氮化退火的机理是引入氮元素,与表面的 C 相关缺陷结合,钝化界面态从而降低表面的界面态。但是,有文献指出,引入的氮原子数量过多时引入的 N 原子与 C 相关缺陷等结合后在界面处形成空穴陷阱,使界面态密度不能降到最低[10-11]。其中东京大学和范德比尔特大学都有相关研究,东京大学指出界面处的 N 含量与快界面态的密度呈正比,美国范德比尔特大学的 Rozen 等人证明了在对 SiC/SiO2和 Si/SiO2界面系统进行氮化退火处理时,退火后的半导体/SiO2界面及近界面的空穴陷阱密度和 N 的含量成线性关系,N 的含量越多,空穴陷阱密度越大。
在负偏压栅漏电测试实验中,测试温度为室温,P-F 隧穿电流与温度呈指数关系,且随温度的增加而增加。结合Le-Huu 等人对 SiC MOS 栅漏电流的研究成果,可以认为我们测试得到的漏电结果,以 P-F 隧穿电流为主,F-N 隧穿电流占栅漏电流较小的部分。在栅漏电流的测试结果中,的栅漏电流正向栅漏电流差距不大,反向栅漏电流样品 B 的最小。根据 P-F 隧穿电流的隧穿机理,在第一阶段空穴通过隧穿过程进入到 SiO2中的陷阱能级,然后在第二个阶段通过热激发转移到氧化层中,陷阱能级在其中起重要作用。结合上文中提到的退火条件对界面密度的影响,可以分析得出,样品 B 的退火条件向界面引入了合适的 N 原子,在钝化界面缺陷的同时,生成的界面空穴陷阱较少,使界面处的缺陷总量较小,较小的界面缺陷使得样品 B 在高温偏压试验前后的阈值电压漂移量较小,反向偏压漏电也较小,反向偏压漏电和高温偏压漏电的结果可以相互验证。
3 结论
本文对自研器件和国外同规格器件进行正压和负压高温栅偏试验,通过观测试验前后的阈值电压、正向栅源漏电流和反向栅源漏电流的变化量对器件的可靠性进行分析。
在负压高温栅偏试验中,自研器件与国外器件的阈值电压变化量绝对值相差不大,分别是 0.2V、0.16V 与 0.21V、0.15V,自研器件的阈值电压偏移量百分比与国外器件相比稍大;自研器件和国外器件的栅源漏电流没有明显差别。
在正压高温栅偏试验中,自研器件与国外器件阈值电压漂移分别是 2.18V、2.40V 和 3.98V、2.58V;自研器件与国外器件的正向栅漏电流变化相当,反向栅漏电流与国外器件相比更稳定。
自研器件 A 和 B 的氮化气体体积分数分别是 12%和 4%,器件 A 在 SiC/SiO2界面处引入了过量的氮元素,钝化界面缺陷的同时,快界面态的产生过多,界面态密度没有被降到最低;器件 B 在 SiC/SiO2界面处引入的氮元素含量适当,钝化界面缺陷的同时,减少了快界面态的产生,使总的界面态密度被降到最低。
来源:电源学报 作者:中国科学院大学微电子学院 刘建君,中国科学院微电子研究所 陈宏 、白云、郝继龙、韩忠霖,株洲中车时代半导体有限公司 丁杰钦
(以上文章系转载,并不代表半导体在线的观点,如有涉及版权等问题,请联系我们以便处理)
