碳化硅(SiC)材 料 的 热 导 率 高,晶 格 匹 配 性 优 异,由其外延 得 到 的 GaN 薄 膜 结 晶 质 量 是 最 优 的,然 而SiC衬底的价格高昂,晶圆 尺 寸 小(3~4 英 寸 为 主),不利于 GaN 射频器件的产业化。硅(Si)材料的价格低廉、晶圆尺寸大(≥6英寸)、热导率良好,若能解决SiCMOS工艺与 GaN 制备工艺的兼容问题,即可低成本、大规模地生产 GaN 射频器件,进而推动5G 通信及其他新兴技术的普及应用。此外,除 了 传 统 的 单 一射频芯片 或 功 率 器 件 外,还 可 利 用 Si工 艺 平 台 实 现GaN 射频器件与功率器件的单片集成,以及与Si器件的异质异构集成等,大幅提升电路 性 能 与 集 成 密 度,推动智能前端芯片技术发展。因此 Si基 GaN 技术正受到国内外科研院所与产业界越来越多的关注 [6-8]。
本文主要调研了 近 年 来 国 内 外 关 于 Si基 GaN 射频器件在材料、工 艺 与 电 路 上 的 研 究 进 展,剖析了相关技术难点与存在问题,并展望了 Si基 GaN 射频器件未来的优化发展方向。此 外 还 基 于 射 频 损 耗 较 低 的高阻 Si上 AlGaN/GaN HEMT 材 料,报 道 了 研 制 的0.25μm 及0.4μm 工艺下的Si基 GaN 射频器件,经测试在 C波段及 X 波段下工作性能优异,揭示了Si基GaN 射频器件在5G 应 用 及 低 成 本 雷 达 等 领 域 的 独 特优势和应用前景。
1.国内外研究现状
自20世纪90年代初,Khan等[9]在蓝宝石衬底上率 先 制 得 了 AlGaN/GaN 结 构, 随 后 AlGaN/GaN HEMT 的 直 流 及 微 波 特 性 相 继 被 报 道[10-11], 关 于GaN HEMT器件的研究逐渐成为热点。由于 GaN 单晶难以制备,GaN HEMT器件一般由异质外延生长得到,所使用 的 衬 底 材 料 有 SiC、蓝宝 石、Si三 种。半绝缘SiC材料由于 具 备 良 好 的 晶 格 匹 配 性 和 优 良 的 热导率,一直是 GaN HEMT 外 延 衬 底 的 最 佳 选 择。然而,SiC作为衬底存 在 着 晶 圆 尺 寸 小、成本过高的问题,严重限制了 GaN 器件的推广应用。而对于蓝宝石衬底,其晶圆尺寸 较 大 且 价 格 较 为 便 宜,但其硬度太高、热导率极低且晶格失配大,不 利 于 后 续 加 工 与 应用。相较之下,Si衬底上 GaN 技术不仅具有较好的热导率和最低的衬底成本,而 且 晶 圆 尺 寸 大,起点6英寸且易升级到8英寸以上,并可与Si工艺线兼容,具有显著的成本优势和 规 模 化 生 产 能 力。下面将介绍近年来国内外关于Si基 GaN 射频器件的研究进展。
1.1Si基 GaN 射频材料优化生长
Si与 GaN 之间存在的较大晶格失配和热失配是制约Si基 GaN 技 术 发 展 的 主 要瓶颈,由 失 配 产 生 的 位错与应力会严重 影 响 结 晶 质 量,并 恶 化 器 件 性 能。因此如何消除各外延 层 之 间 的 应 力,探 究 出 有 效 的 应 力调控技术,是改善 Si基 GaN 射 频 器 件 各 项 特 性 的 基础。此外,与电力电子器件不同,Si基 GaN 射频器件由于高阻Si晶圆难以制备,且衬 底 与 成 核 层 界 面 处 易形成导电层,导致器 件 在 高 频 工 作 状 态 下 存 在 射 频 损耗,限制输出功率和效率。因此,如 何 优 化 衬 底 及外延结构,抑制射频损耗,是实现 Si基 GaN 射频器件大规模高效应用的关键。
2019年,Tzeng等[12]在8英寸Si衬底上分别制备了 Al组分渐变 AlGaN 缓冲层和 AlGaN/GaN 超晶格缓冲层 两 种 结 构 的 GaN HEMT 器 件,如 图 1 所 示。经 TEM、XRD、拉 曼 光 谱、AFM、EPD、直 流 特 性以及频率特性等系统地测试 分 析 比 较 两 种 结 构 对 器 件各项性能指标的影响,发现采用 AlGaN/GaN 超晶格缓冲层结构的器件无论是结 晶 质 量 还 是 直 流 特 性 或 频率特性均展现出更优的测试结果,在0.17 μm 栅长下测得fT和fmax分别达到41.6GHz和126.46GHz。同年 Yang等[13]设计了Si掺杂的 AlGaN 背势垒层以及 C掺杂的 GaN 缓冲层得到了漏电小、耐击穿且电流崩塌效 应 低 的 Si基 AlGaN/GaN HEMT 器 件。2020 年,Xia等[14]分 析 了 GaN 和 SiN 两 种 不 同 帽 层 结 构 对AlN/GaN HEMT器 件 性 能 退 化 的 抑 制 效 果,发 现 带有3.5nm 原位钝化SiN 帽层以及4.5nm AlN 势垒层结构的Si基 GaN HEMT 器 件 具 有 最 低 的 薄 层 电 阻、最 高 的 二 维 电 子 气 浓 度 (Two-DimensionalElectron GasDensity)以及最好的稳定性。
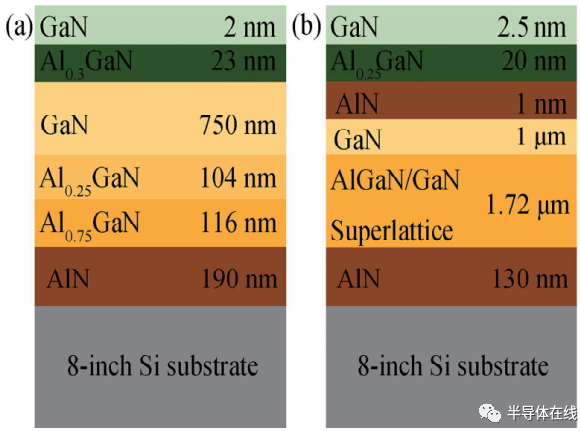
图1 采用组分渐变 AlGaN 的缓冲层结构(a)和 AlGaN/GaN超晶格的缓冲层结构(b)[12]
2017年,Luong等[15]采 用 HLH Temperature的生长模式在高阻Si衬底(104 Ω·cm)上外延出100nm的 AlN 缓 冲 层,得 到 的 GaN HEMT 有 效 抑 制 了 因AlN/Si之间晶格失配所产生的张应力,从而降低极化电场强度,减小射频损耗。通过对长度为1 mm 的共面波导(CPW)测 试,10 GHz下 射 频 损 耗 仅 0.4dB/mm,40GHz下的射频损耗低于1.2dB/mm,材料结构及测试结果如 图 2 所 示。同 年,Cordier等[16]采 用NH3-MBE技术,在高阻Si衬底(104 Ω·cm)上生长了0.2μm 的 AlN 成核层和0.5 μm 的 GaN 缓冲层,此生长模式相较于 MOCVD 更易控制 AlN/Si间的界面态,且其低温生长特性 能 在 抑 制 界 面 态 漏 电 的 同 时 保证高结晶质量。经测试35GHz下的射频损耗低于0.3dB/mm,且70GHz下的射频 损 耗 低 于0.5dB/mm,并对比了不同 AlN 生长温度 对 射 频 损 耗 的 影 响,如图3所示。此外,Chiu等[17]利用绝缘衬底上硅(SOI)制备 了 AlGaN/GaN MISHEMT, 采 用 SOI 衬 底 的HEMT器件具有低寄生电容、低射频损耗、高衬底绝缘度等适用于射频器件的优点,经测试0.25 μm 栅长下fT和fmax分别达32.1GHz和51.9GHz。
可以看出合理的帽层、势 垒 层 以 及 缓 冲 层 等 结 构设计不但能够调控应 力 提 高 结 晶 质 量,还能使器件具备优异的直流特性和频率特性,与 此 同 时 要 优 化 衬 底及成核层结 构 以 求 降 低 射 频 损 耗,一 方 面 可 以 提 高AlN 的结晶质量并抑制 AlN/Si间的界面态,另一方面应从缓 冲 层 及 Si衬 底 入 手,提 高 器 件 绝 缘 度,减 小漏电。
图片
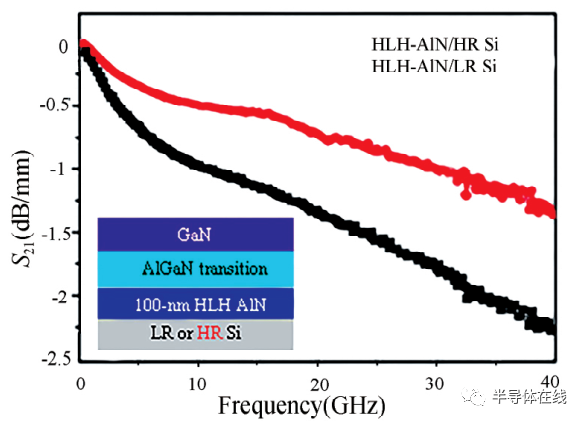
图2 高低阻Si衬底上外延100nm HLH AlN 的射频损耗[15]
1.2 无金的Si基 GaN 工艺技术
现有的Si基 射 频 GaN 器 件 制 造 工 艺 几 乎 都 是 基于有金(Au)工艺 完 成 的。Au是 传 统 GaN 器 件 欧 姆 接触工艺中的必 备 金 属 之 一,采 用 Ti/Al/X/Au(X 可 为Ti、Ni、Mo、Pt等)结 构 合 金 的 接 触 电 阻 可 达 到0.3Ω·mm 左 右,且 性 能 稳 定。然 而,含 Au的 GaN 制备工艺存在着成本高以及与传统 CMOS工 艺 不 兼 容 等问题,提高了 Si基 GaN 射 频 器 件 的 生 产 成 本。实 现无 Au工艺的关键是做到源漏金属的无 Au化,对此已有 Ti/Al/TiN、Ti/Al/Ti/TiN、Ti/Al/W、Ti/Al/Ti/TiW、Ti/Al/Ni/Pt、Ti/Al/NiV 等 方 案 提 出,所 获 得的欧姆接触电阻 一 般 在0.5~1.0Ω·mm,尽 管 这 些方案能够 一 定 程 度 地 满 足 电 力 电 子 功 率 器 件 的 需 求,然而面对射频器件对 寄 生 电 阻 的 严 格 要 求 仍 存 在 较 大的差距。
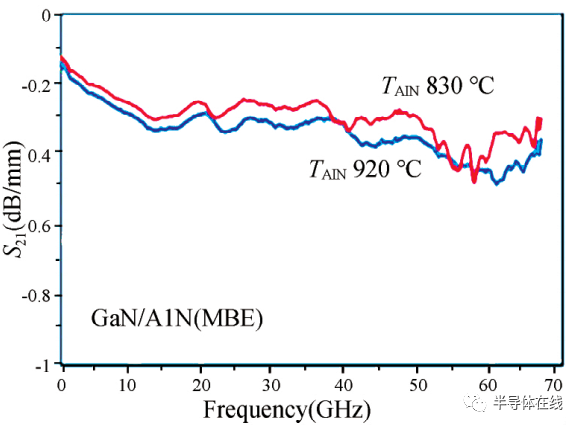
图3 不同温度下采用 NH3-MBE技术生长 GaN/AlN缓冲层的射频损耗对比[16]
2017年,Ferreyra等[18]采 用 脉 冲 激 光 烧 蚀 技 术(PLD),在Si衬 底 上 制 备 了 表 面 光 滑 且 形 貌 良 好 的n+ -GaN,并在 其 上 淀 积 Hf/Al/Ti(20/200/20nm)形成无 Au欧姆接触,此外 Hf金属的功函数(3.5eV)低于 Ti(4.1eV)与 TiN(4.7eV),故 更 适 合 作 为 欧 姆 接触的 电 极,经 测 试 得 到 接 触 电 阻 为0.17Ω·mm,比接触 电 阻 可 达 10-7 Ω·cm2 量 级。2018 年,Zhang等[19]在Si衬 底 上 经 势 垒 层 刻 槽 处 理 后,采 用 Ti/Al/Ti/TiN (2.5/100/20/60nm)的 无 Au欧 姆 接 触 工 艺 制备了 AlGaN/GaN HEMT 器 件,退 火 后 的 结 构 如 图4所示。其中底 层 金 属 Ti的 厚 度 仅 为2.5nm,既 能 够形成厚度适宜 的 TiN 层 让 Al与 TiN 发 生 固 相 反 应 生成 AlN,又不会因 Ti太厚而阻止两者反应,使接触电阻大大降低,在550 ℃下 合 金 得 到 的 接 触 电 阻 与 比 接触电阻分别为0.21Ω·mm 和1.16×10-6 Ω·cm2。
可见采 用 二 次 外 延 高 质 量 n+ -GaN、势 垒 层 刻 槽以及无 Au欧 姆 接 触 等 技 术,能 够 得 到 较 低 的 接 触 电阻和比接触 电 阻 并 改 善 表 面 形 貌。此 外 无 Au的 欧 姆接触工艺也为实现无 Au的Si基 GaN 技术,降低生产成本提供了保障。
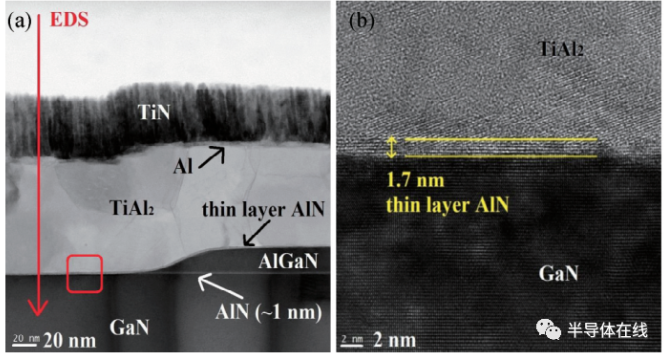
(a)合金退火后金属结构;(b)合金与半导体接触面结构
图4 Ti/Al/Ti/TiN 在550 ℃退火后的 HR-TEM 图[19]
1.3 复合钝化的Si基 GaN 工艺技术
为了 解 决 Si基 GaN 射 频 器 件 的 电 流 崩 塌 问 题,一般需要在器件表面淀积 SiN 钝化保护层,其能够有效抑制表面态对电子的俘获效应,从而抑制电流崩塌,但是与此同时沟道的 电 子 浓 度 也 会 提 高,短沟道效应也随之加剧,恶 化 输 出 特 性 和 关 断 特 性。此外SiN 钝化层通常由PECVD 低温生长得到,此工艺会导致SiN薄膜中 H 离子杂质过多且致密性较差,钝化效果不理想。并且由于Si衬底的绝缘度远不如SiC 衬底,漏电问题也严重制约着 Si基 GaN 射 频 器 件 的 性 能。因此探究高水平的先进钝化工艺是 有 效 抑 制 电 流 崩 塌 和 表面漏电的关键技术方案。LPCVD 不同于 PECVD,是一种高温钝化SiN 的工艺,通 常 在 器 件 工 艺 开 始 前 完成,生长得到 的 钝 化 层 致 密 性 好、质量高。原位钝化MOCVD 是一种在 GaN 生长结束后继续生长SiN 保护层的方法,能够有效避 免 器 件 表 面 受 到 外 界 环 境 的 污染,故钝化效果良好。
2019年,Zhang等[20]采 用 LPCVD 技 术 在 GaN表面生长了一层20nm 的 SiN 钝化层,经 CV 测试分析发现由 LPCVD 生 长 的 钝 化 层 相 较 于 PECVD 具备更好的致 密 性,并 且 能 够 有 效 抑 制 表 面 漏 电。2020年,Chen等[21]采用原位钝化 MOCVD 技术在势垒层上生长了3nm 的SiN 作为栅介质,制得0.7μm 栅长的 AlGaN/GaN MISHEMT 器件性能良好,电路开关比达106,电流退化率为18%,测得fT和fmax分别为12.5GHz和15GHz。为了比较 PECVD、LPCVD 复合钝化以及原位钝化 MOCVD 对电流崩塌以及表面漏电的抑制作用,Huang等[22]用 上 述 三 种 不 同 的 方 式 在同种器件结构上制备了三种SiN 钝化层,钝化效果对比 如 图 5 所 示, 可 以 看 出 LPCVD 复 合 钝 化 层(Bilayer)的曲线波动是最小的,说 明 该 种 钝 化 方 式 对电流崩塌和表面漏电的抑制效果最好。
为在 抑 制 电 流 崩 塌 的 同 时 减 小 漏 电, 并 改 善PECVD 钝化带来的致密性差、H 离 子 杂 质 多 等 问题,可采用原位钝化 MOCVD 以及 LPCVD 生长高质量的钝化层。然而致密 性 过 高 的 钝 化 层 难 以 刻 蚀,会影响后续器件工艺开展,对 此 可 采 用 复 合 钝 化 的 办 法,在一层较薄的原位钝化 MOCVDSiN 或 LPCVDSiN 上通过PECVD 继续生长SiN,最终形成的高质量复合钝化层既有很好的保护作用又便于后续器件工艺的进行。

(a)电流响应;(b)陷阱时间常数
图5 三种钝化层的效果对比[22]
1.4 Si基 GaN 射频器件与电路设计
伴随着材料结构设计和器件制备工艺的持续改进,Si基 GaN 射频器件及其电路的性能也不断刷新着行业记录。
在微波毫 米 波 频 率 特 性 方 面,早 在 2004 年 法 国GaN 研究中心(IEMN)的 Minko等[23]率 先 在 电 阻 率 为20kΩ·cm 的高阻Si衬底上制备了栅长为170nm,且AlGaN 势垒层厚度为30nm 的 GaN HEMT射频器件,当源漏电 压 为 10 V,栅 电 压 为 1 V 时,输 出 电 流 为0.55A/mm,fT和fmax分别为46GHz和92GHz;并在2013年 Bouzid等[24]将 AlGaN 势垒层的厚度降低到12.5nm,栅长缩短到90nm,当源漏电压为5V,栅电压为 -2.1 V 时, 测 得 fT 和 fmax 分 别 提 高 到 100GHz 和 206 GHz。2009 年, 瑞 士 联 邦 理 工 学 院(EPFL)与 苏 黎 世 联 邦 理 工 学 院(ETH)合作[25],采用17.5nm Al0.26Ga0.74N 势垒层,栅长为100nm,源漏电压为2.5V,栅电压为-2V 时,输出电流为0.75A/mm,fT和fmax分别为101GHz和128GHz;2015年 Marti等[26]采 用 3.5nm 厚 的 AlInN 作 为 势 垒 层,制备了栅长为50nm 的 AlInN/GaN HEMT 器件,源漏电压5V,栅电压2V 时,输出电流为1.6A/mm,fT和fmax分别提升至141GHz和232GHz。新加坡南洋理工大学(NTU)在大尺寸硅基 GaN 材料外延与器件制备方面也进 行 了 大 量 的 研 究,2012年 Ng等[27]基于8英寸Si晶圆制备了栅长为0.3μm 的Si基 GaN 射频器件,源漏电压为10V,栅电压为-2V 时,测试得到fT和fmax分别为28GHz和64GHz;接着在2014年 Ranjan等[28]又 报 道 了 基 于 高 阻 Si衬 底 的 T 型 栅AlGaN/GaNHEMT器件,其采用了厚度仅为8nm 的AlGaN 势垒层,栅长为0.15 μm,经测试fT和fmax分别达 到 了 63 GHz和 128 GHz,击 穿 电 压 为 132 V,Johnson品质因子高达8.32THz·V。此外,在2018年他们还与 MIT 合作[29]报道了40nm 栅长的I型 栅InAlN/GaN HEMT器件,测得fT和fmax分别达到250GHz和60GHz。同年,南京电子 器 件 研 究 所 与 苏 州纳米所合作[30]报道了55nm 栅长的 T 型栅 AlGa(In)N/AlN/GaNHEMT器件,经测试fT和fmax分别为145GHz和220GHz,可与国外先进研究成果相媲美。
在微波功率方面,日本 OKI公司的Shinichi等[31]在2009年就有相关研究成果报道,在源漏电压为70V,工作频率为2.14GHz时,测试高阻Si基 GaN 射频器件功率 特 性,得 到 输 出 功 率 密 度 (Pout)达 12.88W/mm,最大功率附加效率(PAE)达64%,测试结果表明Si基 GaN 在射频应 用 方 面 存 在 巨 大 潜 力;同年,瑞士联邦理工学院的 Sun等[25]基于9nm 厚的 AlInN势垒层,研制了栅长为100nm 的Si基 GaN HEMT器件,在源漏电压为15V,工作频率为10GHz时测得Pout为 2.5 W/mm,PAE 达 23%;2012 年,Chang等[32]采用斜场板结构研制的Si基 AlGaN/GaN 器件在8GHz下 Pout达到了5 W/mm;2014年,日本瑞萨电子的 Yasuhiro等[33]制备了栅长为0.16 μm 的 T 型栅AlGaN/GaN HEMT器件,源漏电压为30V,工作频率为14GHz时,Pout为3.82 W/mm;同 年,首 尔 大学的 Lee等[34]报道了研制的Si基 AlGaN/GaN HEMT器件在 8 GHz下 的 功 率 性 能,脉 冲 输 出 功 率 达 8.1W/mm(脉宽为100μm,占空比为10%),功率增益为8dB,PAE达39%,总功率接近30 W。
在 毫 米 波 功 率 方 面, 法 国 IEMN 的 Medjdoub等[35]于2012年 在 4 英 寸 高 阻 Si衬 底 上 制 备 了 AlN/GaN HEMT器件并展示了首个40GHz频率下的功率测试结果,得 到 Pout为 2.5 W/mm,器 件 结 构 及 ID-VGS曲线如图6所示;2013年 Medjdoub 等[36]又将 40GHz下 的 Pout提 高 到 3.2 W/mm;2015 年 ETH 的Marti等[26]报道了国际上首个 W 波段 Si基 GaN 射频器件,工作频率为94GHz时,Pout达1.35 W/mm。
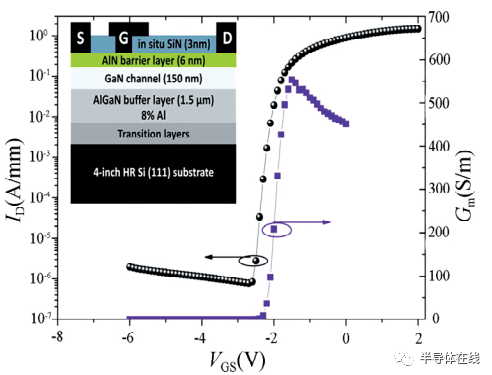
图6 IEMN 制备的毫米波器件结构及其ID -VGS曲线[35]
在产品方面,近年来在5G 通 信 技 术 和 先 进 低 成本相 控 阵 雷 达 得 到 越 来 越 广 泛 应 用 的 大 背 景 下,OMMIC、MACOM、IMEC 以 及 MIT 等 海 外 巨 头 公司和机构纷纷加大投入,在器件性能、成本和技术等方面展现出 卓 越 的 市 场 竞 争 实 力,其 中 代 表 公 司 有MACOM 和 OMMIC。
MACOM 公司自2014年起着力研究 Si基 GaN 技术,并逐渐将重心从SiC基 GaN 芯片转移过来,截至目前已经开发了多代Si基 GaN 射频器件,向通信、军事以及其他应用领域的客 户 提 供 了 上 百 万 件 基 于Si基GaN技术的产品。采用标准的0.5μm HEMT工艺制程制备的分立 及 集 成 放 大 器,能够在直流到6GHz的超宽频带范围内工作,同时产品的增益、增益平坦度、效率以及 稳 定 性 均 处 于 行 业 领 先 水 平,如 NPTB00004A
型宽带 GaN晶体管在28V工作电压以及2.5GHz频率下的线 性 增 益 达 14.8dB,Pout为 5 W,且 PAE 超 过55%,凭借其超 宽 的 工 作 频 率 范 围 可 应 用 于 L/C波段雷达、无线通信 以 及 航 空 航 天 等 领 域。此外 MACOM公司还于2018年宣布了与意法半导体(ST)的合作计划,由ST协助 MACOM 生产晶圆,显著提升了Si基 GaN射频芯片的产能以及国际竞争力。
OMMIC公司于2006年 开 始 Si基 GaN 毫 米 波 功放的研究,并于2015年开发出100nm 制程下的Si基GaN 器件 制 备 工 艺 技 术 (D01GH), 在 30 GHz 时,Pout达3.3 W/mm,40GHz下的噪声系数为 1.5dB,已接近 SiC 基 GaN 器件性能。紧接着在2016年公布了首个基于Si基 GaN 技术的高性能 T/R 芯片,能够在37~43GHz频率范围内工作,40GHz下的总输出功率达10 W,且 PAE达30%,实现了低噪放、功放以及开关的单片集成,可 较 好 地 应 用 于 雷 达、通信以及航空等领域。目前 OMMIC 公 司 已 具 备 全 球 领 先 的6英 寸 Si基 GaN 生 产 线, 并 且 制 程 推 进 到 60nm(D006GH),未来将继续向下开发40nm 线宽的Si基GaN 制程,并向市场提供功放、低噪放、开关以及移相器完全集成,且兼容增强型和耗尽型器件的 T/R 芯片单片化方案,其 T/R 芯片的发展路线如图7所示。可见 尽 管 Si基 GaN 器 件 在 性 能 方 面 与 SiC 基GaN 器件相比还存在差距,但 是 随 着 材 料 生 长 技 术 和器件制备工艺的逐渐成熟,Si基 GaN 器件的截止频率和功率密度 等 主 要 参 数 都 在 逐 步 提 高,未 来 达 到 与SiC基 GaN 相媲美的 性 能 指 日 可 待。同时微波毫米波频段下基于 Si基 GaN 射 频 器 件 的 产 品 也 陆续得以发布,展现出了巨大的竞争潜力,相 信 在 未 来 将 逐 步 占据更大的市场份额。
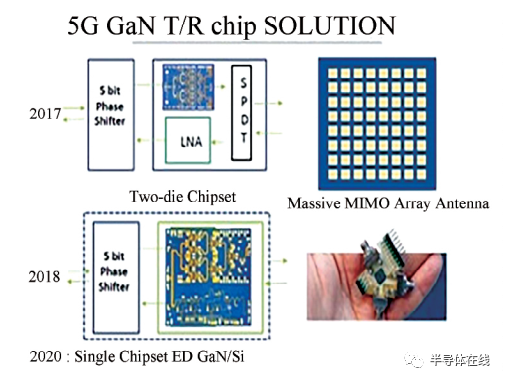
图7 OMMIC公司发布的0.1μmSi基 GaN 收发芯片
2 Si基 GaN 射频器件研制
图8为 制 备 的 0.25 μm 和 0.4 μm 栅 长 的 Si基GaN 材料与器件结构示意图,本 结 构 的 外 延 层 总 厚 度仅有2μm 左右,既能满足典型28V 电压下的正常射频工作,又可确保材 料 具 备 较 低 的 热 阻,同时对 GaN缓冲层进行一定浓度的 C 掺杂后 测 得 射 频 损 耗(0.72dB/mm@4GHz)已接近SiC基 GaN 材料的结果(0.54dB/mm@4GHz),此 外 还 采 用 了 基 于 难 熔 W 金属的叠层 V 型 栅 结 构,以 得 到 更 大 的 击 穿 电 压 和 更 高 的频率。
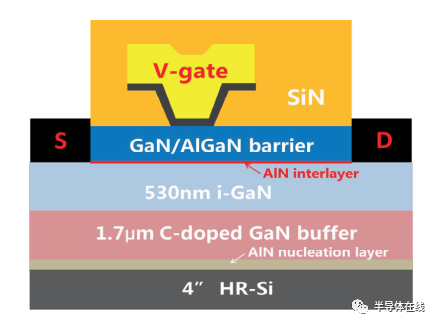
图8 Si基 GaN 射频材料与器件结构示意图
经直流 测 试,0.25 μm 器 件 的 最 大 电 流 密 度(IDS.max)达0.97A/mm,峰值跨导(Gm.max)为0.29S/mm,0.4μm 器 件 的 IDS.max为 0.95 A/mm,Gm.max为0.26S/mm。此外按照IDS=1mA/mm 的标准,0.25μm 和0.4μm 器 件 的 击 穿 电 压 均高于80V,满足28V 工作需求。频率方面,经测试去嵌后0.4 μm 器件的fT和fmax分 别 为 27 GHz和 33 GHz;而 根 据 -20dB/dec斜率外推 |h21 |2和 MSG/MAG,得0.25μm器件的fT和fmax分别为35GHz和42GHz。
经 Load-Pull连续波功率测试,0.4 μm 器件在频率为4GHz,电压为28V 下 的 线 性 增 益 高 达17dB,PAE约为50%,Pout为4.5 W/mm。图9显示了0.25μm 器件在10GHz的测试结果,源 漏 偏 置 电 压 为20V,线性增益为12.3dB,Pout为3.6 W/mm,PAE 约为45%。
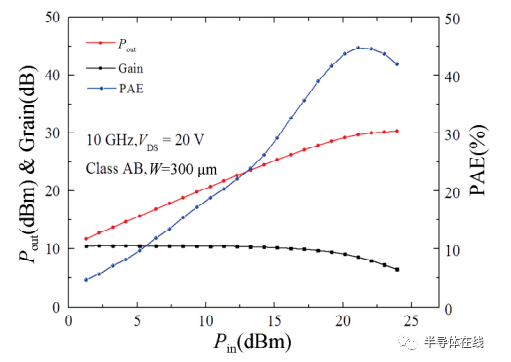
图9 10GHz时Si基 GaN 器件的功率特性
此外,还将0.25 μm 工艺 Si基 GaN 射频器件在10GHz左右的 功 率 特 性 分 别 与 国 外 研 究 成 果 进 行 对比,如表1所示,可见研制的Si基 GaN 射频器件功率特性良好,达到国际先进水平。
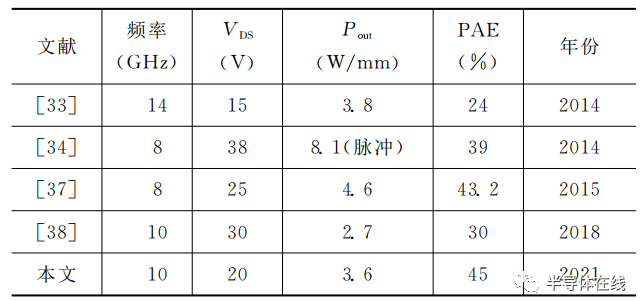
表1 Si基 GaN 射频器件在 X 波段下功率特性对比
3 总结与展望
通过对 Si基 GaN 射 频 器 件 在 材 料 生 长、器件制备以及器件性能等方面的调研分析,介绍了改善Si基GaN 材料结构 缺 陷 并 优 化 器 件 制 备 流 程 的可靠途径。材料方面,超 晶 格 缓 冲 层、背 势 垒 层、C 掺 杂 GaN层、高质量成核层、GaN 帽 层 以 及 高 绝 缘 度 衬 底 等 结构设计,均有助于 改 善 晶 格 失 配、漏 电 及 射 频 损 耗 等问题,而面向于射频领域的 Si基 GaN 材料结构还应控制外延层厚度 以 获 得 较 低 的 热 阻;工艺方面,为最大降低成本,无 Au工艺是必要选择,对于无 Au欧姆接触工艺,结合二次外延 n+ -GaN 以及势垒层刻槽等技术有助于提升表面 形 貌 并 降 低 接 触 电 阻,同时结合PECVD、原位钝化和 LPCVD 的复合 钝 化 工 艺 在 对 表面的保护和漏电的抑制方面均表现出良好的效果。
低成本、批量化的生产Si基 GaN 射频器件是5G通信、射频源等应 用 实 现 的 重 要 保 障。尽管目前国内外各研究机构在 Si基 GaN 射 频 材 料 外 延 与器件性能方面取得了一定进展,但是性能上与SiC衬底 GaN 相比仍然存在较大差距,而且可靠性 未 得 到 长 期 验 证,离产业化尚存在较大距离。未来,通 过 提 高 外 延 材 料质量,开发兼容 CMOS的大尺寸制造工艺,提高Si基GaN 器件与电路芯片性能,降低生产成本,有望推动GaN 射频技术在各类民生领域的普及应用。





