采用钨制触点替代 GaN 肖特基势垒二极管中的传统触点可降低接通电压。
通过采用钨触点,中国西安电子科技大学的研究人员能够改善具有垂直几何结构的GaN 肖特基势垒二极管的性能。工程师们声称,对于具有 100 V 或更高击穿电压的此类二极管的变体,钨阳极使接通电压降至新低。
工程师的发言人 Shenglei Zhao 认为,该研究小组工作的另一个重要方面是识别和确定反向漏电流机理。他认为,随着反向偏置的增加,起主导作用的泄漏机理从热离子发射转变为变程跳跃。
所有这些最新发现都来自于对准垂直(quasivertical)结构GaN肖特基势垒二极管的制作和研究,这是一种一般是在硅或蓝宝石衬底上制作,并在其正面具有阳极和阴极的器件。相比之下,完全垂直型(fully-vertical)器件是在 GaN 衬底上制作的,且在两面上各有一个触点。
据 Zhao 称,与其全垂直型同类器件相比,准垂直器件的两个缺点是活性区域较大和比导通电阻较高。这些不足之处源于正面阴极。
同时,与这些缺点“分庭抗礼”的是准垂直设计所具备的几项优势。Zhao 说:“蓝宝石衬底和硅衬底的成本比 GaN 衬底低得多。”他指出,在大型晶圆片上制造准垂直器件也较为容易;而且,由于两个电极位于晶圆片的同一面,因此这种架构适合设计和制作单片式电源 IC。
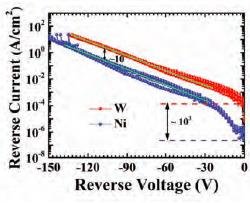
随着反向偏置电压的增加,漏电流的主导机理从热离子发射转变为变程跳跃。
GaN 准垂直肖特基势垒二极管的制造流程是:首先将蓝宝石衬底装入 MOCVD 反应室,并生长一个 2μm 厚的未掺杂 GaN 层,接着生长一个 3.5μm 厚的重掺杂 GaN 层,最后是生长一个 1.3μm 厚的轻掺杂 GaN 层。随后的台面刻蚀进入重掺杂层,在电子束蒸发之前增添 Ti/Al/Ni/Au 欧姆接触,通过在氮气中进行快速热退火予以改善。器件的制作完成需要采用溅射工艺,以形成一个肖特基电极。它具有 76μm 直径,并由50nm 厚的钨和 150nm 厚的金制成。
为了进行比较,研究人员制作了一个除电极之外其他方面完全相同的器件。控制器具有一个传统电极,由 45nm 厚的镍和 150nm 厚的金构成。在 20 个二极管(一半采用钨电极,另一半采用由镍制成的电极)上进行的电流- 电压测量显示,这两种器件均具有优良的均匀性。
对于采用钨阳极的二极管,理想因子(从这些曲线图中提取)为 1.01,而对于采用镍阳极的二极管变体,理想因子则为 1.02。据该研究小组说,这些近乎理想的特性表明,肖特基接触的界面是高度均质的,且电流受热离子发射的支配。
从传统的镍接触转变为采用钨制阳极,可将接通电压从 0.60eV 减低至 0.39eV,但是,这会使开关比(on-off ratio)性能指标下降,从 1010 跌至 108。
研究人员发现,在零偏置条件下,热离子发射对漏电流起着主导作用。在采用钨阳极的二极管中,由于肖特基势垒高度较低,因此漏电流的数值高出三个数量级。如果加大反向偏置,则漏电流的差值降至仅为一个数量级。出现这种情况的原因是:变程跳跃接替热离子发射成为居支配地位的泄漏机理。
研究小组今后的目标包括优化 GaN 外延,旨在将击穿电压提高至 1kV 以上,同时保持低的接通电压。Zhao 表示:“我们将对其他几种阳极金属进行比较,以寻求在接通电压和漏电流之间实现更好的平衡。”
参考文献
Z. Bian et al. Appl. Phys. Express 12 084004
(2019)





