近日,由国家半导体照明工程研发及产业联盟(CSA)与第三代半导体产业技术创新战略联盟(CASA)主办,南方科技大学微电子学院与北京麦肯桥新材料生产力促进中心有限公司共同承办的第十七届中国国际半导体照明论坛(SSLCHINA 2020)暨2020国际第三代半导体论坛(IFWS 2020)在深圳会展中心召开。

期间,由江苏南大光电材料股份有限公司、中微半导体设备(上海)股份有限公司、广州南砂晶圆半导体技术有限公司协办的“衬底、外延及生长装备”分会上,北京大学物理学院高级工程师杨学林分享了“硅衬底上氮化物大失配异质外延生长”的主题报告。详细分享了Si(111)衬底上GaN厚膜、AlN厚膜外延生长、Si(100)衬底上单晶GaN薄膜的外延生长、AlN/Si界面寄生电导产生机理及其抑制方法等方面的研究成果。

GaN功率电子器件是下一代电力电子的一个重要方向,大尺寸、低成本、与现有Si集成电路制备工艺兼容是降低GaN功率电子器件制造成本的唯一有效途径。氮化物半导体领域的研究前沿受到学术界、企业界高度重视。Si衬底上GaN向着大尺寸、厚膜化、低缺陷密度方向发展。高密度缺陷和残余应力严重影响器件性能,成为制约Si衬底上GaN电子器件发展的关键瓶颈。
高密度缺陷和残余应力严重影响器件性能,成为制约Si衬底上GaN电子器件发展的关键瓶颈。低位错密度GaN厚膜外延难度很大,难点是既能降低位错密度又能保持压应力。Si衬底上AlN外延难点涉及大的晶格失配和热失配、缺少能给AlN提供压应力的缓冲层。
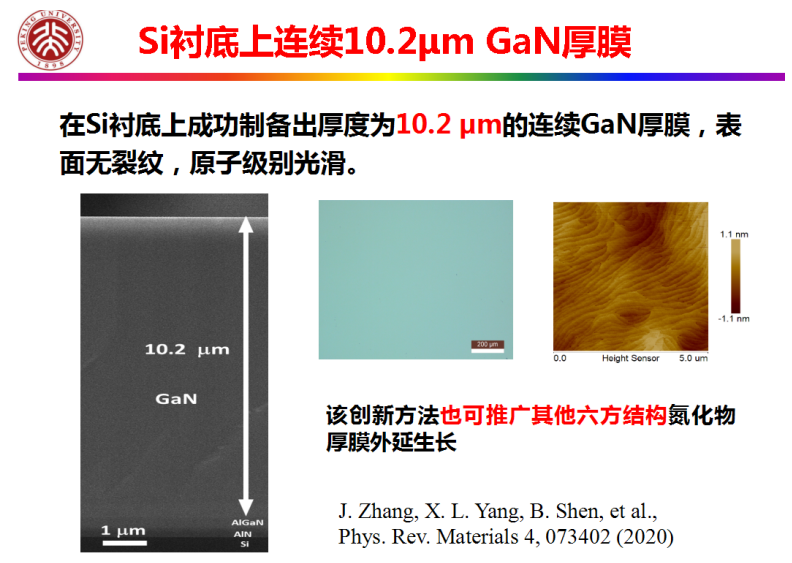

Si(100)是现有CMOS工艺主流衬底,Si(100)衬底上外延GaN是走向IC集成的一个重要途径,报告分享了Si (100) 衬底上单晶GaN的实现、基于N掺杂的石墨烯缓冲层、石墨烯上氮化物的取向特征以及石墨烯上氮化物成核和取向的演化。探讨了GaN-on-Si RF 器件射频损耗问题、AlN/Si界面寄生电导、AlN/Si界面寄生电导的产生机制、界面寄生电导的抑制机理、Al原子扩散对射频损耗的影响等问题。
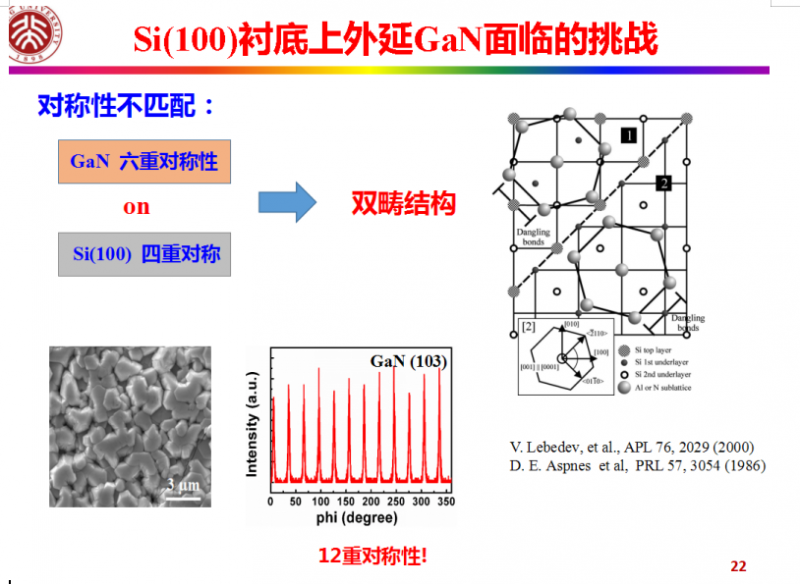
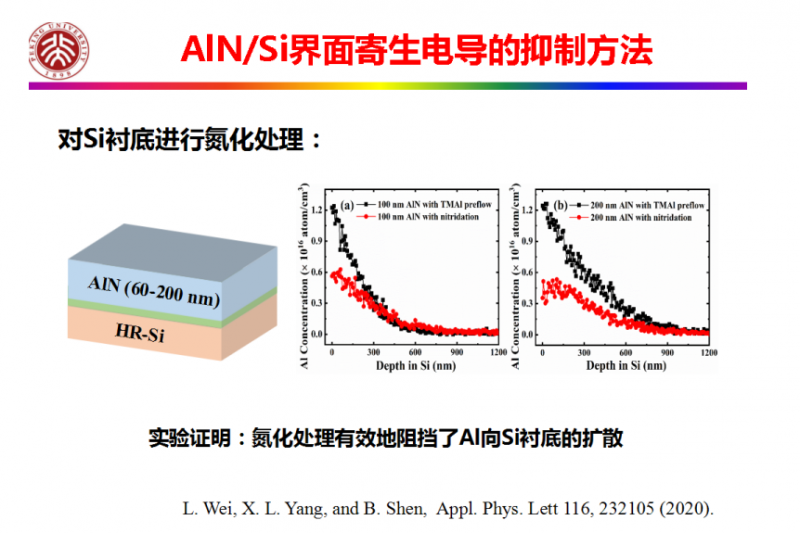
报告中,提出采用Ga空位工程,在Si(111)衬底上实现高质量的GaN厚膜。采用图形化结构,在Si衬底上实现高质量AlN厚膜。采用石墨烯作为缓冲层,在Si(100)衬底上实现单晶GaN薄膜。提出了抑制AlN/Si界面寄生电导的方法。
他是北京大学物理学院高级工程师,国家优秀青年科学基金获得者。先后在吉林大学和北京大学获学士和博士学位,东京大学博士后。近年来在Si衬底上GaN基材料的MOCVD外延生长、C杂质的掺杂调控、缺陷影响电子器件可靠性的机理研究等方面取得了多项进展。迄今在PRL、AFM、APL等期刊上共发表SCI论文70多篇,在本领域国内外学术会议上做邀请报告10多次,申请/授权国家发明专利10多件。
他是北京大学物理学院高级工程师,国家优秀青年科学基金获得者。先后在吉林大学和北京大学获学士和博士学位,东京大学博士后。近年来在Si衬底上GaN基材料的MOCVD外延生长、C杂质的掺杂调控、缺陷影响电子器件可靠性的机理研究等方面取得了多项进展。迄今在PRL、AFM、APL等期刊上共发表SCI论文70多篇,在本领域国内外学术会议上做邀请报告10多次,申请/授权国家发明专利10多件。
(内容根据现场资料整理,如有出入敬请谅解)
