期间,“氮化镓功率器件“专场上,电子科技大学电子薄膜与集成器件国家重点实验室李曦做了题为“GaN HEMT功率器件的热瞬态测试方法与机理研究”的主题报告。
随着功率器件逐渐走向高频高压应用,Si基器件受开关损耗的限制已经很难继续突破。而宽禁带半导体材料GaN由于高迁移率、高临界击穿电场而更能耐高压、高频。
但随着功率密度不断上升,器件热产生加剧,同时由于GaN的自热效应,加上GaN热导率不高,导致GaN HEMT的热问题显着。要分析HEMT的热特性,提高器件热可靠性,就离不开对器件结温提取以及热阻的测试,目前关于GaN HEMT热阻的测试还未有统一标准,常见的是依靠栅极处的肖特基接触进行热测试,但并不是所有的HEMT器件栅极都具有肖特基接触。
在对HEMT的接触电阻以及电子迁移率的温度特性研究发现,接触电阻具有很好的线性温度特性,此外综合电子迁移率以及载流子浓度的温度系数最后发现整体导通电阻具有很好的温度特性,因此导通电阻可以作为热瞬态测试的热敏系数。
采用了GaN HEMT的导通电阻作为热敏参数进行热瞬态测试,与利用栅极肖特基接触相比,此法不受限于特定的几种栅极结构,甚至对于耗尽型的HEMT也同样适用;在实验过程中,发现由于GaN HEMT动态导通电阻得问题使得热瞬态测试的结果一致性较差,无法重复得到相同的测试结果。
在测试中通过加入高温150℃烘烤10分钟的步骤,使得器件在每次测试前均恢复至初始状态,使得最终热瞬态测试的结果具有良好的可重复性。
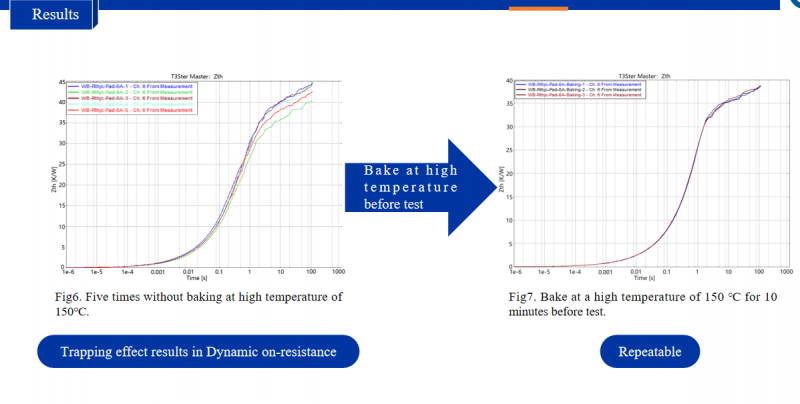
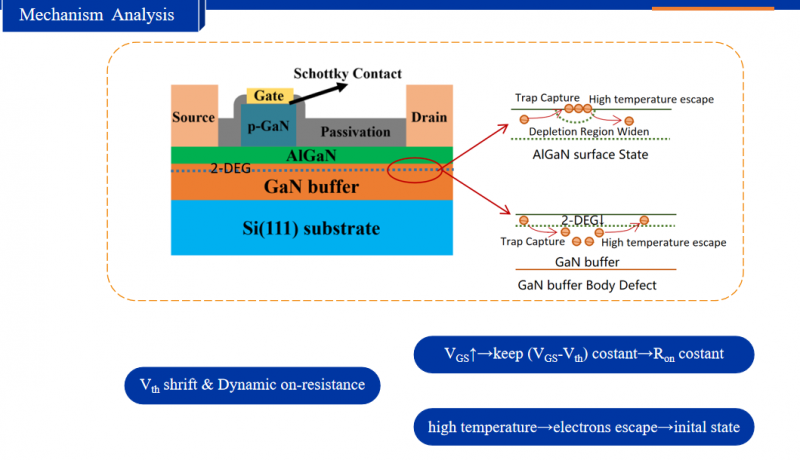
(内容根据现场资料整理,如有出入敬请谅解)
