相比于传统Si材料,以SiC、GaN为代表的第三代半导体更适合于高压、高温、高频、大功率应用,是新能源车、高速铁路、5G基站、充电桩、高压输电的核心器件。
从国际上来看,SiC产业链已经完备,产业化成熟。Cree 、意法半导体等各大公司垄断市场,并继续加大投入,扩大规模。从国内来看,缺少核心技术,SiC产业链条块分割,技术处于初级水平,与国际领先水平相差10年以上。尤其是电力市场需求巨大,所需SiC器件完全依赖进口。SiC器件目前产值约6亿美金,预计2022年即可翻一倍,达12亿美金,增速非常快。
9月13-14日,“2021中国(南京)功率与射频半导体技术市场应用峰会(CASICON 2021)”在南京召开。本届峰会由半导体产业网、第三代半导体产业主办,并得到了南京大学、第三代半导体产业技术创新战略联盟的指导。

会上,复旦大学青年研究员樊嘉杰博士带来了“SiC功率器件先进封装材料及可靠性优化设计”的主题报告,报告指出随着电子封装技术向微型化、高密度、集成化、高可靠方向发展,芯片级封装、系统级封装、系统级芯片、三维立体封装将陆续在碳化硅(SiC)功率模块封装中被采用。
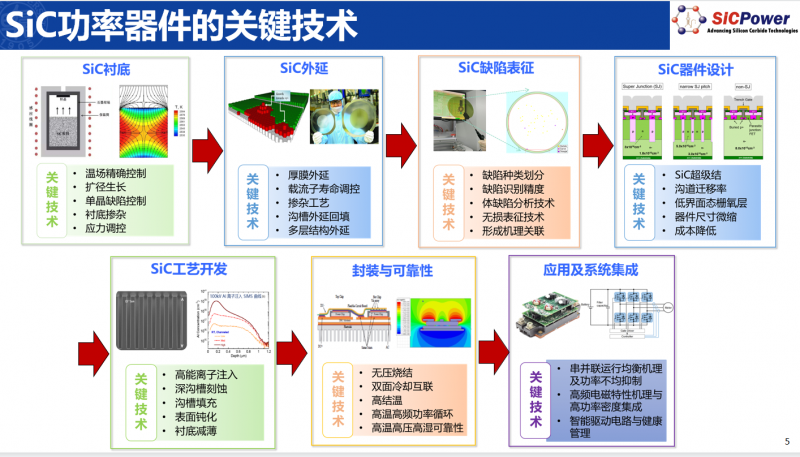

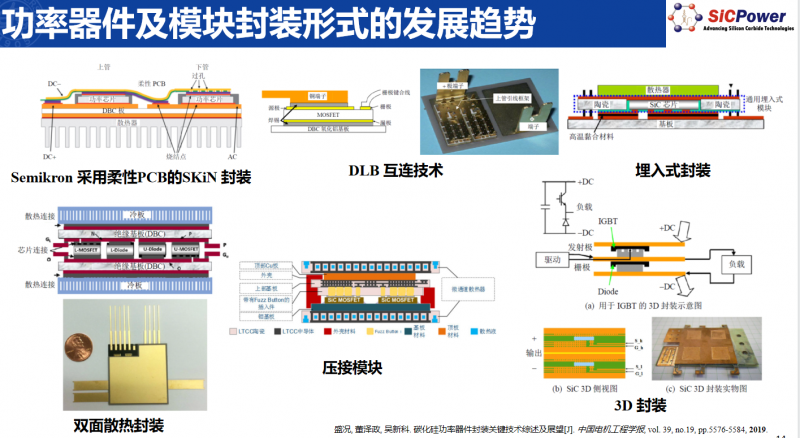
先进封装及可靠性技术是保证宽禁带半导体性能优势并实现长期有效服役的关键,属于第三代半导体产业亟待解决的卡脖子问题,因此,急需对复杂使役条件下SiC功率模块新型封装工艺、材料、失效机理和可靠性等基础问题展开前瞻性探索。报告从第三代半导体发展现状、功率器件及模块封装形式的发展趋势、先进封装材料的发展趋势、封装可靠性设计及优化方法等四个方面展开介绍了最新研究进展。
其中,从功率器件及模块封装形式的发展趋势来看,先进封装的目的是提升功能密度、缩短互连长度、提升系统性能、降低整体功耗。随着系统级别要求的不断提升,“定制化” 成为“主流”。
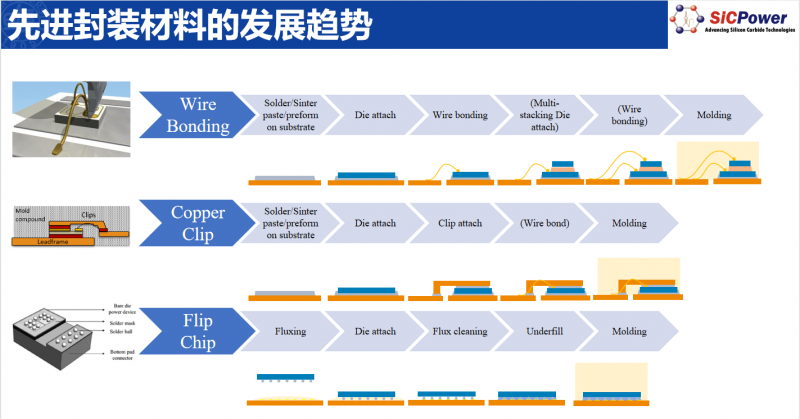

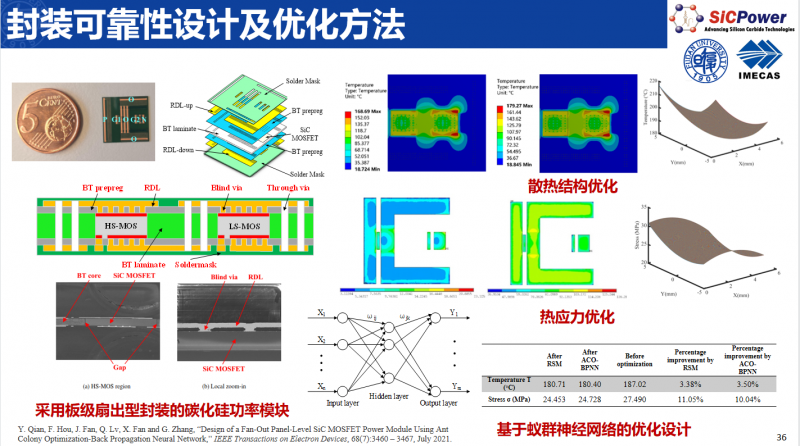
嘉宾简介
樊嘉杰,香港理工大学和美国马里兰大学联合培养博士,荷兰代尔夫特理工大学博士后/CSC公派访问学者/客座研究员。主要研究方向:第三代半导体封装及可靠性。迄今共发表学术论文110余篇;申请/授权专利20余项;主持起草ISA国际标准1项、参与起草国家标准和CSA联盟标准多项。获全国“第三代半导体卓越创新青年”称号、入选江苏省科协 “青年科技人才托举工程”、江苏省第十五批“六大人才高峰”高层次人才等。
